摘要

環評廠空污減量躍進做法及未來思維
Keywords / Air pollution18,Environmental Impact Assessment(EIA)2,Source differentiate
2016年12月通過環保署第306次環評大會審查,中科空氣污染減量、符合總量管制之承諾。隨著台積製程演進與產能需求的增加,為了符合最關鍵的空污總量管制,對於空污的改善是持續演進,廠務處集合新廠設計部、ISEP眾多專家,在中科廠進行檢測、導入新技術、新設備,將半導體產業的空污防治技術提昇到更高的層次,持續推廣至各300mm廠區平行展開。
In December 2016, it passed the review of 306th EIA Conference of the Environmental Protection Agency. TSMC Process Evolution and Increased Capacity. To comply with total Air Pollution control. Air pollution improvement is continuous progress. There are many experts in the NFDD & ISEP. Testing、importing new technology and new equipment in F15B. Air pollution control technology of the semiconductor industry to higher level.
1. 前言
台中位處台灣中部區域,人口排名第二大城市,西側有火力發電廠、中龍鋼鐵廠;南側有南屯垃圾焚化廠、台中工業區、精密機械園區;北側有后里垃圾焚化廠、正隆紙廠;各種重量級污染源環佈,使台中市空氣污染議題常為全國新聞焦點。
F15B位於中部科學園區,建廠前台積電對於這塊土地許下空氣污染減量、符合總量管制之承諾。半導體產業的空氣污染物原本就較火力發電廠、鋼鐵業、光電業為低,既有的空氣污染處理技術所面對的問題是百萬分率(ppm)等級,現在的空氣污染處理技術則必須處理到十億分率(ppb)等級之水準,才能達標,隨著奈米世代的演進及製程的進步,當客戶訂單湧入,產能逐步滿載,相對來源濃度與風量增加,挑戰難度更高,強化的技術不僅僅是中央處理設備效率之提升,甚至必須採用「源頭分類、多段處理」。
魔鬼藏於細節裡,分析找出源頭高污染,由源頭下手改善,在未形成粒狀污染物前、在高濃度低風量型態、未擴散分佈前,源頭去除,於各種形式LSC改善,細節分析,打擊惡魔,去除粒狀污染物PM2.5,同時減輕LSC PM負擔,與新工設計及多位專家的共同努力下,讓既有設備處理效率得以提升,以下篇幅將逐步說明中科環評廠是如何尋根究底、斬草除根,進階新空污標準。
1.1 半導體業空氣污染物種類
提到半導體業會產生的空氣污染物,可參酌環保署2002年公告之「半導體製造業空氣污染管制及排放標準」,根據半導體製造業空氣污染管制及排放標準第四條如下。(九十一年十月十六日修訂) 半導體製造業產生之空氣污染物應由密閉排氣系統導入污染防制設備,並處理至符合下表規定後始得排放,如 表1。
其適用產業包含積體電路晶圓製造、晶圓封裝、磊晶、光罩製造、導線架製造等。原物料使用量大於 表2所規範者必須每年進行檢測及申報(環評廠每半年)。
| 空氣污染物 | 排放標準 |
|---|---|
| 揮發性有機物 | 排放削減率應大於九O%或工廠總排放量應小於O.六kg/hr(以甲烷為計算基準)。 |
| 三氯乙烯 | 排放削減率應大於九O%或工廠總排放量應小於O.O二kg/hr。 |
| 硝酸、鹽酸、磷酸及氫氟酸 | 各污染物排放削減率應大於九十五%或各污染物工廠總放量應小於O.六kg/hr。 |
| 硫酸 | 排放削減率應大於九十五%或工廠總排放量應小於O.一kg/hr。 |
| 原物料 | 年用量 |
|---|---|
| 揮發性有機物 | 一七〇〇公斤/年 |
| 三氯乙烯 | 六〇公斤/年 |
| 硝酸 | 一七〇〇公斤/年 |
| 硫酸 | 三〇〇公斤/年 |
| 鹽酸 | 一七〇〇公斤/年 |
| 磷酸 | 一七〇〇公斤/年 |
| 氫氟酸 | 一二〇〇公斤/年 |
隨著半導體製程的先進製程演進,化學品使用之種類逐年增加,此法難以完整規範所有空氣污染排放項目。於是園區進一步規範新設固定空氣污染源,需分析製程排氣內所使用之原物料及衍生之污染物進行申報(圖1)。
空氣污染物可分為有機物、無機酸鹼、及處理過程衍生之SOx、NOx等產物。申報之種類則因各廠區所使用的化學品而異,有機物一般以「總非甲烷碳氫化合物」、酸類以「氫氟酸、硫酸、硝酸、鹽酸、磷酸、氯氣」、鹼類以「氨氣」作為申報之代表,並分別依污染物特性設置處理設備。
1.2 空氣污染防制設備原理
目前排氣系統主要區分為酸性氣體排放(SEX)、含氨氣體排放(AEX)、有機氣體排放(VEX)與一般氣體排放(GEX),依據空氣污染防制法第8條第3項「未符合空氣品質標準之總量管制區,新設或變更之固定污染源污染物排放量達一定規模者,應採用最佳可行控制技術,並取得足供抵換污染物增量之排放量。」
法規定義之「最佳可行控制技術」指考量能源、環境、經濟之衝擊後,污染源應採取之已商業化並可行污染排放最大減量技術。而長期以來在處理效率、運轉穩定度、安全性等因素考量下,持續採用的技術分別為:
- 有機排氣:終端吸附式沸石轉輪及燃燒爐
- 酸性/氨氣排氣:前端濕式洗滌塔、終端濕式吸附洗滌塔
- 全氟碳化物(Perfluorocarbon, PFC)排氣:前端熱分解處理器
- 毒性/易燃性排氣:前端熱分解處理器及濕式洗滌器
- 有機金屬/重金屬排氣:乾式吸附處理器
圖1、半導體業空氣污染物排放流程

2. 文獻探討
2.1 粒狀污染物之特性
懸浮微粒的粒徑大小有別,如 圖2所示,小於或等於2.5微米(µm)的粒子就稱為PM2.5,通稱細懸浮微粒,單位以微克/立方公尺(µg/m3)表示之,它的直徑不到頭髮粗細的1/28,非常微細可穿透肺部氣泡,並直接進入血管中隨著血液循環全身,故對人體及生態所造成之影響是不容忽視的。PM2.5的生成機制可分為兩種,皆可能由自然界或人為產生,如 圖3所示:
- 原生性(Primary):
是指在大氣中未經化學反應的微粒,主要來自物理破碎、風蝕逸散或人為污染所直接產生,包括海鹽飛沫、裸露地表揚起的粉塵,鍋爐及機動車輛引擎燃燒過程排放之微粒等。
- 衍生性(Secondary):
是指排放到大氣中的化學物質(稱為前驅物,可能為固體、液體或氣體),經過複雜的化學變化與光化反應後生成,PM2.5前驅物包括:硫氧化物(SOx)、氮氧化物(NOx)、揮發性有機物(VOCs)與氨(NH3),在大氣中反應生成硫酸鹽、硝酸鹽及銨鹽等微粒組成PM2.5。
圖2、懸浮微粒大小說明

圖3、原生性及衍生性PM2.5來源關係圖

2.2 粒狀污染物的粒徑及濃度
微粒大小通常是影響微粒行為的最主要參數,對於圓球形微粒而言,通常以微粒直徑來表示微粒的大小。其他非圓球形微粒的大小一般則以相當或等似直徑(equivalent diameter)來表示。描述微粒等似直徑的通常是根據微粒的幾何形狀(如等投影面積直徑、等體積直徑),或是其他特性如氣動特性(空氣動力直徑,簡稱氣動直徑)、散光特性等來定義。等投影面積直徑是和一不規則微粒具有相同投影面積的圓的直徑(圖4);若將微粒由一個具有單位比重及與它相同沈降速度的圓球直徑來代表時,那麼圓球直徑便代表微粒的氣動直徑。具有不同密度、體積直徑或形狀的微粒,都有可能具有相同的沈降速度;而具有相同氣動直徑的微粒在物理上代表相同的氣動行為,例如微粒的慣性衝擊。菲列直徑 (Feret's diameter)是指投影面積兩端的最長水平距離,馬丁直徑(Martin's diameter)則是指將投影面積等分為二的水平直線長度。
圖4、常用的直接測量相當直徑表示法
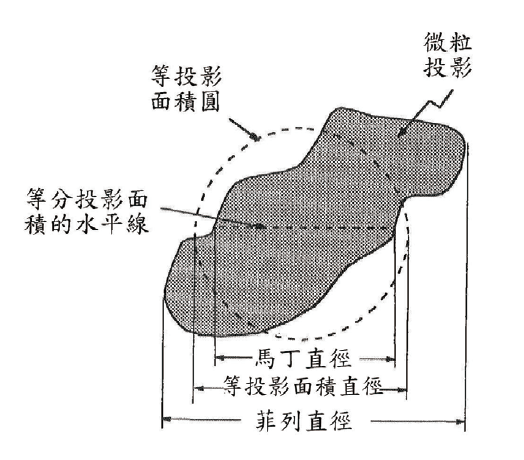
2.3 粒狀污染物的重力沉降

粒狀污染物重力沈降的問題,我們先假設流體不動,微粒以初始速度零開始垂直向下運動。我們知道因微粒受到重力,因此它的速度會從零慢慢增加,直至其阻力等於重力為止,這時微粒的沈降速度不變,稱為終端沈降速度Vts(terminal settling velocity)。一般由於微粒的鬆弛時間很短,我們可以忽略微粒到達終端沈降速度前的速度變化,令重力等於阻力時可得:粒狀污染物在正常狀況下,終端沈降速度Vts與圓球微粒直徑Dp之關係(表3),利用微粒的重力沈降速度的觀念,可以定義一不規則微粒的空氣動力直徑Dpa(aerodynamic diameter)。一個不規則微粒的空氣動力直徑,為與其具有相同重力沈降速度的單位密度(p=1,000kg/m3)圓球直徑。因此不論微粒的形狀或密度為何,只要它們具有同一Dpa,則它們的重力沈降速度就相同,空氣動力行為也相同。
| (20°C , 1 atm : ρp=1000 kg/m3) | |
|---|---|
| Dp,μm | Vts , m / sec |
| 0.01 | 6.92×10-8 |
| 0.02 | 1.42×10-7 |
| 0.05 | 3.85×10-7 |
| 0.10 | 8.82×10-7 |
| 0.20 | 2.26×10-6 |
| 0.50 | 9.91×10-6 |
| 1.00 | 3.48×10-5 |
| 2.00 | 1.30×10-4 |
| 5.00 | 7.76×10-4 |
| 10.0 | 3.06×10-3 |
2.4 旋風集塵之設計理論
在圓形軌道運動的微粒受到離心力的影響會往徑向向外的方向偏離圓形軌道,此離心力F可用式1表示:

其中,ρp=微粒密度(kg/m3);Dp=微粒直徑(m);Vi=微粒之切線方向速度,一般假設與進口流速相同(m/s);r=圓形軌道之半徑(m)。
此式說明了許多有關效率的問題。prpDp 3/6是微粒質量,質量愈大,離心力愈大,偏離的程度愈大,收集效率也愈高。此外,圓形軌道半徑r減少時,離心力會增加。此顯示小型旋風集塵器比大型的效率高。
旋風集塵器可以用下列三個因子來表示其性能:
- [Dp]cut=[Dp]50=50%去除效率之截取直徑(cut-off diameter)
- P=壓力降
- η=總效率
3. 研究方法
3.1 空氣污染源頭普查及高濃度污染源分析
半導體廠區AAS系統大致可分類以下區域,污染物來源:製程機台(Wet Bench、EPI、Thin Film、Lithro、Dif),廠務端(化學桶槽、廢水桶槽、CDU化學供應、氣瓶櫃),前端廢氣處理設備(Local scrubber、Salix、wet scrubber、深層式濾網、水洗箱),經由sub-man duct至立管,再由立管至頂樓大型man duct,銜接至終端廢氣處理系統(SEX、AEX、VOC、GEX),處理後排放至外氣環境。(圖5)
圖5、半導體廠空污排放架構與流程圖
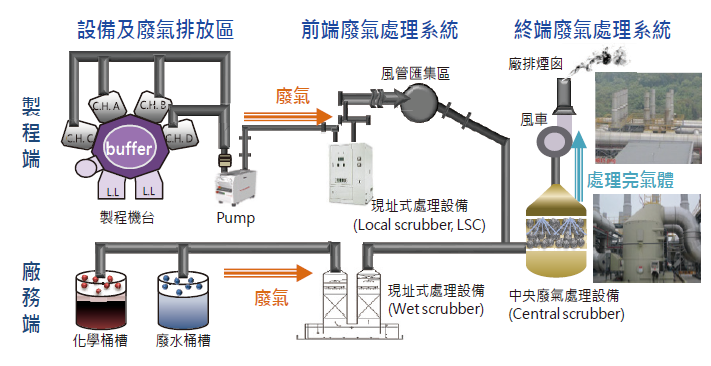
3.2 上游排放煙囪至下游製程機台盤查追蹤
環評廠區需每支煙囪進行採樣,每年於空污自檢採樣排放煙囪,由煙囪污染物濃度,規劃分析各區域立管,進行每支立管採樣,將立管依據濃度排序,排列出濃度較高的兇手,清查出可疑的下游製程機台,進行Local機台採樣,抓出真正的魔鬼,並清楚瞭解各種機台不同污染物的類型。(圖6 圖7)
圖6、硫酸污染物上游排放煙囪至下游製程機台盤查
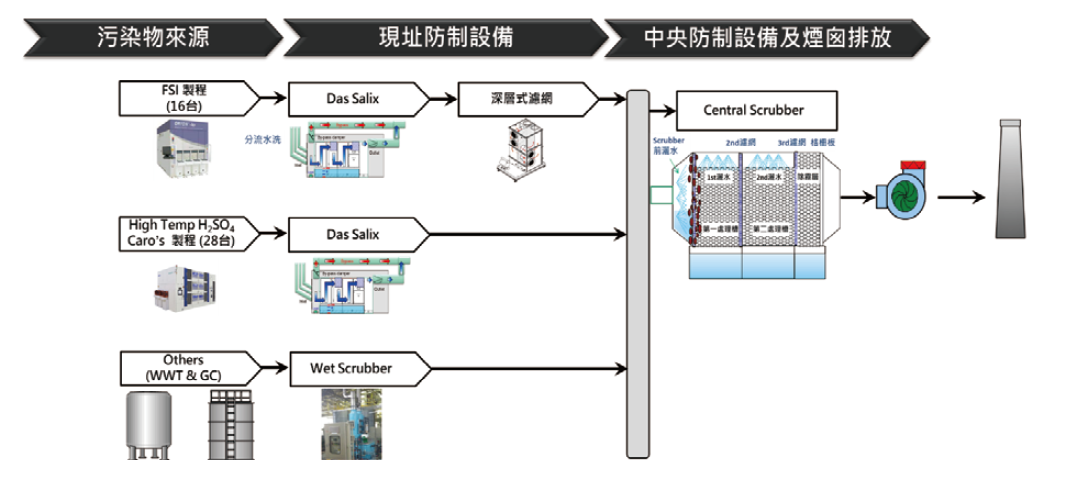
圖7、氫氟酸污染物上游排放煙囪至下游製程機台盤查
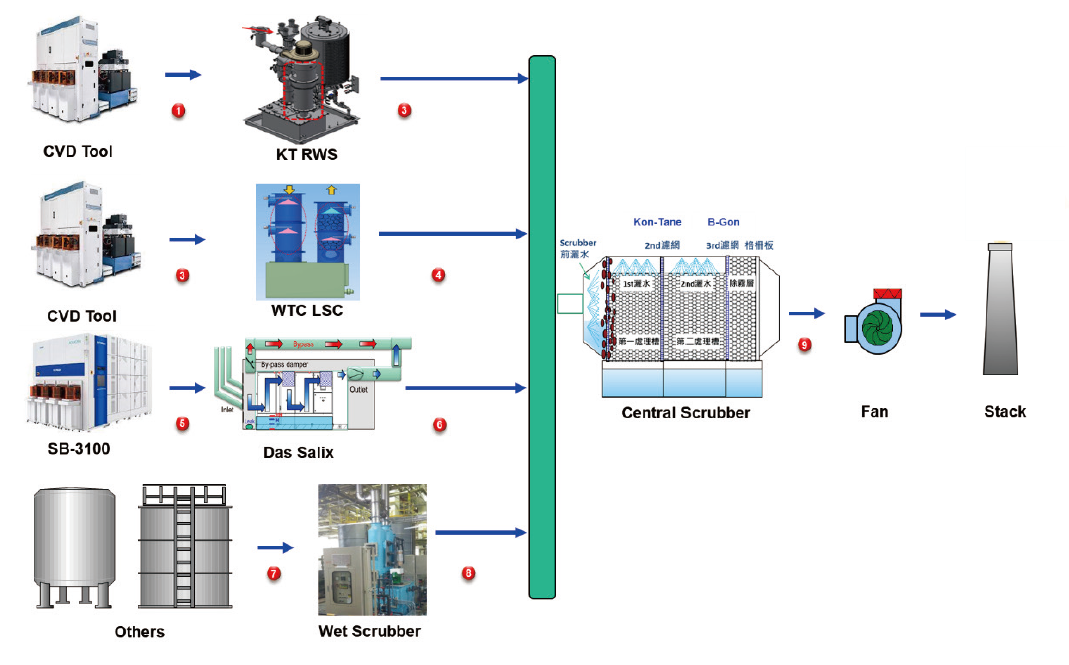
3.3 製程機台污染源與化學品用量核對探討
與氣化課工程師合作,抓出各區域化學品日用量,與機台設備工程師合作,分析化學品使用順序及投片秒數,對照採樣數據,分析判斷使用何種前端廢氣處理設備改善,對症下藥,藥到病除,效如桴鼓。(圖8)
圖8、空污排放減量與削減技術分析
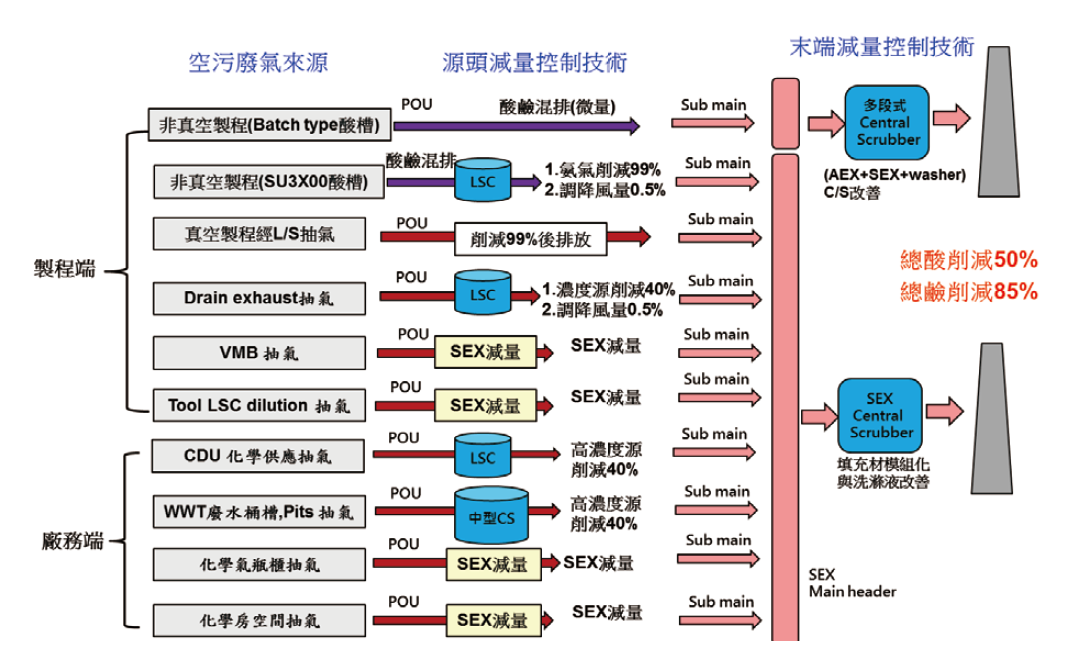
4. 結果分析
4.1 硫酸含量源頭削減
Chamber Exhaust共管導致酸鹼混排,單片式FSI高溫製程使用高溫SPM(H2SO4)及SC-1(NH4OH),其程序如 圖9所示,高溫硫酸(H2SO4)與雙氧水(H2O2)反應後產生220~240℃之硫酸水霧,經過去離子水潤洗過後,接著使用氨(NH4OH)與雙氧水,再使用去離子水後則進行下一次循環,由於不同chamber使用化學品的時間不一致,Chamber Exhaust內連線為共管,則不同chamber的酸鹼皆混排而形成大量硫酸銨粒狀物,造成風管結晶及煙囪白煙問題。根據機台廢氣流程圖來看(如 圖10),每兩個Chamber透過歧管(Manifold)將製程廢氣匯集至Submain,因此排至Das Salix處理之前,早已產生大量的銨鹽粒狀物。
由上述單一Chamber化學品使用程序可知,關鍵點在於H2SO4與NH4OH兩者使用的時機並不重疊,於前段風管採用LSS水潤洗數百秒,因此若將各Chamber內連線由共管改為獨立管分流,當不同Chamber進行不同酸鹼程序時,單一Chamber專管專收不互相混排影響,可大幅降低高濃度酸鹼產生大量粒狀物的機會。因原廠機台設計本身底部已設有專管接點,由此接點後之製程排氣管路修改設計如 圖11所示,兩支Chamber exhaust出機台後各自走獨立專管,取代舊有岐管(Maniflod)匯集至Submain的設計,並於獨立管內設置前灑水頭進行初步水洗,以降低管內酸鹼氣體濃度,減少後續混合形成硫酸銨的機會,當廢氣經分流及細水霧灑水後再送至水渦流機進行少量粒狀物的處理。此設計與以往不同的是,針對單片式FSI機型不再只是處理生成之粒狀物而已,而是解決源頭的酸鹼氣體問題,同時改善混排造成大量粒狀物進入增加效能負荷之問題。Chamber Exhaust共管導致酸鹼混排,單片式FSI高溫製程使用高溫SPM(H2SO4)及SC-1(NH4OH)。
圖9、單片式FSI製程化學品使用程序

圖10、FSI機台排氣構造與流程圖
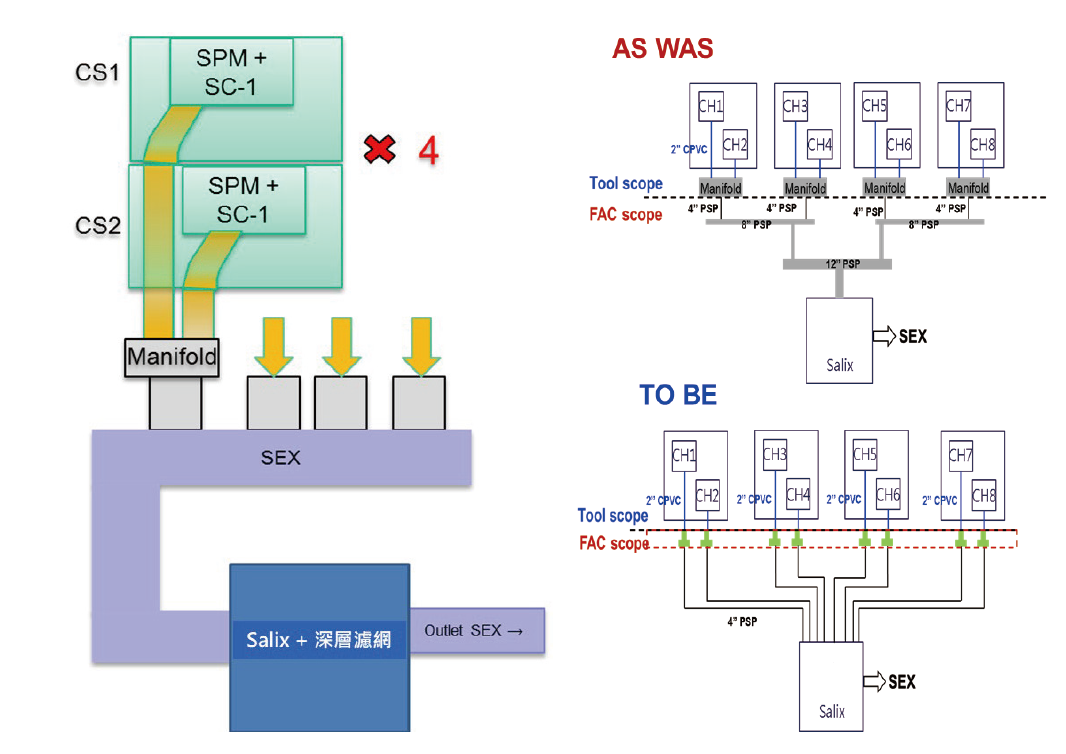
圖11、機台分流減少酸鹼氣體混合反應的粒狀污染物

圖12、前段風管分流灑水安裝方式

4.2 鹽酸含量源頭削減
Dif製程機台使用到的含氯化學氣體(DCS/HCD),其副生成物HCl無法被原有空污處理設備所攔阻,導致酸排風管堆積powder,且HCl無法符合環評要求,IPI Local Scrubber雖能將製程廢氣裂解處理,但其產生的powder粒徑細小,易穿越拉西環間隙抽至風管,造成後端排氣系統阻塞,影響運轉。
IPI Local Scrubber的改造是利用氣體高壓噴射將水打散成微米等級的水霧,再利用二流體高比表面積的特性將污染物抓下;出口段則是加大灑水量,藉由重力與離心力來攔截污染物與粉塵。針對爐管製程中DCS大宗使用群(ANT/LNK/SRK)安裝,目的用以去除製程中的副產物SiO2與HCl:結果採樣分析在LSC與風管立管段皆有86%以上的HCl去除效率。
圖13、IPI二流體改造的增加項目圖示
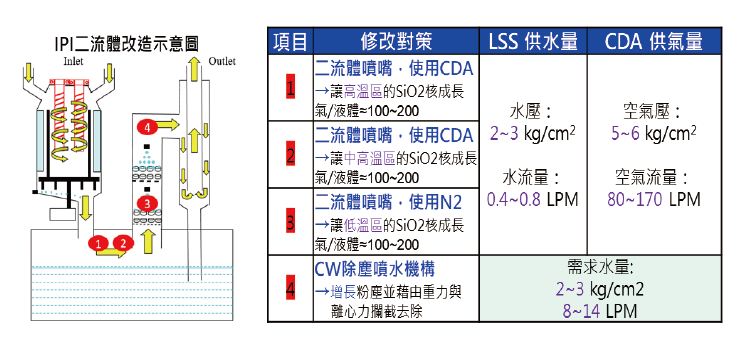
圖14、IPI二流體改造去除效率
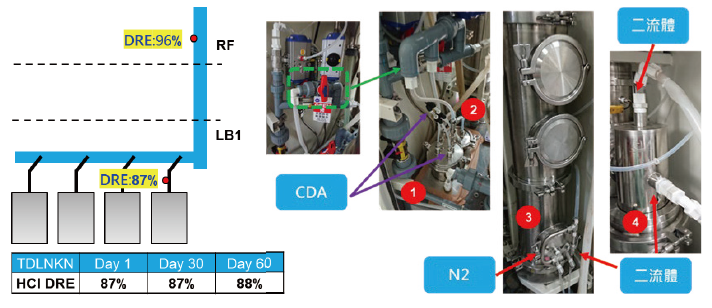
圖15、IPI二流體改造後內部狀況

4.3 氫氟酸含量源頭削減
CVD製程除了原有的化學氣體沉積會產生SiO2白色粉末之外,NF3/CF4等含氟的氣體化合物在CVD應用中經由處理設備的電漿反應後會產生F2氣體,再透過尾氣處理裝置的水洗段後會產生大量的氫氟酸液滴,在此之前這種微小的氣懸浮微粒由於體積重量都過小過輕,並不容易被拉西環的水膜所攔阻,造成後段空污中央處理設備無法有效的去除;於是在KT機台的水洗段先增設細水霧噴頭,另外在靠近出口處增加一個離心旋轉床,藉由超重力的高速旋轉可匯集並增大污染液滴,待其撞擊至出口管道金屬表面後,過多的液體便可順流而下蒐集,如此一來可有效攔截過小的氣懸浮粒子,提升粒狀物的去除效果。F15B測試的結果去除效率可達90%以上,KT完成改造共計81台後P5的總排放量也從0.883頓下降至0.658頓,減少排放量25%以上。
圖16、KT RWS改造後的去除效率
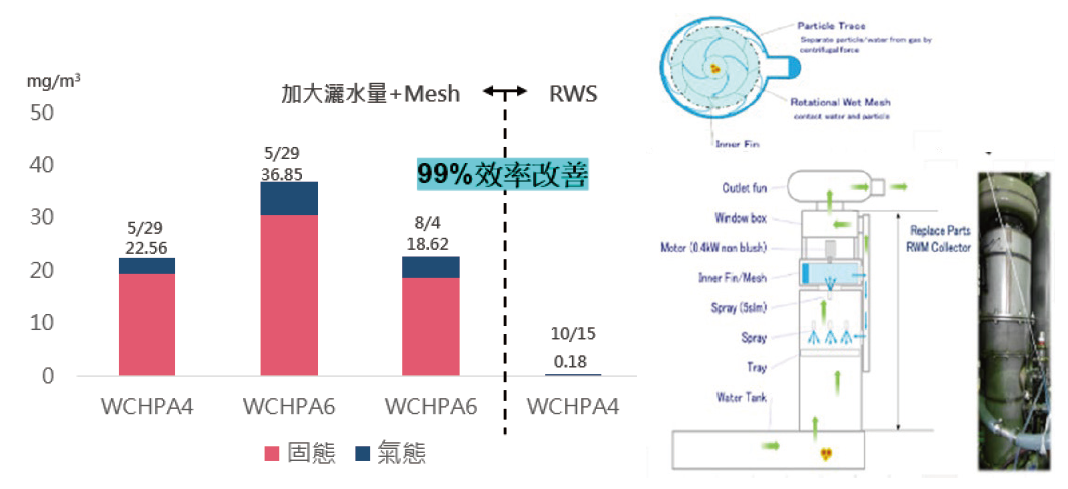
圖17、KT RWS離心旋轉P&ID
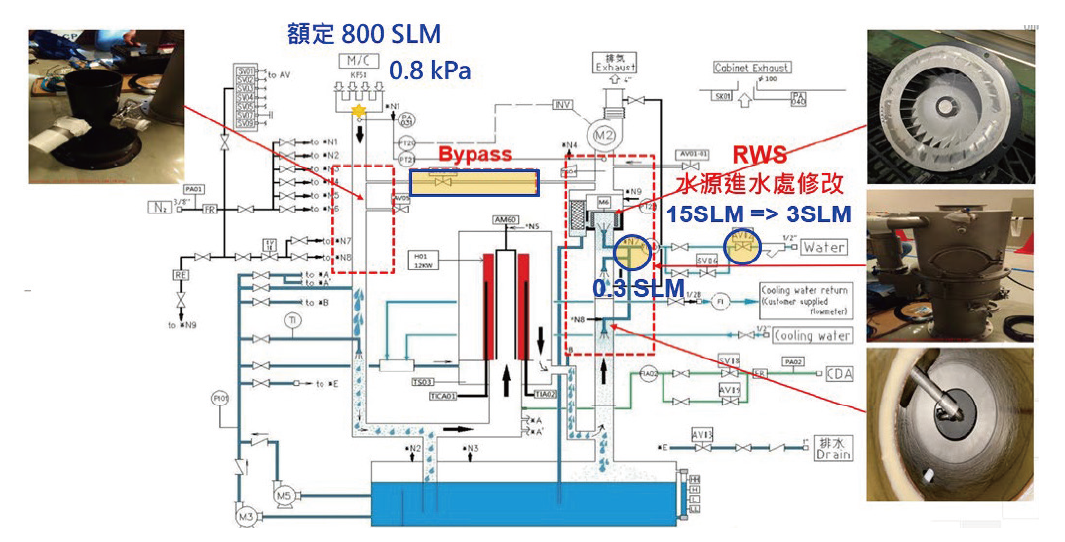
4.4 中央處理設備強化改善方式
濕式洗滌塔中除霧層功能為有效攔阻液滴及粒狀物,原廠洗滌塔除霧層是填充小型球狀拉西環,除霧層則是波浪形狀的除霧浪板。為提升硫酸液滴去除率,測試使用新型高性能除霧層如 圖18,其利用上下相向交錯格線構成階梯狀三維結構,結構具有方向性,因此結構內織線皆與氣流成垂直方向,故可保證最大接觸面積能有效攔截氣流中夾帶的霧滴。立體的排列組合使得通過除霧層的微粒、霧滴透過衝擊及離心作用將霧滴放大,有利於其慣性攔除去除,搭配不同孔隙率的除霧層達到最大的霧滴收集效率(圖18)。高效能除霧層的安裝主要位於圖中洗滌塔第二道除霧層的位置(如 圖19),第一道除霧層的空間保留給水力薄膜。因除霧層是利用慣性衝擊及截留方式攔阻微粒,故增加洗滌塔風速有利其去除效果,但在洗滌塔內部如果風速過快,污染氣體滯留時間太短將不利於質傳反應,為避免增加洗滌塔整體風速導致填充層段的處理效能降低,改以安裝高效能除霧層時在其周圍增加FRP材質的遮板,只讓廢氣於末端通過高效能除霧層的風速增加。
圖18、高效能除霧層攔阻方式
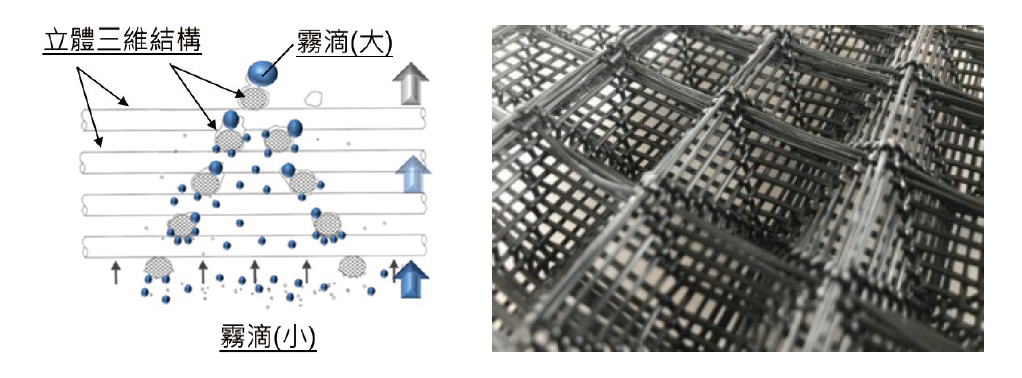
圖19、高效能除霧層安裝位置及攔阻粒徑排序

5. 結論
結果分析
本文研究運用Central Scrubber集中攔截及自潔式效果,維持壓損不上升,運用現有LSC出口安裝濕式旋風集塵器,來處理細懸浮微粒問題,可降低污染物達到環評標準,改善PM2.5空氣污染,也可解決LSC出口後端風管阻塞問題。研究現址式粒狀物防制設備結合的型式也是未來的發展趨勢,既可解決目前半導體廠房空間利用問題,也替未來新廠區設計時多了一個建置的思考方向,濕式旋風集塵器在高轉速與高灑水水量下,目前去除懸浮微粒的效率可高達80~90%,相信在未來的發展研究下,可創造出更高的去除效率,達到預期的空品標準。
參考文獻
- 環保署,半導體製造業空氣污染管制及排放標準,2002。Chamber
- 交通大學環工所,白曛綾教授,酸鹼性氣體洗滌塔操作績效自我評估管理制度手冊,2003。
- 工研院,簡弘民、吳信賢,低濃度酸鹼廢氣高效率洗滌處理技術, 2004。
- 中央大學環工所,費國偉,以濕式洗滌法去除發光二極體產業含氨廢氣之效率探討,2012。
- 中山環工所,空氣污染控制與設計,2014。


留言(0)