摘要

機能水的應用
本文主要介紹目前及未來機台超純水可能使用的走向,機能水的應用及原理,機能水可增加去除效率及減少化學品的耗量,如O3 +DIW,去除有機物(取代SPM功能),CO2+DIW,防止帶電,增加微粒子去除效率…等。目前台積公司超純水水質中央供應系統已勝過ITRS 2020的標準(微粒子計數器已超出線上量測控制器偵測極限) ,新製程線徑,水分子已無法洗淨完全,此時機能水的應用更顯得重要。
前言
在電子產業領域追求細微化的情況下,為了達成構造或機能上的要求,新材料的導入變得不可或缺,同時生產工程的變化也成為無法避免的趨勢。在洗淨工程中,除了獲得潔淨的表面之外,抑制損害的處理也是很重要,用來取代高濃度藥液洗淨之水系統洗淨液的處理也在增加。機能水則是代表性之水系統洗淨液,其應用的範圍也有所拓展,不只是矽元件(Silicon Device),其他如FPD基板或光罩的洗淨等,幾乎所有電子零件的洗淨都會使用到。
本文主要在探討機能水的種類與水質,將以銅(Cu)腐蝕的效果來作說明。
種類與用途
在電子產業領域中所使用的機能水,是指將氣體溶解於其中之超純水的稀薄洗淨液。其中代表性的物質有氫水、臭氧水、碳酸水、電解水、氮水。機能水的洗淨效果,會因為所溶解之氣體的種類或量而有很大的不同,這些機能水的用途與溶解物質如 表一所示。
|
種類 |
用途 |
溶解物質 |
|
|---|---|---|---|
|
還原水 |
氫水、電解陰極(Cathode)水 |
去除粒子、抑制氧化、洗淨水 |
H2 |
|
鹼性還原水 |
氫水、電解陰極(Cathode)水 |
去除粒子、抑制氧化 |
H2 . NH4OH |
|
臭氧水 |
- |
去除有機物(Resist) |
O3 (O2) |
|
酸性氧化水 |
臭氧水、電解陽極(Anode)水 |
去除金屬、去除有機物 |
O3 . O2. HCl . HClO |
|
N2溶解水 |
- |
細微構造洗淨 |
N2 |
|
CO2溶解水 |
- |
防止帶電 |
CO2 |
機能水就酸鹼值與氧化還原電位 圖一、金屬腐蝕性 圖二、比阻抗 圖三,關係說明如下:
圖一是將機能水的水質以pH(橫軸),及ORP(氧化還原電位)(縱軸)來分類,氧化性的水是屬於圖中的上方部分,還原性的水是屬於下方部分。
圖一、機能水的用途與溶解物質
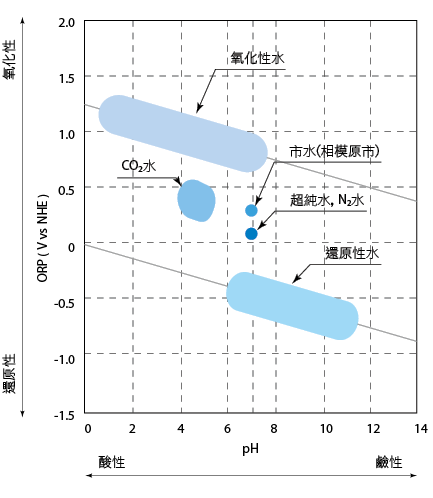
由 圖二Pourbaix diagram Cu可知,大多的金屬在pH2以下的強酸性區域中會溶解,還有對等負性高的金屬之溶解更需要為氧化性的洗淨液。
圖二、Pourbaix diagram Cu
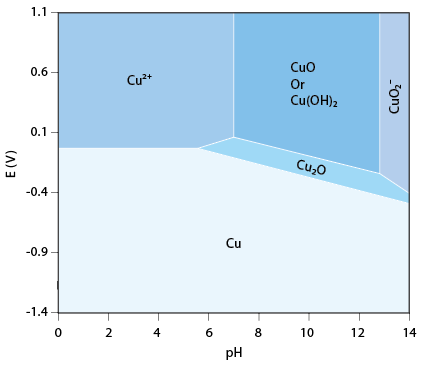
要考量機能水的洗淨效果或對材料的腐蝕性時,需將Pourbaix diagram跟 圖一合在一起看。
例如HPM(塩酸過氧化氫水)溶液中的去除金屬污染,混合了高濃度之塩酸HCl與過氧化氫H2O2之強酸性氧化性溶液中進行洗淨。
圖三是將機能水的水質以pH(橫軸)與比阻抗(縱軸)來分類的。CO2溶解水是利用洗淨來抑制帶電問題,所以受到廣泛利用,這是因為CO2可以溶於水,如下所示進行酸解離(Acid Dissociation)。
H2CO3(aq) ←→ HCO3-(aq) + H+(aq)
HCO3(aq) ←→ CO3 2-(aq) + H+(aq)
圖三、機能水水質(pH-比阻抗 )
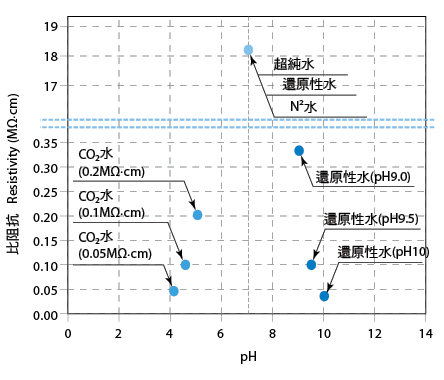
CO2溶解水大多會把比阻抗調整到0.1~0.2MΩ‧cm,此時的pH會降低到5.0~4.5左右成為弱酸性的水溶液,在細微金屬配線的洗淨時會促進配線腐蝕。相較於此,針對就算溶解於水也不會解離之H2或N2氣體的情況下,比阻抗值不會隨之變化,而是與超純水一樣持有相同的比阻抗值18.2MΩ‧cm。在利用氫水(還原性水)或N2水去除微粒子洗淨的情況下,也必須考慮抑制基板的帶電問題,特別是很多時候會添加鹼到氫氣水裡,以pH9~10左右來使用。
添加鹼,比較大的目的是要使微粒子這個去除對象的界面電位(zeta potential)產生變化,然而pH9~10的氫水之比阻抗、跟防止帶電用途所用之CO2溶解水的比阻抗值相同看來,也可以說是對抑制帶電有幫忙的效果。
洗淨的效果
濕式洗淨法雖然依目的可分為SPM、APM、HPM等不同混合藥液,調配條件也會因使用者不同而有差異,但仍為數%~數十%的高濃度。相較之下,機能水溶解在水中的物質為ppb水準,是相當低濃度的洗淨液。
利用酸性氧化性水去除金屬污染[1]
以機能水來去除金屬不純物做說明,用來去除金屬所用之機能水,大多情況會添加微量的酸到臭氧水中,使條件達到pH2以下、ORP1.0V以上來進行利用。
實驗將含銅晶圓(濃度為1012 [ atoms/cm2]),然後用HPM液體及機能水洗淨後的結果。 圖四在右邊的3個條件下Cu的表面濃度維持在1010[atoms/cm2]以下。這三個條件裡面,最右邊的兩個是機能水,右邊算來第三個為HPM,三個的液體性質皆顯示為酸性氧化性,但是所含有之塩酸濃度卻有很大的差異,在機能水是350ppm,與HPM液體5% (=50,000ppm)效果一樣。
圖四、去除金屬(Cu) 之機能水的效果

圖四是為了瞭解洗淨液的氧化性質之效果所做的比較範例,右邊算來第四個顯示將350ppm的稀塩酸加溫到65℃後的洗淨液之結果。在不含氧化劑的這個條件下,洗淨液的氧化還原電位對Cu的溶解不夠充足,結果就是Cu幾乎沒有辦法去除。
使用高濃度藥液清潔有以下幾個問題點:藥品使用的量多、使用後的排液處理負荷高、為了清洗高濃度藥液使用大量的純水,以及洗淨時間長,發散的藥液造成周圍環境污染等。在濕式蝕刻槽(wet-bench)洗淨所使用之大部分高濃度的藥液多在60℃以上的高溫中使用,因為藥液蒸氣經常產生、成為周圍環境中的例如SO2、Cl2、NO2等的腐蝕性氣體來源,導致塩類微粒子生成的可能性高。
利用機能水來抑制Cu配線腐蝕[3]
在先端製程中,配線材料的Cu是不可欠缺的東西。而在此之前的Al-Cu配線、Cu配線的線寬較寬的時候,洗淨時的配線腐蝕或破損情況很嚴重,必須將洗淨液或純水達到最佳化。
關於純水的水質差異造成對Cu配線的腐蝕程度影響,在葉片旋轉處理時洗淨水水質的變化、特別是溶存氧濃度的變化已受到矚目且許多報告討論過。
在大氣中,從液體輸送噴嘴所吐出之水如果為脫氣水(de-aired water)的話,大氣會溶入水中,如果水中已有溶存與大氣不同之氣體的話,預估溶存氣體將會與大氣(空氣)進行交換。此外,在葉片旋轉處理中被倒至晶圓中央的水,預估會因為離心力而往晶圓邊緣的方向移動,同時也產生連續之水質變化。
進行如 圖五所示之準實驗系列中,有洗淨室內(Chamber)充滿著空氣的情況與N2封(Seal)的情況,針對水從吐水點開始到移動了某段距離之間、產生變化之溶存氧濃度(DO)的測定。在實驗中,將樹脂製的板子傾斜固定好,且在基準點(0mm)以及從基準點開始38mm、75mm、140mm的位置上連接量測DO用的採樣軟管(Sampling Tube)。
圖五、DO 測定用準實驗系圖[3]
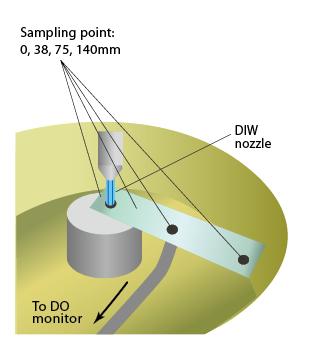
讓水可以接觸到基準點位置來固定吐水的噴嘴(Nozzle),針對水抵達各個採樣點時的DO值進行測定,結果如 圖六所示。
圖六、水中DO 之環境以及從Nozzle 開始距離的影響[3]

洗淨水水質分成下列四個種類,相關與Cu配線腐蝕程度。
- 有防止帶電效果之CO2溶解水、
- 高DO水(7.5mg/L)、
- 低DO水(0.32mg/L)、
- 氫溶解水
洗淨水條件跟在Cu Beta薄膜時的情況一樣,處理時間為600秒,旋轉數為500rpm。處理後之晶圓中央部分的via部斷面SEM照片如 圖七(a)所示。 圖七(a)的5張照片,是洗淨水水質的1~4之結果由上往下排列,左邊欄位也記載了在各個水質之ORP。洗淨室內環境,1~3的水質是只有大氣環境而已,而水質4的氫溶解水之洗淨則是在大氣環境與N2環境下執行。右邊的照片是大氣環境,左邊的是N2環境的結果。
圖七、在via 底部之Cu 的腐蝕3) (a) 洗淨水之ORP 與大氣/N2 環境影響性(b) Cu 的Pourbaix
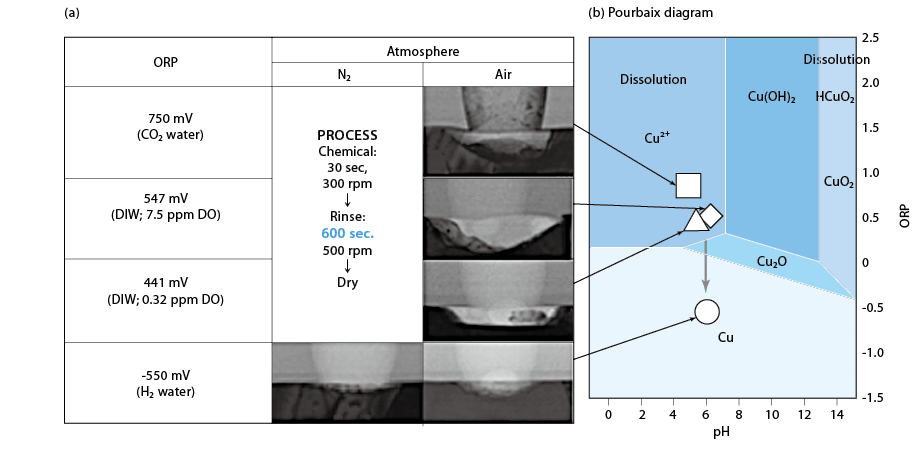
為了防止晶圓帶電而受到廣泛使用之CO2溶解水的洗淨、藉由降低溶氧濃度可以減少腐蝕程度。從這次的比較中知道,使用還原性的氫溶解水,可以更加抑制其腐蝕。
圖七(b)則是表示pH-ORP圖中1~4的洗淨水之水質。在pH中性區域裡屬於2的高DO水與3的低DO水,ORP皆是氧化性。
Cu在腐蝕過程中會形成CuO等的氧化物狀態,將洗淨水變成氫氣水而可以使得抑制Cu腐蝕的效果提高,判斷是因為抑制此Cu的氧化所致。在洗淨中,洗淨液或洗淨水從出液噴嘴吐出之後馬上會產生溶入環境裡的現象,對於控制環境因素之洗淨液的最佳化被認為是越來越重要了。
製造裝置與原理介紹
脫氣膜的應用
H2、CO2、UPW由廠務提供,藉由脫氣膜的裝置,調配適合濃度0.1~0.5 mg/L 圖八。
圖八、脫氣膜的應用
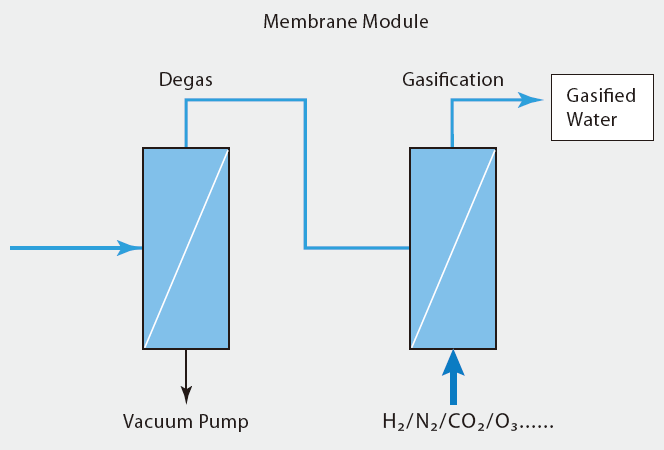
原理1 亨利定律的公式
p=kc
其中:
p為氣體的分壓;
c為溶於溶劑內的體積莫耳濃度;
k為亨利常數,其單位為L-atm/mol atm/莫耳分率或是Pa-m3/mol;
某些氣體的常數如下:
氧氣(O2):769.2 L-atm/mol;
二氧化碳(CO2):29.4 L-atm/mol;
氫氣(H2):1282.1 L-atm/mol;
當這些氣體溶解於S.T.P.的水中時,其選用之濃度表示法應為體積莫耳濃度,L為溶液的升數;atm為溶液上的氣體分壓;mol為溶於溶劑中的莫耳數。值得注意的是:亨利常數的k值會隨著溶劑和溫度變化。當溫度改變的時候,亨利常數隨即改變。這也就是為什麼人們喜歡將它稱作亨利係數的原因。下列即是溫度與亨利常數的關係:

其中θ(Theta)指的是標準溫度(298K)。
氣體的溶解度會隨著溫度的增加而越來越小。像加熱溶有氮氣的水從25℃至95℃,其溶解度會下降成原來的43%,當加熱的時候,C值也跟著改變了,因此C值也可以計作:

其中ΔsolvH為溶解熱;R為理想氣體常數。
原理2道爾頓分壓定律
圖九描述的是理想氣體的特性。這一經驗定律是在1801年由約翰•道爾頓所觀察得到的。其描述如下:
圖九、電解的原理
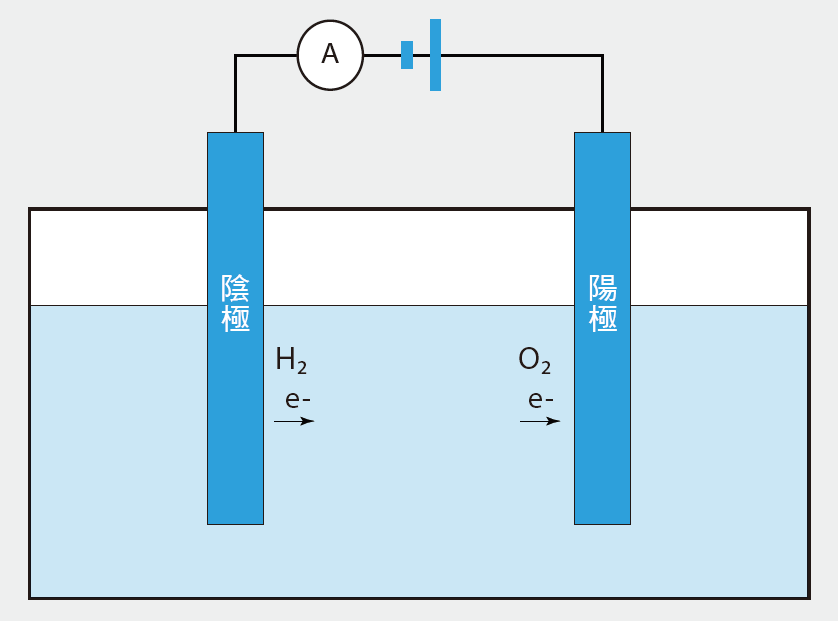
在組分之間不發生化學反應的前提下,理想氣體混合物的總壓力等於各組分的分壓力之和。數學描述為:

其中p1, p2, pn為每一個組分的分壓。結合玻意耳定律和阿伏伽德羅定律,可以推知理想氣體各組分的分壓之比等於其摩爾組分之比,即

其中m1, m2, mn為每一個組分的莫耳數。
電解: 法拉第電解定律
物質在電解過程中參與電極反應的質量與通過電極的電量成正比。不同物質電解的質量則正比於該物質的化學當量。


其中n為1mol物質電解時參與電極反應的電子的摩爾數(即化合價),(M/n)又稱化學當量(Eq);F為法拉第常數,即電解1電化學當量物質所需電量。
法拉第電解定律適用於一切電極反應的氧化還原過程,是電化學反應中的基本定量定律。
電解食鹽鹽水(氯化鈉溶液),陽極產生氯氣,陰極產生氫和氫氧化鈉溶液。
結語
新導入至細微構造的材料有很多都容易受到毀損,同時對蝕刻的容許量也很低。機能水將會做為以超純水為基準的混合洗淨液,應用在新製程的洗淨方面。希望藉由適合洗淨對象之機能水的選定,以及配合洗淨室內環境控制或物理性的洗淨方法來使用以達到最佳化,並對新世代的濕製程(Wet Process)能有所貢獻。
參考文獻
- 今岡孝之:LSI・LCD洗淨の課題と機能水を用いた新しい洗淨技術,クリーンテクノロジー,日本工業出版,P52-55 (2000.6)
- 岡野勝一:超音波洗浄技術と微細化への課題,月刊トライボロジー,新樹社,P51-53 (2008.3)
- Imai, et al. : Japanese Journal of Applied Physics (2009), vol. 48 no. 4


留言(0)