摘要

利用掃描式電子顯微鏡之超純水中的10奈米微粒子檢測技術
Keywords / Liquid Particle Counter (LPC),SEM,UPW2
近年,隨著半導體裝置/元件(Device)的高度積體化,促使製造技術的細微加工化發展,線寬變得越來越狹窄。半導體製造領域的超純水,必須提供高純度的水質,特別是直接影響良率的微粒子(Particle),其粒徑與濃度都有嚴格的要求。依據ITRS發展藍圖(Roadmap),其內容提到應當管理(去除)的「Critical Particle」之大小每年變得越來越微小,2015年是15nm、2019年則是小於10nm,為了10nm 製程到來,2014年與日本合作off-line 的10nm 微粒檢測技術,本文將介紹其設備及檢測的手法。
前言
ITRS 發展藍圖如 表一,若要達到2019年10nm 標準,純水的顆粒數為<1000 PCS/L。
|
Year of Production |
2013 |
2014 |
2015 |
2016 |
2017 |
2018 |
2019 |
2020 |
2021 |
2022 |
2023 |
2024 |
2025 |
2026 |
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
|
Flash ½ Pitch (nm) (un-contacted Poly) (f) |
18 |
17 |
15 |
14.2 |
13.0 |
11.9 |
11.9 |
11.9 |
11.9 |
11.9 |
11.9 |
11.9 |
||
|
DRAM ½ Pitch (nm) (contacted) |
28 |
26 |
24 |
22.0 |
20.0 |
18.0 |
17.0 |
15.0 |
14.0 |
13.0 |
12.0 |
11.0 |
||
|
MPU/ASIC Metal 1 (M1) ½ Pitch (nm) |
40 |
32 |
32 |
28.3 |
25.3 |
22.5 |
20.0 |
17.9 |
15.9 |
14.2 |
12.6 |
11.3 |
||
|
MPU Printed Gate Length (nm) |
28 |
25 |
22 |
19.8 |
17.7 |
15.7 |
14.0 |
12.5 |
11.1 |
9.9 |
8.8 |
7.9 |
||
|
MPU Physical Gate Length (nm) |
20 |
18 |
17 |
15.3 |
14.0 |
12.8 |
11.7 |
10.7 |
9.7 |
8.9 |
8.1 |
7.4 |
||
|
Wafer Environment Control such as Cleanroom, SMF POD, FOUP, etc..., not necessarily the cleanroom itself but wafer environment |
||||||||||||||
|
Critical particle size (nm) |
20 |
17.9 |
15.9 |
14.2 |
12.6 |
11.3 |
10 |
8.9 |
8 |
7.1 |
6.3 |
5.6 |
5.0 |
4.5 |
|
Number of particles >critical particle size (see above) |
1000 |
1000 |
1000 |
1000 |
1000 |
1000 |
1000 |
1000 |
1000 |
1000 |
1000 |
1000 |
1000 |
1000 |
|
Number of particles for EUV mask production >critical particle size (see above) |
100 |
100 |
100 |
100 |
100 |
100 |
100 |
100 |
100 |
100 |
100 |
100 |
100 |
100 |
|
Electrically Active Particles >critical particle size |
TBD |
TBD |
TBD |
TBD |
TBD |
TBD |
TBD |
TBD |
TBD |
TBD |
TBD |
TBD |
TBD |
TBD |
超純水中的微粒子檢測技術中,檢測超純水中的微粒子之方法,有利用光散亂現象之液體微粒子計數器(Liquid Particle Counter:以下稱為LPC),還有以過濾膜來過濾超純水時於過濾膜上所捕捉的微粒子利用光學顯微鏡或掃描式電子顯微鏡來檢測之直檢法。
液體微粒子計數器(LPC)是一種利用散射的方式 圖一測量液體中不溶顆粒的濃度,其原理為: 雷射發出的光經待測液體,光感測器的設置位置與光束之間則具有一夾角;當微粒通過光束時,光線會與該微粒反應而產生散射與反射,並使該些光線投射到光感測器上;光感測器收集該些光線後便以電流方式顯現變化;接續,電子電路在接收到來自光感測器的電流後則顯示出相對應的電壓脈衝;所述的電壓脈衝便會與預設值(校正值)進行比對,其中不同的預設值是對應不同粒徑通道;在微粒計數器中的電子元件會計算在每個比較器中的電壓脈衝以獲得具有不同粒徑的微粒量 圖二;最終,此資訊則藉由儀器的圖形使用者介面以呈現於使用者。
圖一、光散射顆粒計數器原理圖
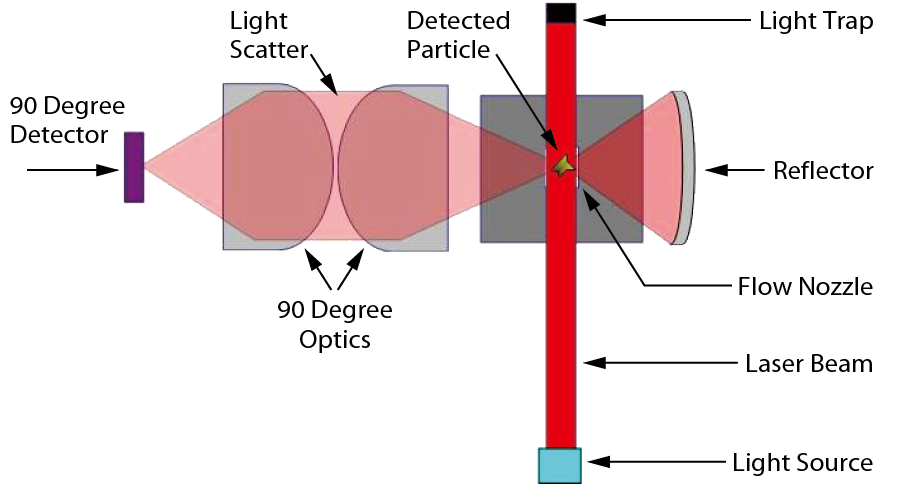
圖二、電壓與粒子數關係

2014年推出最新的LPC只可以檢出20~30nm大小的微粒子,其中又因為雷射強度及接收器不同檢測結果量測值差異大,已經造成水質的量測結果差異,所以若使用目前LPC的技術難以判斷純水中10nm 的顆粒數。
直檢法量測微粒技術
直檢法的原理是利用比檢測對象的微粒子粒徑還要小孔徑的過濾膜過濾純水,並以搭配電子顯微鏡(SEM)觀察膜上粒子的濃度。本次實驗並同時參考日本檢測方法(JIS K 0544超純水微粒檢測方法) ,為了確保此檢測值的信賴性,必須要過濾大量的超純水,讓過濾膜所捕捉到的微粒子數要比捕捉前的過濾膜表面(空白樣本)之微粒子數多。此外因為濾膜的孔隙過小所以過濾膜的壓力損失會增大,過濾流速會變得非常低,所以小粒徑的檢測會需要長時間的過濾。
量測所需的過濾量
- 一般來講,所捕捉的微粒子數與空白樣本平均值的差會在空白樣本值的參差不齊之標準差(standard deviation)的3倍(3σ)以上來決定過濾量。
- 為了觀察50nm以下的微粒子,在SEM觀察中必須要有15000倍以上的觀察倍率,然而在這樣的倍率下視野面積會非常小,變成需要觀察過濾膜表面的一部分來推定過濾膜表面整體有的微粒子數,不觀察許多視野的話,無法獲得統計上可以評估的計數值。特別是在像超純水這樣微小粒子是以低濃度存在的樣本,就算大量過濾,在過濾膜表面所能觀察到的微粒子數量也是稀少,所以為了觀察數個視野以達到可以確認1個微粒子的程度,看情況不同會需要觀察數百~數千個視野。

C: 試料中的微粒子數(個/mL)
N: 檢出微粒子數(個)
A: 過濾膜面積(mm2)
n: 觀察視野數
a: 1視野面積(mm2)
V: 過濾量(mL)
例如:
N =10, A = 20, n =1000,
a =1.21×10−6,採樣體積依公式計算得需要163 L。
SEM技術
掃瞄式電子顯微鏡主要是用來觀察物體的表面型態,其試片製作較簡單,解析度可達奈米尺度且景深長,在觀察材料表面形貌上非常清楚而容易,目前已被廣泛的使用。而一般光學顯微鏡,受限於波長繞射的限制,因此解析度只能到300nm左右。電子顯微鏡之工作原理,即以波長遠小於一般可見光的高能量電子取代光源,因此解析度可大大的提升。
電子顯微鏡組成主要分為電子鎗系統、電磁透鏡組與掃瞄線圈等 圖三為電子鎗透過熱游離或是電場發射原理產生高能電子束,經過電磁透鏡組後,可以將電子束聚焦至試片上,利用掃瞄線圈偏折電子束,在試片表面上做二度空間的掃瞄。當電子束與試片作用時,會產生各種不同的訊號,如二次電子、背向散射電子、吸收電子、歐傑電子、特徵X光…等。在一般掃瞄式電子顯微鏡偵測系統上,主要為偵測二次電子及背向散射電子成像,這些訊號經過放大處理後即可成像觀察。
圖三、SEM 設備
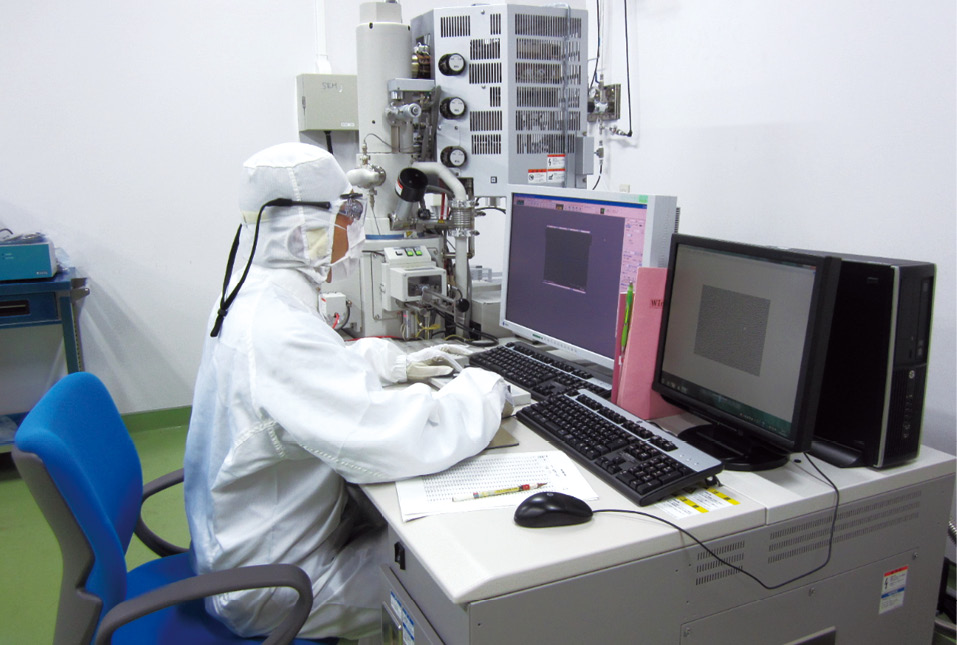
10nm微粒檢測實驗方法及結果
實驗方法
10nm微粒子檢測技術實驗設備有:10nm過濾膜 圖四;可以提升過濾流速以縮短過濾時間的過濾裝置 圖五;電子顯微鏡。
圖四、10nm 微粒子捕捉用過濾膜
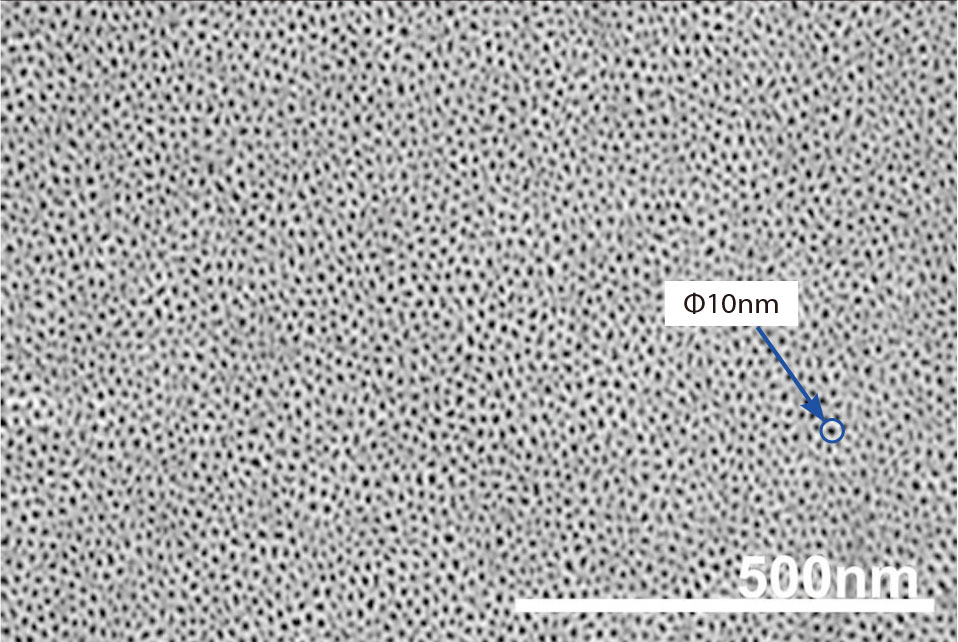
圖五、離心過濾裝置

超純水的過濾使用離心過濾裝置 圖五,藉由離心力讓超純水加壓,通過過濾膜的超純水流量增加,讓過濾所需要的時間縮短,用於要求長時間的採樣(sampling)時之裝置。在離心過濾中,過濾面上的壓力是隨著迴轉數的平方成正比例變化,所以用迴轉數12,000rpm來運轉時,本裝置會產生大約2MPa(約20kg/cm2)的壓力。
實驗量測
使用添加了已知濃度及粒徑之標準粒子到超純水中的試料水,進行離心過濾裝置之標準粒子的採樣,評估過濾量與過濾膜表面所捕捉到之標準粒子數之間的相關性。本評估的流程如 圖六所示。利用注射泵(syringe pump)來添加polystylene latex(以下稱:PSL)粒子(孔徑55nm)當作標準粒子到超純水中。讓含有所定濃度之PSL粒子的試料水連續通水於過濾膜(孔徑10nm)之離心過濾裝置,然後進行PSL粒子的採樣。採樣的過濾量分別有7、12、47、150L,讓這些在過濾量之過濾膜表面所分別捕捉到的PSL粒子數以SEM來進行觀察計數。
圖六、標準粒子添加評估
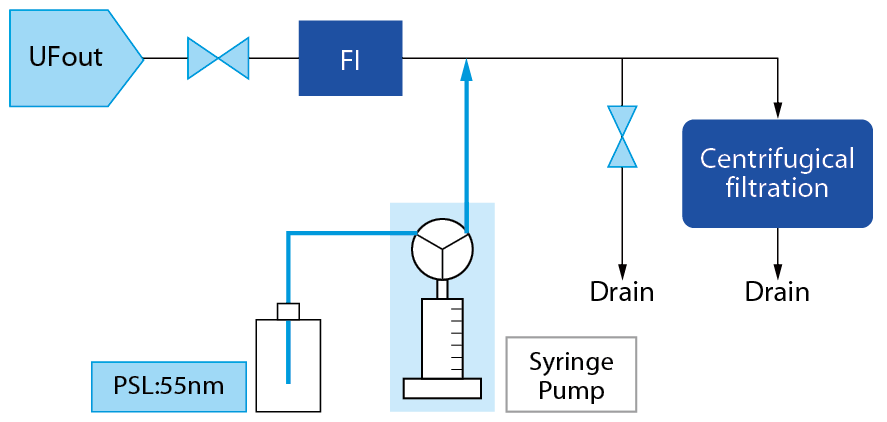
圖七為在各個過濾量之過濾膜所捕捉到的PSL粒子個數。另外,在通水量150L之過濾膜表面的SEM觀察圖像如 圖八所示。從 圖七可以知道,在過濾膜所捕捉到的PSL粒子數會與通水量成正比變化。此表示為進行長期間的採樣,過濾膜的捕捉率也不會變化、過濾膜表面也不會受到汙染。因此、可以判斷此離心過濾系統(過濾膜以及離心過濾裝置)能夠進行超純水中的微粒子之採樣。
圖七、捕捉粒子數與過濾量的相關性

圖八、150L SEM 粒徑數量

2014年於FAB12P5廠實際測試UF出口之10nm微粒子檢測,為了採樣體積達165L則採樣時間連續一個月,其電子顯微鏡的過濾膜表面微粒子數為16pcs./mL,1000張的圖像幾乎都像 圖八所示,都為50nm以下的粒子,幾乎都沒有看到比50nm還要大的微粒子。
總結
只要今後半導體裝置/元件的細微加工化也持續進行,可以預想對於超純水的製造也會愈加的提高要求。如同ITRS發展藍圖中也表示,需對超純水中的微粒子管理更加的嚴格要求。這次所介紹的「10nm微粒子檢測方法」突破50nm的極限可以藉由讓採樣時間拉長以進行10nm-1pcs./mL的評估。而且,不僅是過濾膜上所捕捉的微粒子濃度,將來只要微粒子的成分分析技術確立之後,可以推定粒子的產生來源時,就可以連結到超純水製造裝置的最佳化、高品質化的發展,結果可以期待對半導體裝置/元件的高品質提升有所助益。
參考文獻
- ITRS 2012 Yield Enchancement.
- 日本工業規格:JIS K 0554(超純水中の微粒子測定方法)。
- UC標準規格:遠心ろ過―電子顕微鏡法による超純水中微粒子計測法(離心過濾―利用電子顯微鏡法檢測超純水中微粒子方法)。
- 草野徹:クリーンテクノロジー(Clean Technology)、2007.11、P37.
- Particle Monitoring in Liquid, Xiaoliang Wang, April 2002.



留言(0)