摘要

研發廠空氣污染物排放減量之挑戰與策略
Keywords / Air Pollution18,Emission Reduction,Local Scrubber (LSC)5,Central Scrubber4
空氣污染問題已成為人們日常討論的議題,統計陳情案件,以高科技廠較為集中的新竹科學園區周圍空氣污染問題最多,而空污的來源大多數由未經適當處理的污染物經由煙囪排出。面對民眾生活環境及複雜製程所使用的化學物質,操作者應思考不僅符合法令規範,甚至要勇於將排放之氣體進行最妥善之削減後再行排放。本文針對廠區煙囪內所含有之無機酸(acid)、氨氣(NH3)與異丙醇(Isopropyl Alcohol, IPA)等混合排放之煙道進行來源分析,並依據理論基礎增設處理設備,進而重新定義排放種類,以達成空污減量,最終以空污排放達環境背景值為目標,以降低污染物對環境的衝擊。
前言
高科技產業是目前台灣重要的產業之一,其中半導體的產量與技術更位居世界上領先的位置。科學園區附近的工廠密集度居世界之冠。隨著高科技製程技術的精進,化學品原料的使用方式創新,進而導致大量的廢氣經由管道進入空污防制設備,經過處理後再排放至煙囪。但由於尾氣管線的規劃、污染防制設備之設計限制、防制設備之操作等問題,雖然單位時間的濃度符合法定規範,但工廠長時間運作的累積污染量依然可觀,另外,部分未經完全處理的污染物經由煙道排出後所至,目前排氣系統主要區分為酸性氣體排放(SEX)、含氨氣體排放(AEX)、有機氣體排放(VEX)與一般氣體排放(GEX),但因製程方式改變使酸、鹼、有機分流不佳導致混排造成中央處理設備(Central Scrubber)處理效率下降,進而導致空污排放量增加等問題產生。有鑑於此,秉持著綠色製造的精神,探討空污排放量能否有減量的機會,甚至以污染物排放低於環境背景值為目標努力。
在討論空污排放前,須了解製程尾氣來源:在半導體製產業中,機台需要各式化學品提供給相對應的製程使用,其簡易的製程流程包含熱氧化成長(Thermal Oxide Growth)、物理氣相沉積(Physical Vapor Deposition)、化學氣相沉積(Chemical Vapor Deposition)、磊晶沉積(Epitaxial Deposition)、離子植入(Ion Implantation)、蝕刻(Etching)、微影(Photolithography)、清洗(Clean)與擴散(Diffuse)等程序,而在製程中,蝕刻階段會使用硫酸、硝酸、氫氟酸、氨液等而清潔過程則會使用到異丙醇(Isopropyl Alcohol, IPA)、丙醇等有機溶劑。而排放管道中的污染物是因化學物質本身的揮發性被排氣系統收集,目前其尾氣流向(Exhaust)先經過現址式空氣處理設備(Local Scrubber),再集中至中央處理設備(Central Scrubber)進行此兩階段的處理後,才排放至大氣 圖1。但隨著半導體製程不斷演進,生產過程不斷精進以達積體電路線寬縮小之目的,導致尾氣中帶有之化學品亦越趨複雜,更有甚者包含酸鹼有機混排問題,以往單純經由Central Scrubber處理後再進行排放的作法儼然已不適用。
圖1、科技廠房煙囪排放流程圖

有關高科技廠區之空污混排相關資料較少,且鮮少有人針對酸、鹼、有機混排提出有效的對應處理方案。本研究主要針對這方面的不足進行深入研究,由煙道檢測開始先確定造成空污問題的污染物種類,進而朝向製程端機台尋找污染源;再依據文獻探討對應之處理方式,並經由各式防制設備的特性進行全面性的重新規劃。
文獻探討
為了能深入探討空污混排問題,需針對污染物種類進行採樣,以確立污染物來源。其次為解決污染物所造成的空污問題,進一步探討填充式洗滌塔對於各式污染物的去除機制與處理效率等研究,最後經由分析後確認可行之配置模式進行驗證空氣污染物的定義為危害人體健康及周邊環境有破壞性的物質,而高科技廠區已經針對污染物建置防制設備進行處理,但其煙道的排放特性為低濃度高風量,使得整體的污染物廢氣排放總量相對提升。依據[1]針對新竹科學園區內的20間工廠無機酸鹼排放量進行推估,發現以氨氣的排放量最大,有104.58ton/year,HF次之排放量為18.45ton/year。然而工研院環安中心[2]針對數家新竹縣半導體廠之廢氣進行研究,其Isopropyl alcohol與Acetone為常見污染物。但以本廠區實際排放風量為例,酸性排氣占全廠排放總量57%,其次為有機排氣與一般排氣約各佔18%,而鹼性排氣僅占7%,因此酸性排氣中的污染物削減顯得格外重要。
濕式洗滌塔
現行工廠中針對酸鹼氣體多以濕式洗滌塔(Central Scrubber)進行處理,對於HCl、HNO3、HF等酸所造成的酸氣與酸霧,多採用鹼液,如氫氧化鈉或氫氧化鈣水溶液進行吸收; NH3之吸收液則採用鹽酸或硫酸進行去除削減。
濕式洗滌塔去除氣體污染物的理論基礎在於氣體吸收的物質傳輸作用,藉著填充塔內之填充物的潤濕表面,而達到由氣相傳輸到液相的反應,此吸收作用以雙膜理論(two-film theory)[3]為基礎,發展出一套設計理論。其示意圖如 圖2,圖中已假設氣液相已經達到平衡狀態。假設A為污染物物種、B為載流氣體,且假設載流氣體B之擴散速度相對於介面是靜止,A藉著分子擴散與本身的移動所造成的傳輸速率可以用公式[1]表示:
圖2、雙膜理論示意圖[11]
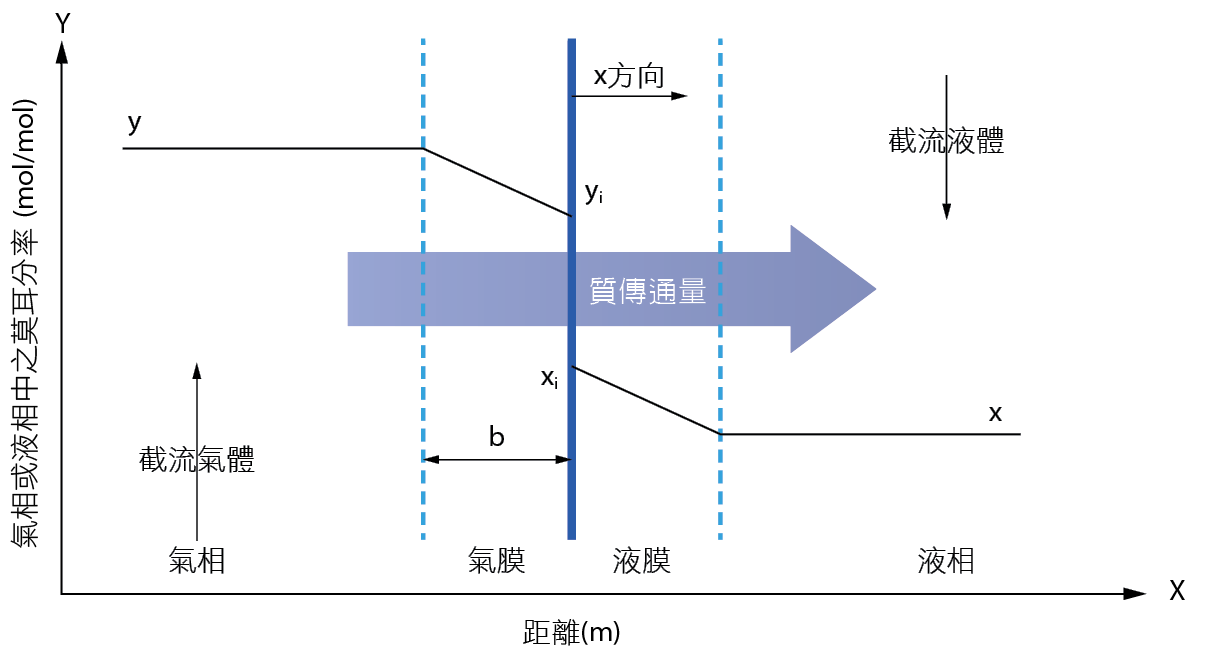
 ...........[1]
...........[1]
式子中的NA代表A傳輸速率,DAB為莫耳擴散係數,y為A之莫耳分率,b為擴散方向(X方向)之距離,Area為垂直擴散方向之擴散面積。
由於A物種之濃度在氣體B中極小,故A之莫耳分率y趨近於0,將公式[1]簡化整理後對dy由yt到y積分,db由0到Br積分,公式如下所示:
 ...........[2]
...........[2]
公式式中Br代表氣膜之厚度,單位為m,積分後可得公式如下:
 ...........[3]
...........[3]
公式[3]中kG即為氣相質傳係數,單位為 。
。
在液相中也可以用類似公式[1]的方式來表示A在液相中的擴散情形,在液相膜中亦可以得到下式
 ...........[4]
...........[4]
kx為液相質傳係數,單位為
利用上述之雙膜理論(Cooper and Alley, 1998)發展出下列各種去除效率之理論推導公式,主要以塔填充物料之高度與進出口濃度之間的關係,推導出下式:
 ...........[5]
...........[5]
公式中y1為洗滌塔進口端污染物濃度,單位為ppmv;y2為洗滌塔出口端濃度,單位為ppmv;hr為填充物料的高度,單位為m;ac為填充物料的比表面積,單位為 ;kG為氣相質傳係數,單位為
;kG為氣相質傳係數,單位為 ;Gmol為單位面積氣流之莫耳流率,單位為
;Gmol為單位面積氣流之莫耳流率,單位為 。
。
為了使操作人員結合洗滌塔的去除效率與理論公式,[4]針對半導體與光電產業洗滌塔去除氣體污染物效率推估提出公式[6],僅考量了滯留時間、填充物料比表面積與氣相質傳係數對去除效率的影響,如下所示:
 ...........[6]
...........[6]
公式中之t代表停留時間,單位sec,ac代表填充物料比表面積,單位為 ,kG為氣相質傳常數單位為
,kG為氣相質傳常數單位為 ,-0.0234則是將單位面積氣流之莫耳流率與塔高合併簡化而成,單位為,y1為洗滌塔進口端污染物濃度,單位為ppmv;y2為洗滌塔出口端濃度,單位為ppmv。
,-0.0234則是將單位面積氣流之莫耳流率與塔高合併簡化而成,單位為,y1為洗滌塔進口端污染物濃度,單位為ppmv;y2為洗滌塔出口端濃度,單位為ppmv。
為了考慮更多洗滌塔參數對去除效率所造成的影響,公式[7]中利用雙膜理論推估填充物料高度之理論公式[5],配合其他參數的經驗公式與洗滌塔的操作參數,推估得到下式:
 ...........[7]
...........[7]
公式中m為各污染物種之亨利常數所換算出來之常數,單位為
C、D、E分別為各種洗滌塔操作參數與經驗參數所計算出來的參數。
由理論公式中顯示洗滌塔之去除效率與洗滌塔進口端酸氣的濃度、酸氣的水溶性及溶入水中後的解離程度、液氣比、洗滌水品質、洗滌水pH值及停留時間成正比。
故由亨利定律可知,亨利常數越低,水溶性越差,愈不適合化學洗滌處理。液氣比(L/G)與亨利常數(m)之關係,其計算式如下式所示:依據[6]其各參數關係如下:
L / G ∝ MR / T
L:洗滌液循環水量(m3/min)
G:進氣廢氣量(m3/min)
M:亨利常數(M/atm)
R:常數=0.08205
T:絕對溫度(K)
由上式可知,液氣比(L/G)與亨利常數(M)成正比之關係,為了要得到大的液氣比(L/G)亨利常數越大越好,溫度越低去除效率越好,故若欲使用濕式洗滌塔對污染物產生有效去除則亨利常數越高越好,於此處列舉一些化學物質在25℃水中之亨利常數值如 表1所列。
|
污染物物種 |
HF |
HCI |
HNO2 |
HNO3 |
NH3 |
IPA |
|---|---|---|---|---|---|---|
|
亨利常數 |
1.85 |
727 |
50 |
21000 |
62 |
6.49 |
|
註:溫度為298K |
||||||
有機排氣處理
半導體廠揮發性有機排氣(VEX)與酸鹼排氣一樣具有低濃度大風量的特性,適合使用沸石濃縮轉輪處理技術[7],目前科學園區常用之VOCs去除方式如 表2[8],而依據廠區的特性目前高科技廠中多選用沸石轉輪吸附加焚化法進行VOCs去除。根據[9]高沸點之VOCs可使用冷凝法去除,此法有效去除尾氣中的高沸點VOCs,且可維持沸石轉輪的吸附與再生能力。而相對於IPA與Acetone等中低沸點的VOCs使用冷凝法則去除效率不甚理想,但若將其導入末端沸石吸附焚化系統處理可長時間保持95%以上之去除效率。經由文獻探討以及目前廠區之防制設備建置方式,有機尾氣的處理方式實以沸石吸附焚化較佳,但需注意酸性氣體與悶燃等現象對於沸石轉輪的危害[10]。
|
控制技術 |
優點 |
缺點 |
|
|---|---|---|---|
|
其它串聯不同處理設備 |
沸石濃縮轉輪+焚化 |
去除效率高(300ppm以下) 高濃縮比(20:1) 適用於大風量低濃度 燃料費較省(as活性碳固定床、RTO) 含高沸點化學品,可水洗(疏水性沸石) |
含高沸點化學品時,轉輪需定期水洗再生(廢水處理問題) 濃度較高時及操作處理不當時,有潛在的著火危險,需加 裝保護措施(N2及消防水自動噴灑) 輪轉壽命3~5年(高沸點成分脫附困難) |
|
沸石濃縮轉輪+RTO |
佔地空間小 高處理效益 |
系統壓力變動大 燃料費用高 高沸點化學品,或HMDS時,有蓄熱材堵塞問題 |
|
|
專業活性碳吸脫附系統 |
初設成本低 確保減廢效率(>90%) 操作成本低 無二次污染問題 費用低廉,技術成熟 |
不適合含水分之溶劑 不適合含粒狀物之廢氣 有火災之危險 廢棄活性碳處理問題 |
|
園區周界污染物
在周界污染物檢測上,清華大學使用GC/FID、GC/ECD及FTIR於園區內進行周界污染物偵測,結果顯示VOC污染物為Acetone、IPA、BETX、Cyclopentanone及PGMEA,其中IPA、Benzene及Toluene的濃度最高,平均值約在數十個ppbv左右,最高濃度大約150ppbv,另有少量氯化烴類,濃度約為數十到數百ppt。
Chen等人研究中利用GC-MS判定VOCs廢氣之顯著物質為IPA[14];Tsai等人分別利用IC及GC-MS進行中科園區大氣採樣之粒狀污染物質、水溶性離子及氣體樣本分析,denuder吸收系統採集、經分析後所得主要物質為SO2、HNO2及NH3;在PM10及PM2.5中所含有主要硝酸鹽(nitrate)、硫酸(sulfate)及銨鹽(ammonium)[15]。
綜觀國內外文獻,多為針對各別空氣污染物、同類型污染物種討論或改善其處理設備,如HF、HCl、H2SO4、HNO3、H3PO4皆為酸類,排放以濕式洗滌塔改善為主,另則建議不同類型空氣污染物於源頭分流後再行分別處理[15]。但由於半導體製程更新快速,依摩爾定律,積體電路上可容納的電晶體數目約每隔兩年便會增加一倍,相對半導體設備機台設計及化學品使用之演進也是日新月異,使用過往的製程廢氣處理流程已不足以有效去除目前煙道中的污染物。
計畫方法
本研究的目的是為了解決廠區中同一條管道中有著不同屬性的污染物俗稱混排,煙囪內污染物偏高的問題,其主要原因是目前廠內製程方式改良,導致嘗試找出混排機台為主要方向,並研擬出改善方法以解決排放量問題,由於排氣系統管路分佈遍及全廠,考量到分析時效與成本問題,因此採用直讀式儀器進行濃度分析。
建置污染物量測機制
參考環保署環檢所採樣量測方法及業界已使用的儀器 表3,其中MiTAP對於IPA檢測可進行即時量測,可輔助現場人員確認IPA來源,快速而即時。而對於低濃度NH3目前多使用API進行量測,但其體積龐大為其缺點,於污染物查找過程初期NH3多屬高濃度,當時可採用如TLD-1手持式氣體偵測器進行全檢,其攜帶性增加了採樣期間的便利性,以利採樣人員快速確認污染源。
|
儀器種類 |
分析原理 |
分析項目 |
|---|---|---|
|
離子層析儀(IC) |
流動相對固定相中的離子進行洗脫,離子中不同的物質會以不同的速度沿固定相移動,最終達到分離的效果,當移動相通過偵測器時,便可進行定性及定量的分析。 |
酸鹼離子 |
|
氣體層析火焰離子偵測器(GC-FID) |
利用層析管分離有機化合物後再以火焰離子偵測器測定強度後轉換為濃度。 |
有機化合物 |
|
氣體層析質譜儀(GC-MS) |
利用層析管分離有機化合物後被下游的質譜分析器捕捉,使離子化、加速、偏向後最終分別測定離子化碎片,依據質荷比(質量/電荷比值)進行篩選偵測,將這些分布情況與各種離子的相對強度作圖,即為質譜圖並換算濃度。 |
有機化合物 |
|
電感耦合電漿體質譜儀(ICP-MS) |
利用氬電漿所產生的高能量讓樣品同時進行乾燥、原子化及離子化,搭配惰性氣體碰撞系統及配有氧氣、氨氣與甲烷的氣體反應系統去除基質干擾,再經由四極柱進行質量分析。 |
金屬 |
|
不透光率儀(Opacity) |
入射光線經過介質而衰減之百分率。 |
白煙 |
|
氣體層析光離子偵測儀(GC-PID) |
利用層析管分析有機化合物後再利用惰性氣體真空放電現象所產生的紫外線(VUV),使待測氣體分子發生電離,並通過測量離子化後的氣體所產生的電流強度,從而得到待測氣體濃度。 |
異丙醇/丙酮 |
|
揮發性有機物微型氣相分析儀(MiTAP) |
利用高濃縮採樣系統、微型氣相層析模組、陣列式感測器從而得到待測氣體濃度。 |
異丙醇/丙酮 |
|
F2 (氟氣)Sensor |
電化學傳感器通過與被測氣體發生反應並產生與氣體濃度成正比的電子訊號。 |
F2 (氟氣) |
|
總碳氫化合物/甲烷/非甲烷 氣體分析儀(THC Analyzer) |
FID(Flame Ionization Detector)以火焰離子偵測器測定強度後以甲烷為計算基準轉換為濃度。 |
有機化合物 |
|
氮氣化物分析儀(NOX Analyzer) |
根據化學發光法作為設計原理與被測氣體發生反應並產生與氣體濃度成正比的電子訊號。 |
氮氣化物 |
|
硫氧化物分析儀(SO2 Analyzer) |
根據紫外光螢光法作為設計原理與被測氣體發生反應並產生與氣體濃度成正比的電子訊號。 |
硫氧化物 |
|
API氣體分析儀 |
氣體分析儀以化學發光法量測空氣中NH3氣體濃度,並配備一台外部熱轉換器與之結合,以先進的處理技術,提供精準且穩定的低濃度量測。 |
氨氣 |
污染源目標確認
混排主要發生於濕式蝕刻機台,其製程方式為同一腔體(chamber)中使用酸、鹼、有機化學品進行蝕刻(etch)與乾燥(dryer)又分流不佳導致問題發生,此情形不僅影響酸排煙道的排放量,亦影響鹼性排氣中的污染物濃度。為降低煙囪的污染物排放量,因此需要更進一步進行問題探討與現狀改善。依據實際運轉經驗顯示,單片式酸槽Wet bench製程,於機台單腔體內混合排放各項酸性化學物質、NH3及IPA等污染物 表4,造成Exhaust端無法分流的情況產生,經過Exhaust風管輸送至濕式洗滌塔加藥鹼洗後由酸性排氣(SEX)煙囪排放,由第二章中文獻探討已經了解,濕式洗滌塔對揮發性有機物IPA的去除效率不若酸性氣體來的好,故易造成廠區內污染物排放量升高。由於目前鮮少專家學者針對混排議題進行探討及提供解決辦法,因而我們使用一套創新的空污處理方案來解決此問題。
|
定檢項目 |
污染物 |
污染來源 |
|
|---|---|---|---|
|
V |
HF |
Tool |
Bench tool |
|
FAC |
廢水桶槽 |
||
|
V |
HNO3 |
Tool |
CWR/Etch/EPI parts Clean/Wet Bench |
|
FAC |
廢水桶槽 |
||
|
V |
HCl |
Tool |
CWR/EPI/Wet Bench |
|
FAC |
廢水桶槽/Lorry tank |
||
|
V |
H2SO4 |
Tool |
Wet Bench/ECP |
|
FAC |
SCR加藥系統/廢水桶槽 |
||
|
V |
H3PO4 |
Tool |
Wet Bench |
|
FAC |
廢水桶槽/Lorry tank |
||
|
V |
VOCs |
Tool |
Litho/Wet Bench/CWR |
|
FAC |
廢水桶槽/PV pump |
||
|
V |
NH3 |
Tool |
Wet Bench/ EPI/Etch/CVD/B.S. |
|
FAC |
廢水桶槽/Lorry tank/ RCW/LSS |
||
|
V |
Cl2 |
Tool |
Etch/DIF |
|
FAC |
廢水桶槽 |
||
|
NA |
SOX |
Tool |
NA |
|
FAC |
VOC/LSC燃燒副產物 |
||
|
NA |
NOX |
Tool |
NA |
|
FAC |
VOC/LSC燃燒副產物 |
||
我們有了上述所介紹的工具後,則開始訂定量測方法,需依照尾氣排放流程循序漸進,本次實驗以酸槽機台之尾氣為例由機台設備產生→分流設備→現址處理設備→終端處理設備 圖3,但為溯源以確認明確混排機台,其污染物追查方式反向進行為:煙囪煙道→排氣主管→排氣次主管→排氣支管→生產機台。
圖3、酸槽機台尾氣處理流程

排氣主管量測
廠區共有27根主風管(submain)需進行量測,每支需確認其待評估之污染物濃度,如量測到高濃度異丙醇後,即追查上游機台來源。由於主風管靜壓較強,採樣時需使用高真空泵浦,進行氣體樣本取樣,以利增加捕集率。
尾氣處理設備量測
酸槽機台製程腔體末端先經由尾氣處理設備預處理後才排入主風管,為更精確確認污染物來源之機台,需經由尾氣處理設備後方之管路開孔進行量測,此時需與設備同仁確認機台為使用狀況下且並未進行PM等保養動作,再行採樣。經過採樣收集後可確認污染源之機台,後續再經由排放種類重新規劃,達到污染物減量的目的。
結果與分析
改善成效
本研究對於煙道中的總排放量減量提出對應的做法,有效降低了廠區內的排放總量 表5,目前已將上述方案分享給各運轉廠區,甚至於未來建廠規畫上期望以目前運轉中所碰到的議題進行探討,並以此為基礎進行新廠設計與規劃。
|
污染物 |
改善項目 |
改善方法 |
預估改善成效(K/Y) |
背景值(K/Y) |
是否達背景值 |
|---|---|---|---|---|---|
|
五酸 |
源頭改善 |
新技術導入-填充層導入高效率蜂巢式濾材,風管型wet LSC |
10.75→5.38 (-50%) |
0.61 |
N |
|
WWT Tank建置智慧調節閥、水封箱,廢水場源頭高濃度酸鹼排氣減量 |
|||||
|
末端處理 |
循環水質改善-建置local RO處理系統降低水中酸離子濃度 |
||||
|
鹼 |
源頭改善 |
排氣分流-Benchtool (不含IPA)去酸後進入AEX處理系統 |
6.53→2.8 (-60%) |
1.35 |
N |
|
末端處理 |
循環水質改善-建置Resin/RO循環水旁濾系統移除 |
||||
|
IPA |
源頭改善 |
排氣分流改善-Benchtool/WWT tank去酸鹼後進入VOC處理系統 |
7.50→2.61 (-60%) |
2.69 |
Y |
|
末端處理 |
Central Scrubber供應水質改善:MAU air washer回收水取代RCW |
||||
|
有機 |
源頭改善 |
建立廠區VOCs排放平衡圖-評估高濃度Tool裝設Condenser |
10.24→5.12 (-50%) |
1.71 |
N |
|
末端處理 |
VOC潔淨空氣導入脫附段-提高VOC去除率 |
||||
|
VOC沸石轉輪參數最佳化-提升T3脫附溫度、T5脫附後溫度 |
某廠區 2018空污排放量108→35K/Y,減量67.6%,2019預計減量至35→15K/Y,較2018再減量66% 圖4,其污染物改善方式於後續舉例說明。
圖4、某廠空污排放改善成效

利用改管解決鹼性氣體排氣中「異丙醇」排放問題
緣起:某廠區於2017年7月空污自檢發現AEX內VOCs排放平均值達34ppm (2016自檢<1ppm),此狀況可能因濕式洗滌塔無法有效處理有機污染物導致,有機污染物先經由THC分析儀器進行總濃度確認,後續經由MiTAP檢測儀器針對IPA進行採樣,發現煙道內之VOCs組成以IPA為主,故削減IPA為主要改善方向。
問題:LAM EOS PS (polymer stri-pping)為single wafer機台,其製程方式為同一腔體內使用鹼性及有機類的化學品,於Tool端AEX exhaust約有800ppm IPA,而氨氣濃度則<50ppb,由前述國內外學者研究結果可以得知,目前廠區內防制設備現況,中央濕式洗滌塔並不適用於處理VOCs,固然IPA水溶性較佳但相對於半導體廠內的污染物屬於高風量低濃度,且設計滯留時間約為0.8sec,因而異丙醇於濕式洗滌塔的處理效率不佳。
對策:與設備合作進行採樣,確認製程方式無酸性物質出現於排放管道後,改管至既有之沸石轉輪加焚化爐式防制設備進行處理,其VOCs總處理效率約可達到95%以上,此案例中的異丙醇處理效率可保持在90%以上,有效的削減鹼排中異丙醇的排放問題。
同一機台分製程進行分流改善酸性氣體排氣中「異丙醇」及「氨」排放問題
緣起:2009年某廠開始發現排氣風管風門處有結晶狀況,清查後發現酸性排氣風管中NH3濃度測值大於150ppm;2012年某廠發現酸排煙囪有明顯白煙判斷為機台排氣酸鹼混排造成氨鹽類結晶發生;2016年測出某廠酸排氣中IPA濃度超過5ppm已影響到潔淨室AMC品質,除此之外煙道污染物沒有經過妥善處理後排放確實會造成觀感不佳與污染物排放量增加等問題。
問題:DNS SU-3X00系列機台因設計製程中HF/H2SO4/NH3/IPA反應均在同一個腔體內發生,原污染物分流方式為採用Switch Box進行酸鹼有機尾氣切換,但依據採樣儀器對分流後尾氣進行分析,有切換功能不佳的問題,進而造成酸鹼氨鹽,以及酸排煙囪含IPA問題。此外NH3及IPA使用水洗式洗滌塔的削減率受到理論限制,此狀況亦是造成空污排放問題的原因。由上述狀況得知混排情形發生於酸槽機台,因而針對機台所使用的化學品種類,區分為三種狀況:
- Acid/NH3/IPA混排
- Acid/NH3混排
- 各式Acid 排放
依據混排差異做不同的分流處理,此方式更減少額外添加硫酸造成二次污染物排放問題 圖5。
圖5、酸槽機台混排處理方式
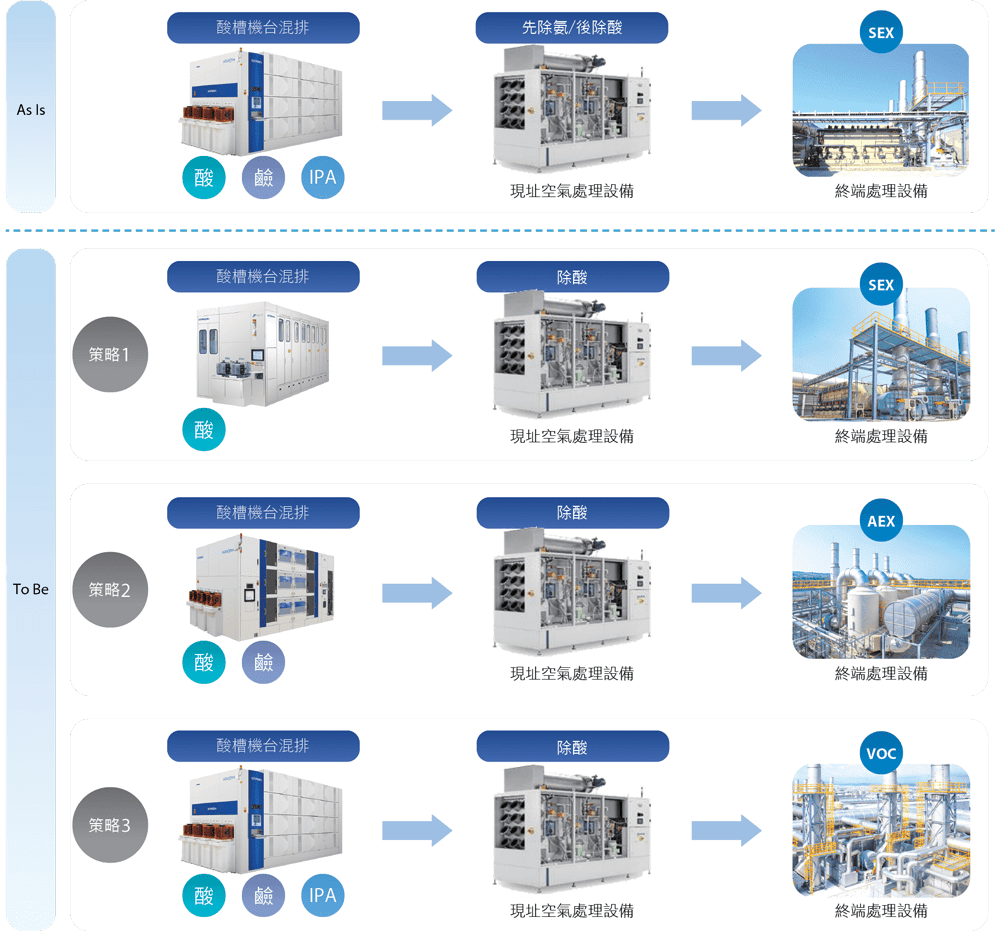
對策:
- 於酸槽機台後方安裝現址式洗滌塔(DAS Salix),過程中僅使用水霧配合拉西環進行水洗,此階段的功能為去除混排中的酸鹼廢氣,避免因酸鹼造成沸石轉輪與風管腐蝕等風險,移除酸鹼後再使用沸石轉輪與燃燒爐結合的設備去除混排中的有機污染物。
- 對於機台使用酸與NH3化學品情形下,與上述處理方法類似,先以現址式洗滌塔去除酸性污染物後排放進含氨氣體排放(AEX),此方法利用中央式現址處理設備加入廢硫酸以去除尾氣中的氨氣,符合混排後分段處理的目的。
- 廠區內有著為數不多僅使用酸性化學品的酸槽機台,此改善方式為安裝現址式洗滌塔(DAS Salix),排入酸性氣體排放系統,以減少中央式濕式洗滌塔的負載,可達到高濃度污染物現址處理的目的,避免因稀釋後造成濃度降低,去除效率不佳的問題。
利用尾氣處理設備改善廢水場中「異丙醇、氨、總酸」排放問題
緣起:桶槽區污染物以異丙醇、硫酸、氨氣為主,其中桶槽區酸排中的異丙醇佔某廠總量的16.6%,而鹼排中則佔59.8%,因而對於酸鹼排中的排放量減量此區域的污染物處理亦刻不容緩。
問題:原桶槽區域之尾氣種類僅單純分類為酸排與鹼排,但藉由簡易的尾氣分類至兩種排氣已無法滿足目前的空污排放要求,由於桶槽內的廢水收集相當複雜,若處理不佳恐造成煙道酸鹼混排產生鹽類,進而導至白煙形成,與污染物排放問題,為減少空污排放目前將桶槽分類為以下幾種 表6。
|
項目 |
IPA減量 |
NH3減量 |
總酸減量 |
|---|---|---|---|
|
WWT Soruce |
 |
||
|
前端 處理對策 |
 |
||
|
終端 處理對策 |
 |
||
- 桶槽含有異丙醇、酸與氨氣
- 桶槽含有異丙醇與酸
- 桶槽含有氨氣與酸
- 桶槽單純含有酸性物質
對策:
- 先經由兩台尾氣處理設備並配有酸、鹼加藥系統,第一台設備的洗滌液pH控制於3,以移除尾氣中的氨氣,接續由第二台現址處理設備進行再處理,其加藥控制點定為pH10,此舉可獲得兩項優勢,包含去除尾氣中的酸性物質與避免管路腐蝕,最終末端尾氣再經由VOC防制設備進行處理,此方式與製程機台相同,可有效去除尾氣中的IPA濃度。
- 桶槽含有異丙醇與酸的尾氣,藉由現址處理設備安裝並控制加藥以達成洗滌液pH約控制於10,末端再排放至有機氣體排放進行處理。
- 桶槽含有氨氣與酸,分別安裝兩台現址處理設備加藥控制洗滌液為pH3與pH10,最終由含氨濕式洗滌塔進行最終處理。
- 桶槽單純含有酸性物質,為避免白煙形成與達成總酸減量的目的,由現址處理設備加藥控制洗滌液於pH10再排入酸性濕式洗滌塔以符合小風量高濃度現址處理的原則。
結論
過往空氣中的污染物常被忽略,直到近年因PM2.5等懸浮微粒污染物逐漸被各界重視後才加緊對空氣污染物的重視。無機酸、鹼、異丙醇於空污防制設備處理過後可有效改善空污問題,但空污改善仍與上游機台所使用的化學品種類與製程方式息息相關,創新與進步一直是半導體產業追求的目標,當然在產業精進的同時,廠務同仁們也竭盡所能的將各式污染物減量以利於降低對環境的衝擊。
目前廠區持續針對煙囪加裝多種污染物即時監控系統,以利隨時了解改善成效與運轉最佳化狀態確認,且可於較短時間內確認污染物來源,並針對污染物提出有效處理方案,但目前的即時監控系統並無法針對全部污染物進行分析,需探尋新的儀器與方案使污染物來源確認更加精準。尾氣處理是一個持續改善循序漸進的過程,現在廠區還是致力於改善煙道中的非甲烷碳氫化合物、硫酸等污染物,持續改善其污染物來源,以及未來製程變更下所需的對應處理方法。相信在運轉空污防制設備的同時,不僅需要顧及設備穩定且要堅守於改善煙囪污染物排放達環境背景值的目標,此兩項的結合才得以跟上綠色製造的腳步。
參考文獻
- 蔡春慶「新竹科學園區空氣污染物量測及處理效率提昇研究計畫」期末報告,新竹科學園區管理局,2002年
- Chein, H.M, Chen, T.M., “Emission Characteristics of Volatile Organic Compounds from Semiconductor Manufacturing”, Journal of The Air & Waste Management Association, 53(8), pp.1029-1036 (2003).
- Cooper, C.D.; Alley, F.C., Air Pollution Control: A Design Approach, 2nd ed., Chapter 7 &13, Waveland Press, Inc., Taiwan, 1994
- 白曛綾「新竹科學園區半導體及光電製造業空氣污染防制設施績效提升輔導」期末報告,新竹科學園區管理局,2001年
- 蘭舜煒「某半導體廠週界異味來源及控制研究」,交通大學,2002年
- 黃宗銘「某TFT-LCD廠濕蝕刻機台酸性製程排氣的白煙去除研究」,交通大學,2006年
- 蘭舜煒「某半導體廠週界異味來源及控制研究」,交通大學,2002年
- 游建華「高科技產業沸石轉輪操作條件之研究」,「區域與環境資源永續發展研討會」,2011年。
- 高科技產業揮發性廢氣處理技術及操作處理成本,2010年
- 林育旨「沸石轉輪吸附材改良與結合冷凝器效能提升研究」,交通大學,2005年
- 黃俊超「高科技產業無機酸鹼廢氣組成與填充式濕式洗滌塔控制效率之研究」,交通大學,2003年
- 張豐堂「沸石濃縮轉輪焚化技術常見問題與解決方法」,清華大學
- 羅俊光、蔡培癸,2000,“新竹科學工業園區環境空氣中有害物質監測分析”,新竹科學工業園區管理局委辦計畫,國立清華大學原子科學研究所
- Chen, H.M, Chen, T.M., “Emission Characteristics of Volatile Organic Compounds from Semiconductor Manufacturing,” Journal of Th e Air & Waste Management Association, 53(8), pp.1029-1036 (2003).
- Tsai, J.H., Huang, Y.S., Shieh, Z.X., Chiang, H.L., “Concentration Chara-cteristics of VOCs and Acids/Bases in the Gas phase and Water-soluble Ions in the Particle Phase at an Electrical Industry Park During Construction and Mass Production”, Journal of Environmental Science and Health Part A-Toxic/ =Hazardous Substances & Environmental Engineering, 46(5), pp.540-551 (2011)


留言(0)