摘要

燃燒水洗式洗滌塔 操作參數與副產物探討
Keywords / Burning type,By-product2,Destruction Efficiency (DRE),Local Scrubber (LSC)5,FTIR3
製程廢氣中危害性氣體及全氟碳化物(PFCs)僅能由現址式空氣處理設備(Local scrubber)處理削減,而Local scrubber之操作參數與製程廢氣去除效率息息相關,為確保削減效率,大多以「Worst Case」進行參數設定,有能源浪費之虞;本研究以FTIR實測廠內正常生產時Local scrubber削減效率,並以燃燒式為首要討論範疇,其操作溫度高(1200℃以上)且機台數量多(占比26%),實測發現生產時濃度負載率小於50%,進而衍生副產物及能源浪費等問題,未來將朝調整Local scrubber運轉參數發展,並以相同研究方法推廣至其餘Local scrubber類型,達到削減效率達標又不對環境造成額外負擔。
前言
半導體產品相關製程複雜多樣,且製程中所使用之化學物質種類繁多,產生之廢氣依其特性可分為酸性、鹼性、有機性及一般排氣。機台端之製程排氣一般會先由附屬之尾氣處理設備(Local scrubber, LSC)處理後,再排放至中央廢氣處理系統。製程廢氣中危害性氣體及全氟碳化物(Perfluorinated compounds, PFCs)僅能由Local scrubber處理削減,如 圖1,而Local scrubber之操作參數與製程廢氣去除效率息息相關,參數如何精準設定,才能使去除效率達標又不生成副產物汙染環境,顯然是一門值得深入探討的課題,其中燃燒式Local scrubber操作溫度高(1200℃以上) 且機台數量多(占比28%),如 圖2,為本文首要討論範疇。
圖1、Local scrubber削減排放

圖2、300MM Local Scrubber T 圖1、Local scrubber削減排放 ype(取自FAM 2018.01)

文獻探討
Local scrubber削減規範
根據300mm規範將待處理之製程尾氣分為毒性(Toxic)、易燃性(Flammable)、發火性(Pyrophoric)、腐蝕性(Corrosive)及全氟碳化物(PFCs),並詳細定義Local scrubber削減能力如 表1, Banks等人[1]研究指出全氟碳化物中C-F鍵結能量穩定,具有很強之紅外線吸收力與熱穩定,要完全去除四氟化碳(CF4)尾氣處理設備燃燒室溫度應提高到1600℃以上,其可於大氣中存留50,000年如 表2,故此五大類中最難以削減即為PFCs,其亦是最穩定之溫室氣體。
|
Gas classify |
代表氣體 |
LSC削減能力 |
|---|---|---|
|
Toxic |
Hydride, Cl2, etc. |
DRE>99%, 或出口氣體濃度 <1 STEL |
|
Flammable |
H2, SiH4, NH3, CO, etc. |
出口氣體濃度<10% LEL |
|
Pyrophoric |
SiH4, etc. |
出口氣體濃度<10% LEL |
|
Corrosive |
NH3, HF, SiF4, Cl2, HBr, etc. |
DRE>90%, 或出口氣體濃度 <1 STEL |
|
PFC |
CF4, NF3, C2F6, C3F8, SF6,etc. |
DRE>95%, except CF4 DRE >90% |
|
Greenhouse Gas |
Atmospheric lifetime (yrs) |
Global Warming Potential (GWP100) |
|---|---|---|
|
CO2 |
5-200 |
1 |
|
CF4 |
50,000 |
5,700 |
|
C2F6 |
10,000 |
11,900 |
|
SF6 |
3,200 |
22,200 |
|
C4F8 |
3,200 |
10,000 |
|
C3F8 |
243 |
14,800 |
全氟碳化物90%去除效率所需處理溫度如 圖3,CF4為PFCs中最穩定之化合物,用於蝕刻(Etching) 製程中移除晶圓上之薄膜,以達到產生所需圖案(Pattern),其全球暖化潛勢(Global Warming Potential, GWP)為二氧化碳的5,700倍(以100年計),穩定性極高,至少需1350℃以上對其才具削減能力,業界中廣泛使用之尾氣處理設備僅有燃燒式及電漿式[2],才可達到其處理溫度,其中又以燃燒式Local scrubber發展較成熟完善。
圖3、PFCs 90%去除效率對應溫度及流量

燃燒式尾氣處理設備 (Burn type local scrubber)
利用瓦斯燃燒產生高熱,使氣體經過高溫處理(1200℃以上)後裂解,再經由水洗將污染物水解/離子化後進入液相而去除,如 圖4所示。該設備在使用端(Point-of-Use)藉由瓦斯與氧氣操作參數之調整,運用成熟的燃燒/水洗技術來分解PFCs,可達到高效率(大於95%)之PFCs廢氣處理,解決許多精進製程在提高生產效率的同時相對帶來的挑戰。目前Burn type LSC在半導體產業中大約占總量的15~20%,主要應用於非無塵室ETC process與大量使用氫氣機台如EPI process。雖然使用瓦斯燃燒可有效處理PFCs等溫室氣體,卻易衍生氮氧化物(NOx)等副產物,如 圖5,NOx破壞自然生態的平衡,為環境保護者及立法者首要管制的廢氣,亦是本研究探討重點。
圖4、Burn type local scrubber構造流程圖
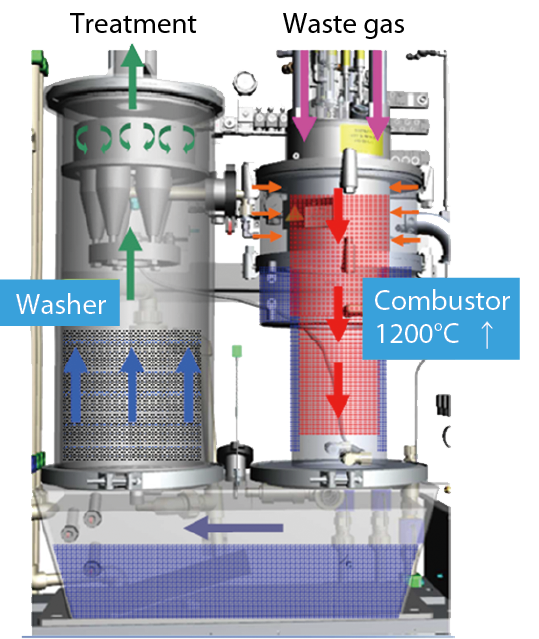
圖5、工研院DAS ESCAPE DUO DRE test(Burn type LSC)
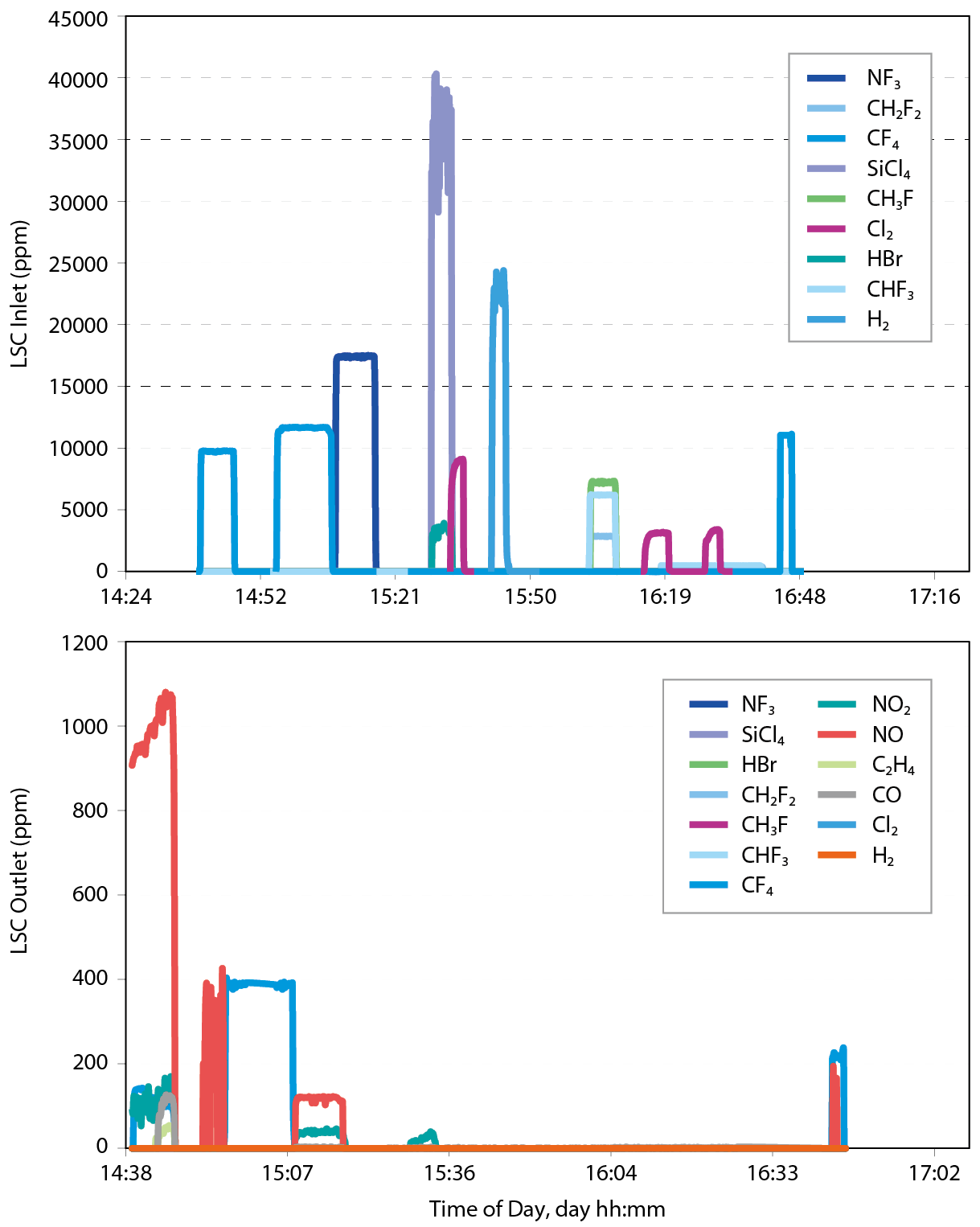
Local scrubber操作參數
Local scrubber瓦斯與氧氣之操作參數,仰賴第三方公正單位「工研院」進廠實測之結果,其檢測時常以主機台特氣“質流控制器”(Mass flow controller, MFC)之“最大量”視為排放尾氣,符合其去除效率(Destruction Removal Efficiency, DRE)之Local scrubber操作參數則為日後設定數值;但正常生產時特氣流量一定“小於”MFC最大量,推測此時之Local scrubber操作參數雖可滿足DRE規範,卻可能造成能源過剩,進而產生額外副產物,如 圖6,正是本研究主要目的。
圖6、DRE檢測與正常生產比較
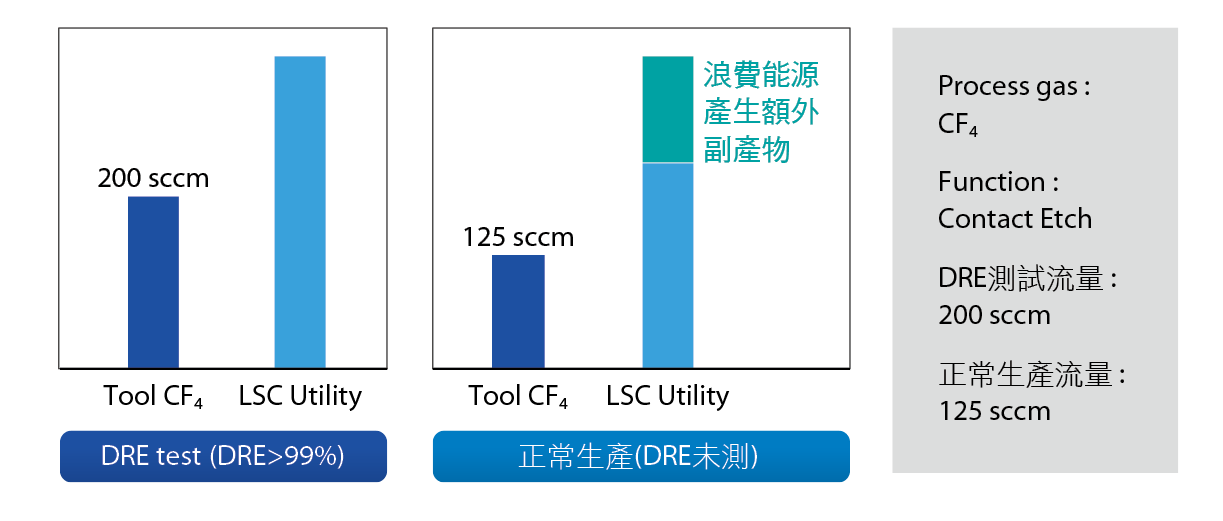
計畫方法
DRE量測儀器評估
傅立葉轉換紅外線光譜儀(Fourier Transform Infrared Spectroscopy, FTIR)
紅外線光譜(Infrared, IR)的原理為分子中各種不同鍵結結構產生分子間振動,轉動模式時,吸收了適當的紅外光能量而得到的光譜,紅外線光譜能提供分子結構特性的資料,FTIR即利用干涉儀產生干涉圖譜經傅利葉轉換成IR光譜,根據Beer-Lambert定律,由IR光譜中得到分子吸收紅外光後之吸收光譜,和指紋區光譜 圖7作各種定性比對及定量分析 圖8。
圖7、指紋區光譜圖

圖8、FTIR原理

質量流量計(Mass Flow Meter)
質量流量計原理為科氏力效應(Coriolis Effect),科氏力來自物體運動的「慣性」。物體在轉動體系中進行直線運動時,由於慣性作用,將會有沿著原方向繼續運動的趨勢,但因體系本身在轉動,物體經歷一段時間的直線運動後,位置將有所變化,若以轉動體系的視角去觀察,它的運動方向就會發生偏離。科氏力是在轉動體系中觀察到的一種「假想的偏移力」圖9,流體流過振動的U形管時,科式力效應便會起作用,使流入端A與流出端B之間的流動反向,並且將管路扭曲,物體的重量與速度互成比例關係,因此透過量測扭曲量,便可以知道其質量流量。
圖9、質量流量計原理說明(KEYENCE網站)

電化學式氣體偵測器(Gas Detector)
氣體偵測器原理為Chamber內裝電解液與雙電極,當特定氣體進入時,會透過薄膜而吸收,內部產生氧化或還原,可得到電子流變化換算成濃度。
以上三種儀器類型對於Local scrubber DRE量測之適用性評估如 表3所示,僅FTIR類型符合量測需求,其中ACM-150光鏡長度固定,導致量測濃度受限,無法符合Local scrubber入口高濃度需求,如 表4與 圖10,故選定FTIR其進行實測。早期Brandon等人[3,4]將FTIR應用於電子零件包裝廠和煉鋁廠等工作 場所,而應用於半導體廠房內氣體之量測,則以Levine等人[5-7]所發表之相關論文最多也最詳盡,其重點多以評估其定性、定量之可行性為主;另有Chang等人[8,9]發表亦可量測到SF6、CF4、IPA (異丙醇)等化合物;葉等人[10]將其用於量測乾式洗滌塔入、出口進行效能評估,為本研究效法對象。
|
儀器 |
原理 |
量測物種 |
偵測極限 |
精準度 |
適用性 |
|---|---|---|---|---|---|
|
FTIR |
利用干涉儀產生干涉圖譜經傅利葉轉換成IR的光譜,由IR光譜中可以得到分子吸收紅外光後之吸收光譜,和指紋區光譜作各種定性比對及定量的分析。 |
有圖譜皆 可偵測 |
最低可到ppm 而異) |
2%. |
○ 可適用Inlet及Outlet量測 |
|
FTIR 氣體監控系統 |
多點式氣體傅立葉轉換紅外線光譜偵測技術,將氣體偵測整合於單一裝置之中,依序偵測最多達60個量測點可自行規劃設定,提高靈活度。 |
有圖譜皆 可偵測 |
最低可到ppm 而異) |
2%. |
僅能用於Outlet (LSC失效,偵測器會失準,需校正) |
|
熱質量流量計PN 100 |
利用不銹鋼毛細管與電阻溫度計測量氣體導熱係數來換算質量流量。 |
CF4/NF3 |
不適用 |
5% |
僅能測量純氣 |
|
科氏力質量流量計 |
直接或間接測量在旋轉管道中流動的流體所產生的科氏力就可以測得質量流量。 |
CF4/NF3 |
不適用 |
5% |
僅能測量純氣 |
|
電化學式氣體偵測器 |
Chamber內裝電解液與雙電極,當特定氣體進入時,會透過薄膜而吸收,內部產生氧化或還原,可得到電子流變化換算成濃度。 |
NF3 |
3.6~40 ppm |
3%. |
僅能用於Outlet (LSC失效,偵測器會失準,需校正) |
|
電化學式氣體偵測器 |
Chamber內裝電解液與雙電極,當特定氣體進入時,會透過薄膜而吸收,內部產生氧化或還原,可得到電子流變化換算成濃度。 |
CF4 |
0~999 ppm |
3%. |
僅能用於Outlet (LSC失效,偵測器會失準,需校正) |
|
電化學式氣體偵測器 |
Chamber內裝電解液與雙電極,當特定氣體進入時,會透過薄膜而吸收,內部產生氧化或還原,可得到電子流變化換算成濃度。 |
H2 |
0~100 %LEL 0~100 %LEL |
3%. |
僅能用於Outlet (LSC失效,偵測器會失準,需校正) |
|
儀器 |
偵測方式 |
光鏡長度 |
Max 量測濃度 |
|---|---|---|---|
|
FTIR |
單點式 |
1cm/10cm/1m/10m |
100,000 ppm |
|
ACM-150 |
多點式(Max 60點) |
5 m |
300~400 ppm |
圖10、DAS ESCAPE DUO DRE test(Burn type LSC)
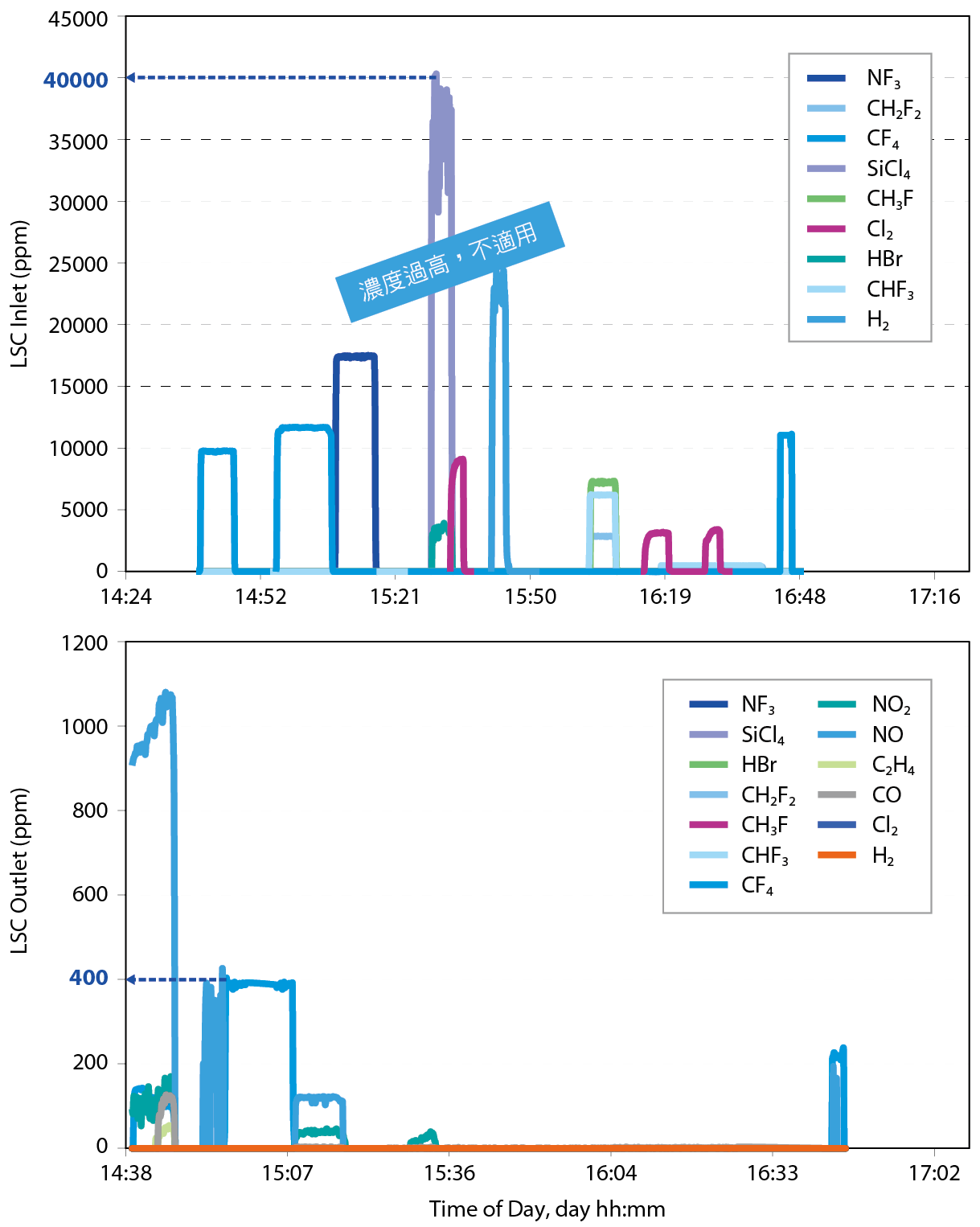
DRE量測方法
製程廢氣由主機台經真空泵(Dry pump)排入Local scrubber處理,本研究試驗係於Local scrubber入口端及出口端各別架設FTIR,如 圖11,量測製程廢氣經由Local scrubber處理前、後濃度,進而換算成廢氣削減效率(DRE),運算公式如下。

where
i : gas as CF4, SF6, SiH4, etc.
j : inlet/outlet
M : mass, g
C : volumetric gas concentration, parts per million by volume, ppmv (760torr.~298K)
Q : volumetric gas flow rate, lpm
ρ : gas density, g/l
圖11、FTIR量測架構圖

結果與分析
EPI Function DRE Result
DAS STYRAX Local scrubber用於N-EPI製程,其製程廢氣中指標物種為SiH2Cl2 (Dichlorosilane, DCS),廠內實測結果如 圖12,Local scrubber入口SiH2Cl2濃度最高 9,274 ppm,並在Local scrub-ber無檢測出SiH2Cl2,DRE試算符合工研院測試(大於99.9%),但「正常生產」時Local scrubber入口濃度遠小於「工研院DRE報告」中濃度(16,381 ppm),如 表5,可評估調整Local scrubber瓦斯與空氣配比,避免能源浪費。
圖12、廠內實測DRE test (DAS STYRAX)
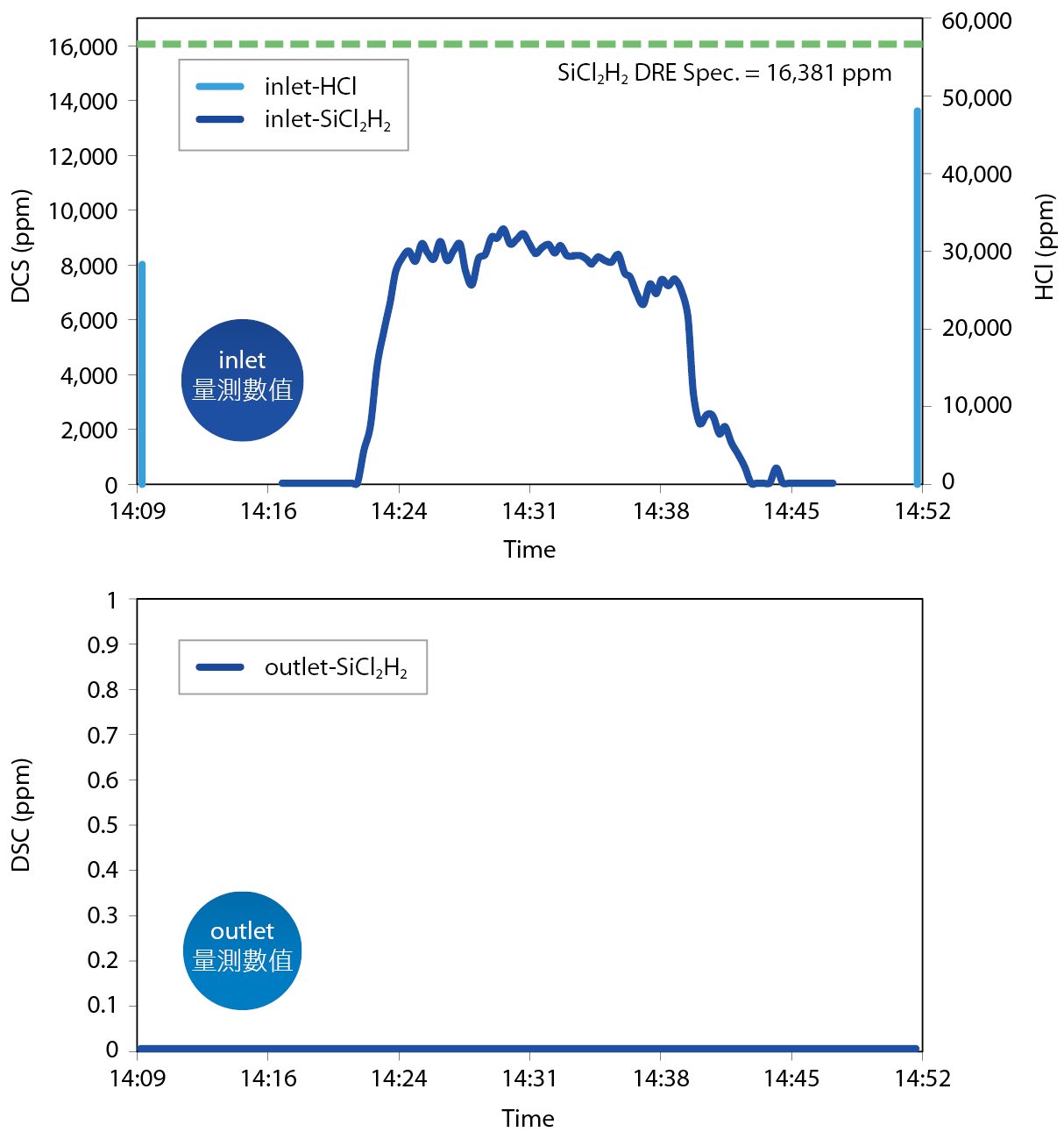
|
製程 |
LSC機型 |
運轉參數 |
指標物種 |
inlet 濃度(ppm) |
outlet 濃度(ppm) |
DRE去除效率 |
|
|---|---|---|---|---|---|---|---|
|
工研院檢測 |
N-EPI |
DAS-Styrax |
NG : 15.5 slm |
SiH2Cl2 |
16,381 |
N.D. |
>99.9% |
|
廠內實測 |
N-EPI |
DAS-Styrax |
NG : 15.5 slm |
SiH2Cl2 |
9,274 |
N.D. |
>99.9% |
Edwards Helios Local scrubber用於P-EPI製程,廠內實測結果如 圖13,Local scrubber入口SiH2Cl2濃度最高10,734 ppm,並在出口端檢測出濃度最高2.34 ppm,DRE試算符合工研院測試(大於99.9%),但「正常生產」時Local scrubber入口濃度僅略小於「工研院DRE報告」中濃度(12,000 ppm),如 表6,則不考慮調整Local scrubber相關參數。
圖13、廠內實測DRE test (Edwards Helios)
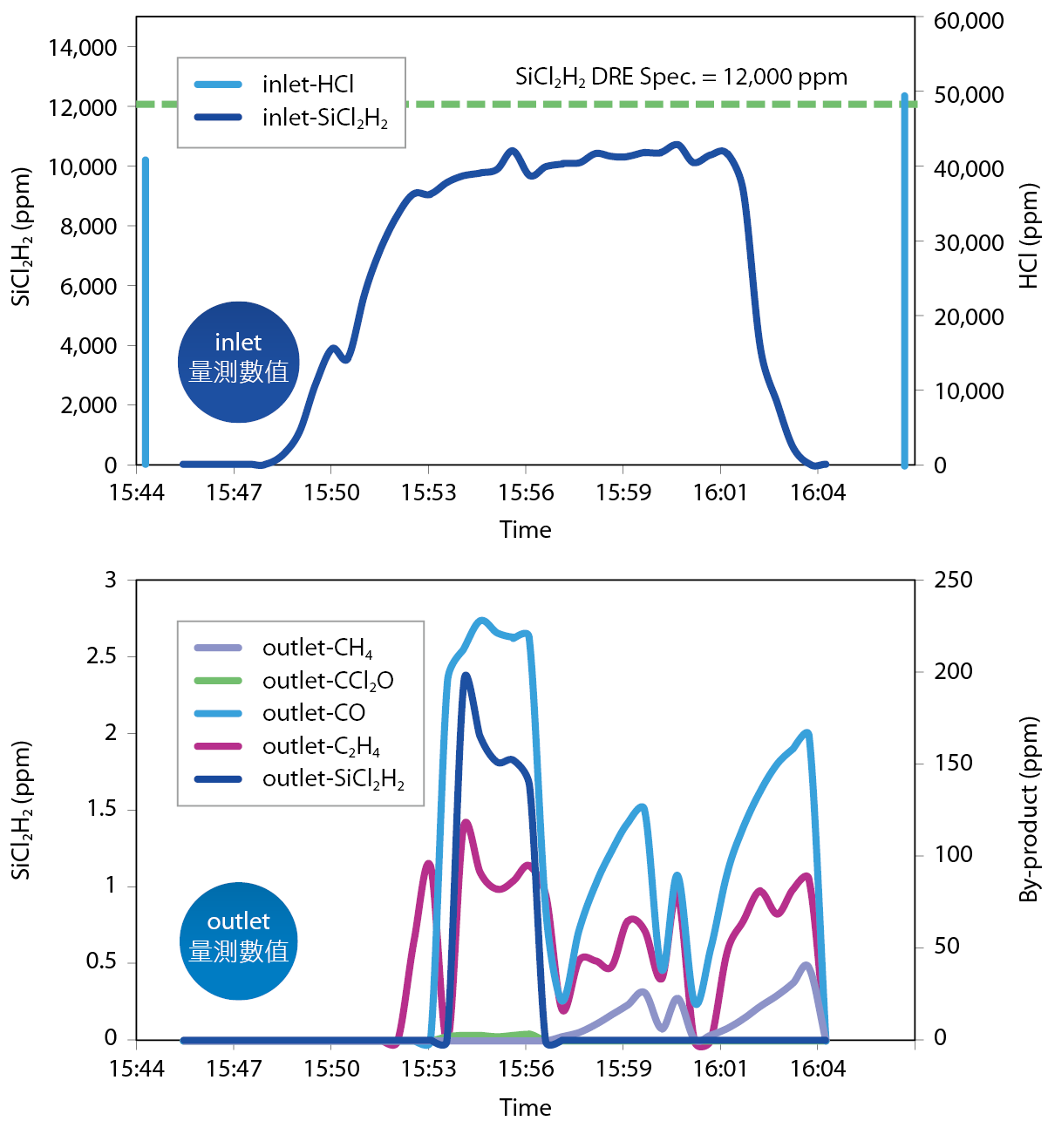
|
製程 |
LSC機型 |
運轉參數 |
指標物種 |
inlet 濃度(ppm) |
outlet 濃度(ppm) |
DRE去除效率 |
|
|---|---|---|---|---|---|---|---|
|
工研院檢測 |
P-EPI |
Edwards-Helios |
NG : 24.5 slm |
SiH2Cl2 |
12,000 |
N.D. |
>99.9% |
|
廠內實測 |
P-EPI |
Edwards-Helios |
NG : 24.5 slm |
SiH2Cl2 |
10,734 |
2.34 |
>99.9% |
ETCH Function DRE Result
Edwards Atlas Local scrubber用於ETCH製程,其製程廢氣中指標物種為CF4 (Tetrafluoromethane),廠內實測結果如 圖14,Local scru-bber入口CF4濃度最高1,550ppm,並在出口端檢測出濃度最高1.51 ppm,DRE試算與工研院測試相近(99.5%),但「正常生產」時Local scrubber入口濃度遠小於「工研院DRE報告」中濃度(7,327 ppm),如 表7,出口端反而有CO(~126ppm)、NO(~33.7ppm)、HNO2(~1.1ppm)等副產物生成,判斷為Local scrubber瓦斯與空氣用量過多,大於正常生產時所需用量,導致O2與N2燃燒反應生成。
2N2 + 3O2 → 2NO + 2NO2
圖14、廠內實測DRE test (Edwards Atlas)

|
製程 |
LSC機型 |
運轉參數 |
指標物種 |
inlet 濃度(ppm) |
outlet 濃度(ppm) |
DRE去除效率 |
|
|---|---|---|---|---|---|---|---|
|
工研院檢測 |
Etch |
Edwards-Atlas |
NG : 46.8 slm |
CF4 |
7,327 |
8.1 |
99.9% |
|
廠內實測 |
Etch |
Edwards-Atlas |
NG : 42 slm |
CF4 |
1,550 |
7 |
99.5% |
為證實上述論點,將Edwards Atlas Local scrubber於「不進氣」狀態下進行空燒,即Local scru-bber僅通入瓦斯及空氣燃燒排放,則出口端有CO(~60.7ppm)、HNO2(~0.62 ppm)生成,如 圖15,其中HNO2易分解為NOx,故證實Local scrubber進氣量不足時,反而更容易產生NOx等副產物。
圖15、廠內實測DRE test(Edwards Atlas-空燒)

廠內DRE實測結果分析
廠內DRE實測結果如 表8,Local scrubber入口指標物種濃度負載率低,以Etch製程為例,CF4負載率僅21.2~47%、CHF3僅有1.9%,與原設計濃度差異大,而當濃度負載不足時,反而容易會有副產物生成(NO:33.7 ppm、CO:126~189 ppm),實測DRE結果,CF4可達到99.5%,遠大於台積規範90%,仍有彈性空間可評估依實際製程氣體用量,調整Local scrubber參數來提升濃度負載率,並使副產物減量,達到效率與節能並重。
|
LSC機型 |
製程 |
運轉參數 |
指標 物種 |
inlet 濃度 (ppm) |
DRE 去除效率 |
By-Product |
|||||
|---|---|---|---|---|---|---|---|---|---|---|---|
|
工研院 檢測 |
廠內 實測 |
負載率 |
工研院 檢測 |
廠內 實測 |
OI規範 03-002) |
工研院 檢測 |
廠內實測 |
||||
|
DAS-Styrax |
N-EPI |
NG : 15.5 slm |
SiH2Cl2 |
16,381 |
9,274 |
56.6% |
>99.9% |
>99.9% |
>95% |
未檢出 |
未檢出 |
|
HCl |
53,069 |
47,958 |
90.4% |
>99.5% |
>99.5% |
>95% |
|||||
|
Edwards- Helios |
P-EPI |
NG : 24.5 slm |
SiH2Cl2 |
12,000 |
10,734 |
89.5% |
>99.9% |
99.9% |
>95% |
CH4 : 3.4 ppm |
CH4: 115 ppm |
|
Edwards- Atlas |
Etch |
NG : 36.4 slm |
CF4 |
1,015 |
477 |
47.0% |
99.9% |
99.7% |
>90% |
未檢出 |
CO: 189 ppm |
|
CHF3 |
12,415 |
231 |
1.9% |
>99.9% |
>99.9% |
>95% |
|||||
|
Edwards- Atlas |
Etch |
NG : 42 slm |
CF4 |
7,327 |
1,550 |
21.2% |
99.9% |
99.5% |
>90% |
未檢出 |
NO: 33.7 ppm |
|
Edwards- Atlas |
Etch 乾燒) |
NG : 24 slm |
- |
- |
- |
- |
- |
- |
- |
- |
HNO2: 0.6 ppm |
結論
本文實測結果:
- Etch製程入口CHF3、CF4濃度僅原始設計值之1.9、21.2~ 47%,能源浪費。
- 相比工研院資料,負載率低時反而額外產出By-product。
- 廠內實測DRE皆99.5%以上,大於台積規範5~10%,仍有空間調整。
溫室效應日益重視,國際巴黎協定及國內溫管法紛紛提出相關減量政策,台積電針對PFCs氣體設置Local scrubber削減處理,為確保削減效率,大多以「Worst Case」進行參數設定,實際生產時濃度負載率小於50%,進而衍生副產物及能源浪費等問題,為了解決一次汙染,反而製造了二次汙染。在能源緊縮的未來,更需重新審視Local scrubber設置的精準性,並與供應商及學術界合作研發削減效能連續監測,配合產線負載,適時調整運轉參數,既可使削減效率達標又不對環境造成額外負擔。
參考文獻
- Banks, R.E., Smart, B.E., and Tatlow, J.C.(1994), “Organicfluorine Chemistry, Plenum Press”, New York.
- 陳孝輝(2004),半導體PFC廢氣處理技術—熱電漿破壞法,電漿處理在環境工程之應用技術研習會。
- Brandon, R.W., Trautwien, J., 1992; “Application of Fourier Transform Infrared Remote Sensing to Air Quality Monitoring in the Workplace”, Special Publication Royal Society of Chemistry, 108: 77.
- Brandon, R.W., Schlosser, R.L., 1992; “FTIR Open Path Site Survey of Toxic Gas Emissions at an Aluminum Smelting Plant”, MDA Scientific, Inc..
- Strang, C.R., Levine, S.P., 1989; “The Limits of Detection for the Monitoring of Semiconductor Manufacturing Gas and Vapor Emission by Fourier Transform Infrared (FTIR) Spectroscopy”, Am. Ind. Hyg. Assoc. J., 50: 78.
- Herget, W.F., Levine, S.P., 1986; “Fourier Transform Infrared(FTIR) Spectroscopy for Monitoring Semiconductor Process Gas Emission”, Appl. Ind. Hyg., 1: 110.
- Strang, C.R., Levine, S.P., 1989; “A Preliminary Evaluation of the Fourier Transform Infrared (FTIR) Spectrometer as a Quantitative Air Monitor for Semiconductor Manufacturing Process Emissions”, Am. Ind. Hyg. Assoc. J., 50: 70
- Chang, S.Y., Tso, T.L., Lo, J.G., 1994; “Determination in Situ of Chemical Solvent Vapors in a Semiconductor Workplace with an Open Path FTIR Spectrometer”, J. Chin. Chem. Soc., 41: 685.
- Huang, Y.S., Chang, S.Y., Wu, R.T., Yeh, M.P., 1995; “Serendipity Type of Exploring the Residue Gases from a Common Semiconductor Work-place by Using New Open Path FTIR Spectroscopy Approach”, The Third Asian Conference on Analytical Sciences, Seoul , Korea: 62 .
- 葉銘鵬,吳榮泰,余榮彬,1999,應用霍式紅外光譜法調查半導體廠製程危害性氣體,工業技術研究院工業安全衛生發展中心。
- 錢建嵩(2007), The Characterization of Combustion for Large Objects in a Bubbling Fluidized Bed Incinerator.
- Chinggaam Lin, C.H. Tsai, and L. D. Chen (1999), Operational Practices of Scrubber Systems in Semiconductor.
- 張勝祈(2008),晶圓廠區洗滌設備異常事件之風險評估與改善對策。
- 環保署,空氣污染防制法,2014。
- 環保署,半導體製造業空氣污染管制及排放標準,2002。
- 行政院環保署發布,「2015年中華民國國家溫室氣體清冊報告」,民國104年2月26日。
- 關於氮氧化物對環境的危害及汙染控制技術,2012。(http://big.hi138.com/gongxue/huanjinggongcheng/ 201211/428892.asp#.WKBoo2997cs)



留言(0)