摘要

16/20奈米提高良率技術XCDA新應用
Keywords / Foup Cleaning,XCDA,Purifier
壓縮乾燥空氣CDA(Compressed Dry Air) 在半導體廠扮演著非常重要的角色,幾乎半導體廠內的每台設備機台都需要使用到CDA。300mm晶圓廠甚至以CDA再經過純化器(Purifier) 過濾大氣中的許多不純物質後成為XCDA(Extra Pure CDA)再加以應用於先進製程上,使晶圓於製造過程中能全程保鮮,降低環境空氣對晶圓的汙染,並提高產品良率。 本文將介紹XCDA之系統架構,並詳細說明XCDA如何創新應用於半導體廠之晶圓製造過程與對晶圓製造良率之影響,使大家對XCDA新應用領域能有基本了解。
前言
對半導體晶圓製造廠而言, 「產品良率」是非常重要的指標,良率對一家公司之營運競爭力有極為重要的影響,所以對半導體晶圓製造廠而言,無不竭盡所能提高產品之良率以強化公司之競爭力! 尤其對發展先進製程之半導體晶圓廠,高良率即代表著晶圓廠具備先進之領先製造生產技術。
隨著先進製程技術日新月異,台積電於2014年起生產20奈米與16奈米之先進半導體製程晶圓產品,對於新製程生產技術而言,生產過程中對晶圓之各種汙染源都對先進製程產品之良率有重大之影響。
目前台積電對於20奈米與16奈米之先進半導體製程機台設備已規劃完整XCDA FOUP purge供應系統,為因應大量XCDA purge 氣體供應量之需求,300mm廠務處亦已完整規畫擴充先進製程晶圓廠之XCDA供應量與品質監測分析儀器系統,並於未來之新建廠房建廠初期,即會規畫裝設XCDA監測分析儀器系統,藉由此品質監測分析系統24小時不間斷的監測XCDA供應品質,以實現高品質之XCDA氣體供應系統,提供最先進之製程晶圓廠使用。
XCDA氣體應用
XCDA之由來原本是因應微影設備機台ASML之需求而產生,當時因ASML於機台內微影系統之鏡片(lens)需要高度純淨之環境,以避免極精密之鏡片因曝光之高能量與環境中之氣體不純物反應而產生副產物(byproduct)汙染鏡片影響微影設備之運作。由於其純度要求極高,而需要以CDA再經過純化器去除空氣中之主要不純物(如 表一)後所產出之超高純淨度extra pure CDA (XCDA) 作為purge lens之氣體!
|
Impurity |
SPG standard Inlet purity requirement |
SPG standard outlet purity |
|---|---|---|
|
H2O 水 |
<25.0 ppm |
<1 ppb |
|
TOC (as C7H8) 有機化合物之含碳總量 (甲苯) |
<200 ppb |
<0.01 ppb |
|
Acids ( as SO2) 酸性物質(二氧化硫) |
<50 ppb |
<0.01 ppb |
|
Bases ( as NH3) 鹼性物質(氨) |
<50 ppb |
<0.01 ppb |
|
Trace impurities***,雜質*** |
<50 ppb total |
<0.01 ppb |
|
Particle size 最大粉塵顆粒 |
@ 0.1μm |
|
|
*** Trace impurities include refractory compounds (HMDSO), phthalates, carboxylic acids and NOx. 雜質包括不易反應的化合物(苯甲酸乙酯)、鄰苯二甲酸、羧基的酸、氮氧化物。 |
||
當今之半導體先進製程已發展至20奈米與16奈米甚至將來更先進之製程之際,晶圓製造過程中對於晶圓所接觸之環境或汙染物質更為敏感,更因晶圓放置於FOUP 圖一內停留在製程機台進貨平台(Load Port)上進行晶圓製造過程中會導致所謂「毒氣室效應」 圖二,亦即晶圓表面釋出氣體大量停留於FOUP內並且與潔淨室之環境空氣或水分直接接觸造成晶圓表面凝結或有腐蝕等各種缺陷情況發生,以往製程工程師要避免晶圓表面產生凝結或腐蝕之方法有二:晶圓製造流程需於一定時間內完成;要求製造部(MFG)拆批。此兩種方法不僅需增加製程機台數量造成生產成本增加,也會因拆批而加重製造部(MFG)與自動化部門(AMHS)之OHT(overhead Hoist Transfer),運轉負荷量 圖三!
圖一、FOUP 與FOUP Purge 圖示

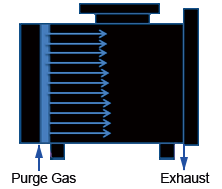

圖二、FOUP 內之XCDA Purge 改善毒氣室效應
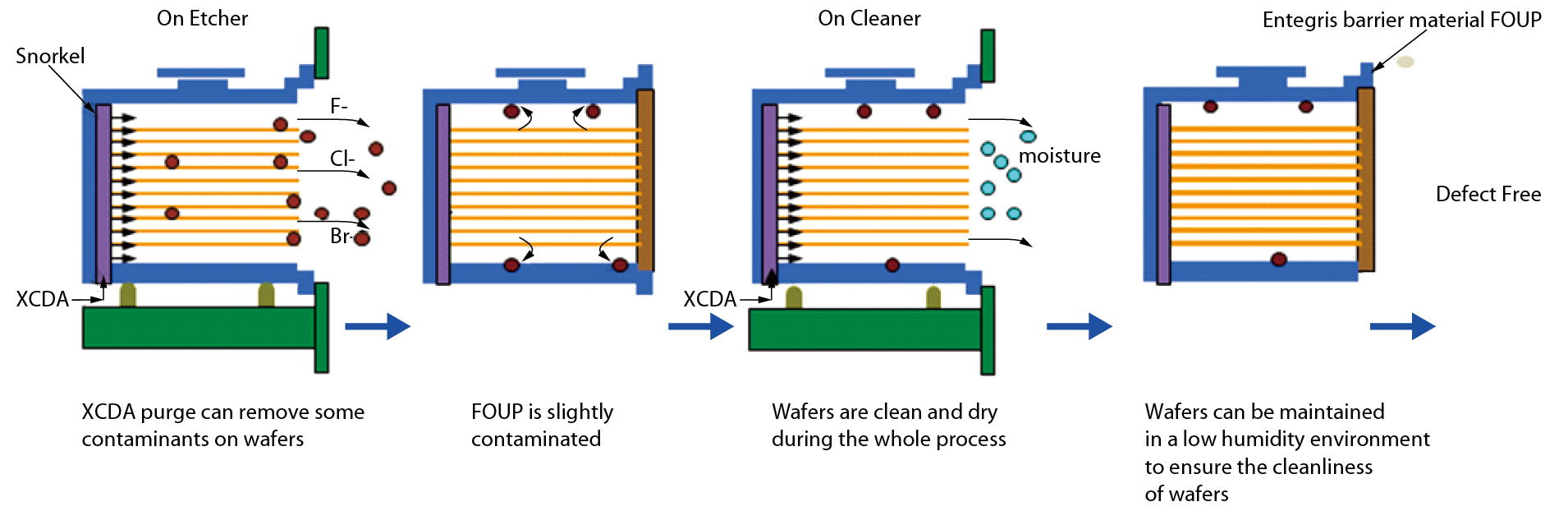
圖三、無塵室內之OHT 運送系統
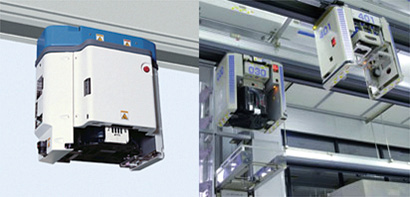
藉由XCDA purge使晶圓置於FOUP內充滿超高純淨度之XCDA氣體環境中,能降低FOUP內濕度與O2濃度,避免產品變異,而且裝設於Load Port上其效果較為及時,並且有助於提早帶走晶圓原表面之釋出氣體,且可因應不同需求增加預先沖吹(pre-purge)與後續沖吹(post-purge)的功能,目前由Entegris的Snorkel FOUP來與purge Load Port搭配。綜合以上之論述,XCDA Load Port FOUP 沖吹之好處簡單歸納如下:
- 缺陷改善
- 容許等候時間延長
- 不需要拆批
- 良率改善
經由截取製程設備機台與Load Port 圖四的傳輸訊號,在不修改機台軟體的前提前下,以外部控制器來控制沖吹動能,而目前已能夠藉由TAP來控制控制器驅動Load Port FOUP沖吹功能 圖五。
圖四、機台Load Port 與其 Purge Hole
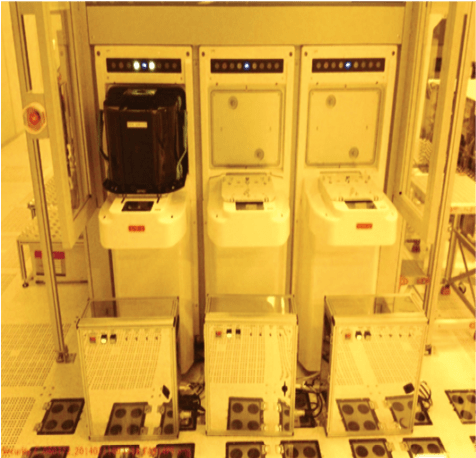

圖五、機台Load Port Purge 控制方法
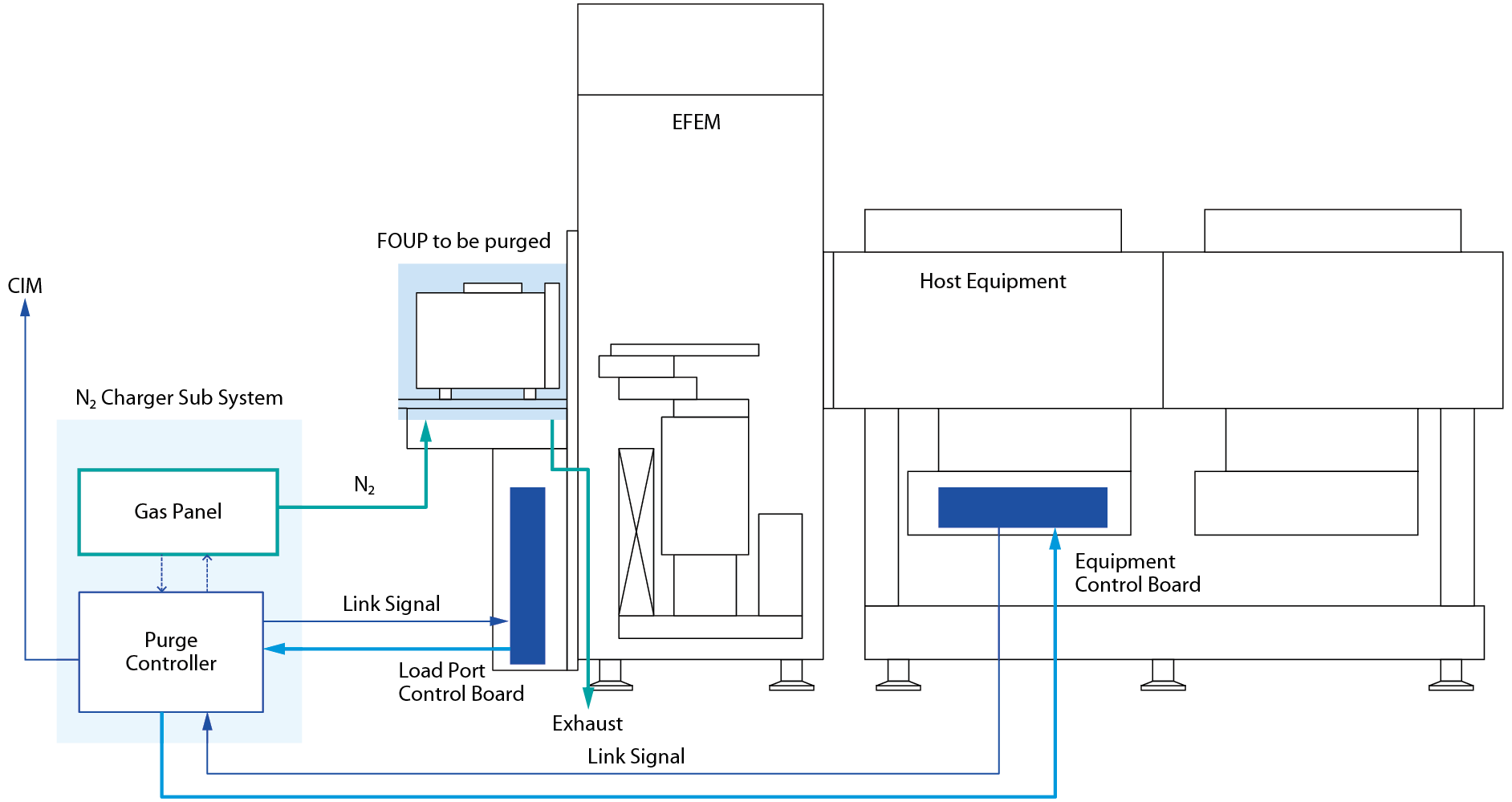
XCDA氣體供應系統架構說明
前一節將XCDA應用簡單說明後,本節將說明XCDA氣體供應系統架構。XCDA氣體系統為CDA經過純化器純化後產出之超高純淨度壓縮空氣。CDA為空氣經由壓縮機(compressor)壓縮成高壓高溫氣體後經緩衝槽(Receiver tank)後再經由乾燥機(Dryer)去除水分,由PCV (Pressure Control Valve)調整控制所需之供應壓力。
調壓後之CDA再經由氣體過濾器(Gas Filter)去除CDA中之微塵粒子後再由純化器(purifier)去除CDA氣體中之不純物如:H2O、TOC、Acids、Bases、Refractory Com-pounds等。
因XCDA屬於超高純淨度之P級氣體,需要有XCDA CQC (Con-tinuous Quality Control)連續品質控制監測分析儀器系統,藉由此品質監測分析系統即可24小時不間斷的監測XCDA供應品質,其氣體供應系統架構如 圖六。
圖六、XCDA 氣體供應系統架構

CDA氣體純化技術
XCDA是CDA經由SAES之CDA氣體純化器(purifier) 圖七去除CDA中之各種氣態不純物所得到的純化氣體。
圖七、CDA Purifier

CDA purifier利用吸附(adsorption)與脫附(desorption)再生原理反覆使用吸附桶內之吸附材。SAES CDA化器使用GSZ203之ALS (Allumino Silicates)吸附材質 圖八來吸附CDA氣體中之不純物H2O、TOC、Acids、Bases、Refractory Compounds等,其吸附桶之吸附作用原理如 圖九。
圖八、CDA Purifier ALS 吸附材料
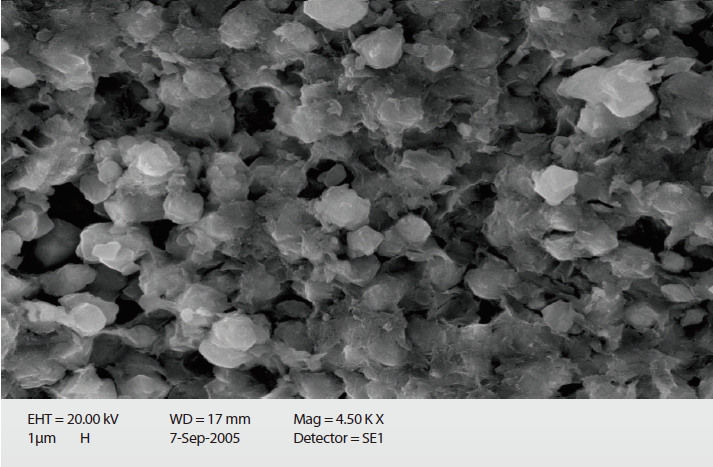
圖九、CDA Purifier 吸附作用
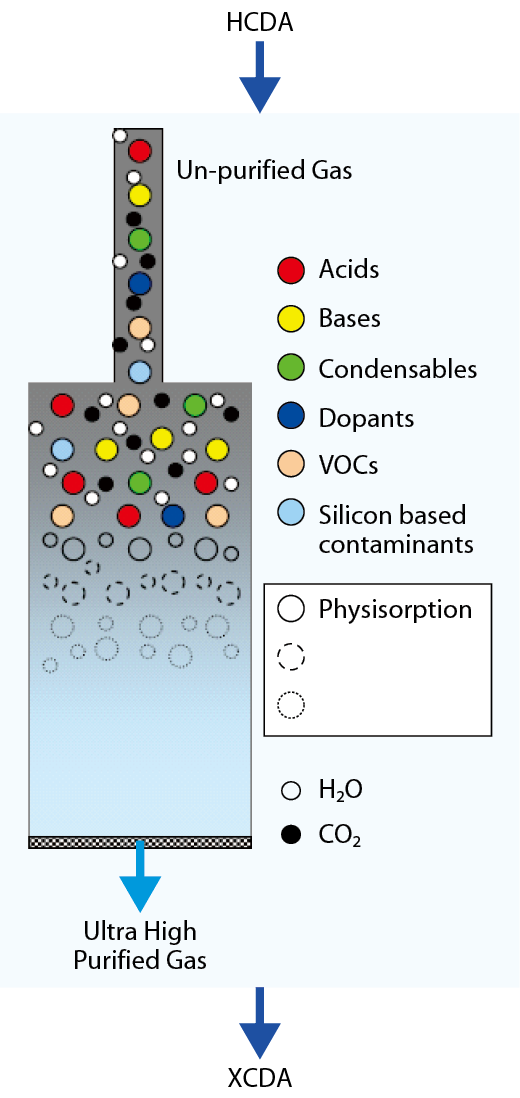
現在SAES所使用之CDA purifier吸附材料GSZ-203為目前SAES所研發之最新型使用於最先進之CDA純化吸附材料,茲介紹如下:
- Material Base: High Surface Allumino Silicates (ALS)
- Gasse Purified: Primarily CDA but also Bulks (N2, Ar, He, H2)...
- Impurities Removed: H2O, CO2, VOC, Condensables, Refractory compounds (siloxanes, slianols, silazones…), NH3, SO2, NOX...
- Examples of Purification Reac-tions:
ALS + H2O→ALS × H2O (Physical Adsorption)
ALS + CO2→ALS × CO2 (Physical Adsorption)
ALS + HCs→ALS × HCs (Physical Adsorption)
ALS + SO2→ALS × SO2 (Physical Adsorption)
ALS + NH3→ALS × NH3 (Physical Adsorption)
XCDA品質精進方案
現在全球半導體晶圓廠普遍使用的SAES CDA純化器其純化品質可以達到ppb等級之純化氣體,但因晶圓製造技術日新月異,如何精進改善XCDA之氣體品質來進一步降低晶圓製造過程之汙染,提高晶圓製造產品之良率是台積電重要目標。目前可改善XCDA純化品質方法有以下兩種。
去除更多不純物如CO、H2、CH4
可以,但相當昂貴。當初設計 XCDA目的是為purge微影機台lens使用,主要是去除acides、bases、TOC等不純物,因此選擇ALS為純化材料,若要去除類似N2 purifier所能去除之impurity如CO、H2、CH4則需加裝觸媒床(catalyst bed),因成本偏高,故較不建議以此方式改善!
去除相同不純物但更乾淨
SAES 可改善XCDA purifier的GSZ 203吸附材質(ALS)使其XCDA 品質達到更純淨之目標,Acids, Bases, TOC將可由目前0.01ppb改善為0.001ppb 表二。此種改善方式是以最少成本與最快速的方式,即可以立刻改善XCDA之品質的方法!建議以此種方式,即可很快的使XCDA氣體品質得到很大的改善!
|
Impurities Removal Items |
XCDA Purifier |
|
|---|---|---|
|
As Is |
To Be |
|
|
H2O |
< 1 ppb |
Can improve to < 0.1 ppb |
|
O2 |
N/A |
NA |
|
H2 |
No. Can be added if this was concerned. Can meet < 0.1 ppb |
need to add catalyst |
|
CO |
No. Can be added if this was concerned. Can meet < 0.1 ppb |
need to add catalyst |
|
CO2 |
No. Can be added if this was concerned. Can meet < 0.1 ppb |
NA |
|
CH4 |
No. Can be added if this was concerned. Can meet < 0.1 ppb |
need to add catalyst |
|
NMHC / TOC |
< 0.01 ppb |
Can improve to < 0.001 ppb ( 1 ppt) |
|
Acids |
< 0.01 ppb |
Can improve to < 0.001 ppb ( 1 ppt) |
|
Bases |
< 0.01 ppb |
Can improve to < 0.005 ppb ( 5 ppt) |
|
Refractory Compounds |
< 0.01 ppb |
Can improve to < 0.001 ppb ( 1 ppt) |
XCDA品質監測系統架構
以往XCDA品質監測系統是附屬於廠務機械課AMC監測儀器之內,是以批次間斷不連續方式進行XCDA氣體品質監測,並非持續監控系統,且分析點位於無塵室內XCDA主管路末端,無法對XCDA品質做最即時(Real Time)的監測,而且也無量測H2O與Particle之分析儀器。
為改善上述缺點,300mm廠務已規畫增購一套完整的XCDA分析儀器包括了TOC 圖十、TS 圖十一、NH3 圖十二、H2O與Particle共五種形式不純物分析儀器,並將分析儀器之取樣點(sampling port)設置於純化器後之主管路上,此XCDA品質分析儀器系統架構可及時監測純化器出口之XCDA氣體品質,其系統架構之改善如 圖十三。
圖十、XCDA TOC 分析儀器

圖十一、XCDA TS 分析儀器

圖十二、XCDA NH3 分析儀器

圖十三、XCDA 品質監測系統架構改善
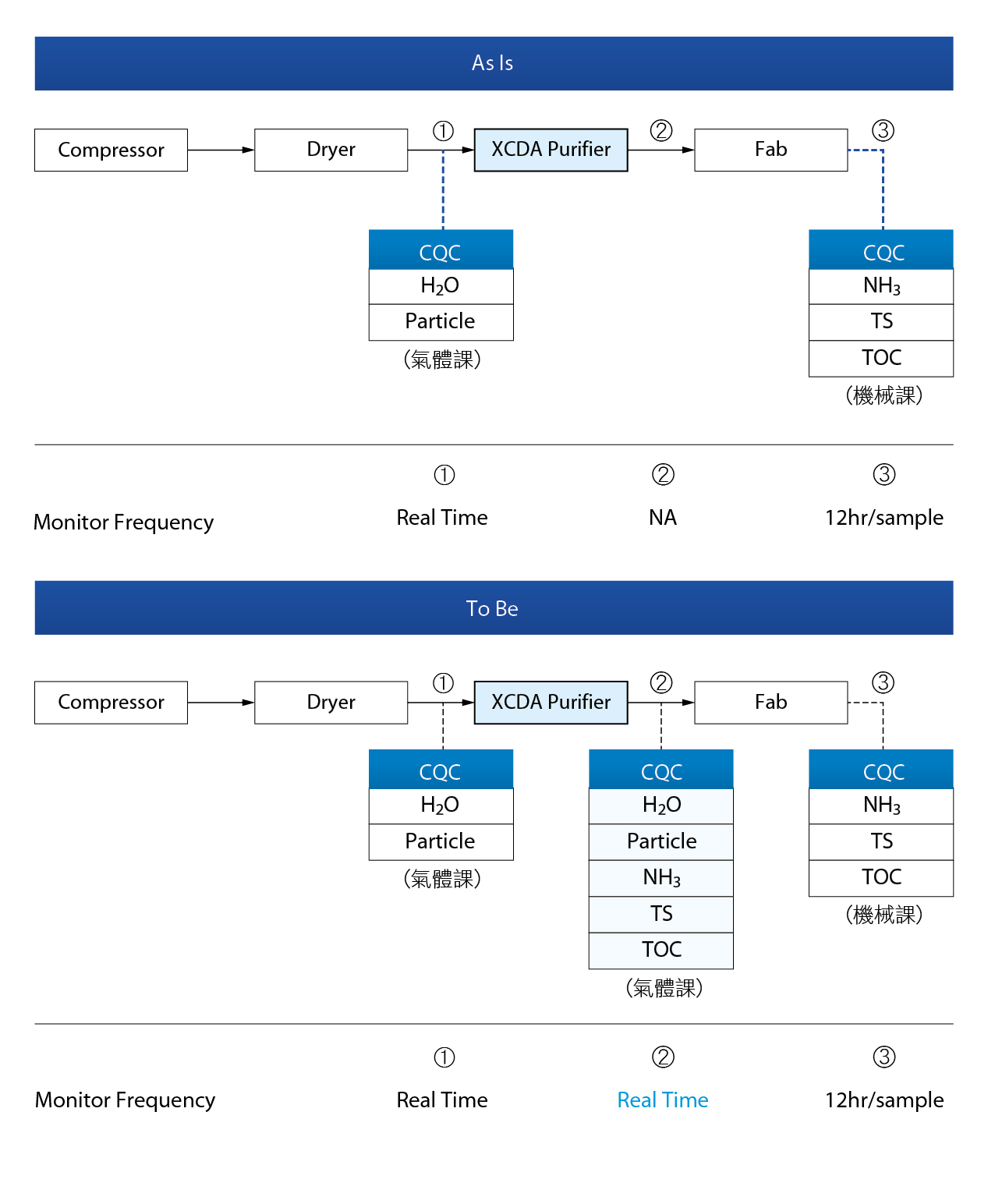
結論
在當今全球半導體先進製程技術日新月異激烈競爭之際,能提高產品良率增加產品競爭力,具備領先全球半導體廠的製程技術能力是我們所追求的共同目標。進入20奈米先進製程之後,XCDA於晶圓生產過程中扮演著越來越重要之角色!
300mm廠務已完整規劃擴大XCDA供應系統與強化品質監測分析系統於未來先進製程晶圓廠之廠房設計中,未來興建之新廠房將具備有充裕完備之XCDA供應量與精密之品質監測分析系統,24小時即時不間斷的監測XCDA供應品質以提供最先進之製程晶圓廠使用!期能共同創造持續領先全球的最先進半導體製造技術能力!
參考文獻
- SAES PS-22-MGT2500-CDA-S71-220 purifier (209379), (2011), pp. 4-10.
- http://www.saesgetters.com/group/saes-group
- New Entegris 300mm FOUP Improves Yield for Semiconductor Industry, Sep 16, 2002 (BUSINESS WIRE) -- Entegris, Inc.

留言(0)