摘要

中央洗滌塔排水 回收再利用改善空污排放
Keywords / Reclaim City Water (RCW),Central Scrubber4,Acid-Base Gas Mixed Emissions,Ammonia Reduction,Circulation Water Improvement
半導體廠空氣污染物處理設備以中央洗滌塔(Central Scrubber)為主,因製程需求演進導致機台廢氣酸鹼混排問題,而目前先進製程廠區酸性氣體排放管道中,氨氣皆佔有一定排放量比例,而煙囪排放氨氣濃度也間接影響無塵室微污染控制,因此氨氣減量方式除進行來源端源頭減量、污染物分流與現址型洗滌塔配置外,另外提升酸性洗滌塔去除氨氣效率亦可達到污染物減量之目的。提昇酸排洗滌塔效率(SEX)方法有氣液相濃度差及處理設備滯留時間兩大因素,滯留時間方面暨有廠區洗滌塔設置改善已有多位專家於《廠務季刊》中提出討論,因此本篇針對酸性洗滌塔中氣液相污染物濃度差之方向進行探討,藉以洗滌水水質改善提升酸排洗滌塔去除氨氣效率。
前言
空氣污染是由於外來的因素,使乾淨空氣中含有污染物質,致改變原有的空氣組成。另對於空氣污染物的定義了解,可依照我國空氣污染防制法第二條一之說明,指空氣中足以直接或間接妨礙國民健康或生活環境之物質,包含主要污染物及有害污染物,主要污染物分別是二氧化硫、二氧化氮、一氧化碳、臭氧、碳氫化合物及懸浮微粒[1]。
新《空污法》2018/08/01由總統頒布正式上路,並針對2017年6月實施的《空氣品質嚴重惡化管制辦法》將再修訂,加強管制細懸浮微粒(PM2.5)的污染前驅物「氨」,半導體產業將首當其衝。氨(Ammonia,或稱氨氣,分子式為NH3)是無色氣體,有強烈刺激氣味,極易溶於水,於常溫常壓下1單位體積水可溶解700倍體積的氨。半導體廠以洗滌塔為主要空氣污染物處理設備,白煙問題是一般工廠常見的嚴重污染狀況,較常發生於酸鹼混排的管路中,主要因排氣中的酸類易與氨氣反應形成氨鹽微粒,而洗滌塔中過多水氣易與氨鹽微粒結合後形成肉眼可辨識之微小粒子,也就是氣狀污染物衍生之粒狀污染物。要解決酸鹼混排問題,最直接的方法便是將酸鹼混排中的氨氣透過洗滌水pH調整先行溶解於洗滌液中,先將排氣中氨氣成分使用酸性洗滌液中和去除,以減少酸鹼混排所衍生之粒狀污染物並降低廠區氨氣年排放總量,而洗滌塔所產生之洗滌廢水則導入水回收系統,利用回收系統RO逆滲透處理(Reverse Osmosis-RO)程序將含氨污染物濃縮後進入氨氮處理系統(MD)去除氨氮,經由逆滲透處理後水質再經由UV (紫外光)及混床樹酯塔(MB)進行精煉處理後,其產水再次供給洗滌塔,達成水質循環使用與污染物妥善處理之目的。
文獻探討
水質與空污理論
目前半導體業處理無機酸鹼排均以吸收法為主,且其排氣多是低濃度大風量,若濃度過低則處理效率無法有效提升,因此更進一步探討吸收法原理與處理效率改善機制。吸收法可分為物理吸收與化學吸收,物理吸收藉由有害物質在洗滌液中溶解度,液氣兩相接觸後溶解在洗滌液中;化學吸收則是依靠有害物質與洗滌液發生化學反應,形成無害之分子或離子,一般洗滌塔則採用兩種並行方式,以水為洗滌液,並加入氫氧化鈉或硫酸等藥劑加速化學反應。在洗滌塔中,廢氣與洗滌液接觸形式,依照雙膜理論(Two-Film Theory)[2]如 圖1。
圖1、雙膜理論說明[2]
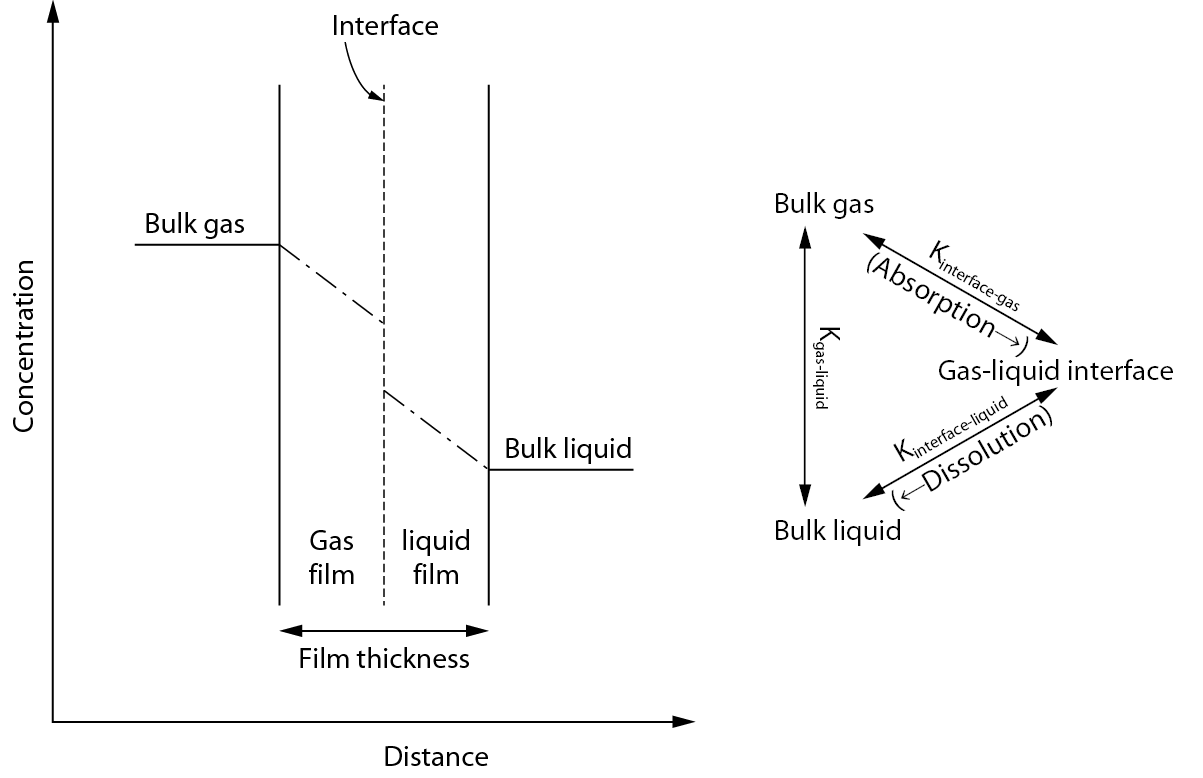
圖1左表示在液氣接觸介面附近之氣體與流體,由於污染物濃度差之關係各自有一濃度梯度,可將包含有濃度梯度的液體與氣體視為接觸的雙膜,在膜的介面處有一不連續驟降之濃度梯度,則此液氣接觸濃度差便是兩相質傳的驅動力。 圖1右表示在液氣介面之溶解平衡常數會趨近於一致。一般將此溶解平衡常數稱為亨利常數(Henry's law constant),其物理意義為氣體中溶質分壓與溶液中溶質平衡濃度的比值,其值愈小,代表該物質水溶性愈好,通常亨利常數需小於0.007才適合以水作為吸收液[2]。
因半導體排氣特性屬於低濃度高風量,在排氣濃度低的的狀態下,循環水水質乾淨程度亦影響處理效率,循環水導電度高狀態下即使控制pH及滯留時間,對空氣污染物的去除效果有限並可能產生氣提現象,依據『利用細微水霧改善傳統填充塔對HCL氣體去除效率』文獻中探討,利用不同導電度水質進行去除氯離子效率測試,導電度與氯離子結果如 表1,當在入口濃度1ppm以上之範圍,0.35、5和10cm/ms三種水質表現是導電度越低的去除效率越佳 圖2,但其間差距約不超過5%,但在小於1ppm則會有較大差距表現,而在入口濃度100ppb時,去除效率的差距可達到20%,而在洗滌水導電度為10ms/cm時,若入口濃度小於40ppb時,則有可能會有氣提(stripping)產生,此時不但無法將污染物去除反而會從洗滌水釋出少量污染物,以上結論可知針對低入口濃度時水質的導電度為主要重點[3]。
|
導電度ms/cm |
0.35 |
2 |
5 |
10 |
|---|---|---|---|---|
|
[Cl-]濃度ppb |
10000~13000 |
49000~53000 |
140000~160000 |
3600000~4200000 |
圖2、填充塔內不同循環水質對HCl去除效率圖(陳開亨;2004)[3]

洗滌塔去除原理概述
在「半導體製造業空氣污染管制及排放標準」[4]中,規定若無法證明酸類排氣排放能達到 表2之排放標準時,則處理設備控制條件需符合以下:
|
空氣污染物 |
排放標準 |
|---|---|
|
揮發性有機物 |
排放削減率應大於90%或工廠總排放量應小於0.6kg/hr |
|
三氯乙烯 |
排放削減率應大於90%或工廠總排放量應小於0.02kg/hr |
|
硝酸、鹽酸、磷酸及氫氟酸 |
各污染物排放削減率應大於95%或各污染物工廠總排放量應小於0.6kg/hr |
|
硫酸 |
排放削減率應大於95%或工廠總排放量應小於0.1kg/hr |
- 洗滌水pH值應大於7
- 潤濕因子應大於0.1m2/hr
- 滯留時間應大於0.5秒
- 填充物比表面積應大於90m2/m3
針對洗滌塔處理效率關鍵因子有「洗滌水pH」、「氣體滯留機會」、「水質導電度與處理效率」以及「污染物濃度與處理效率」。以下分別就四種關鍵因子進行探討[5]。
洗滌水pH
氣態污染物接觸洗滌液時,透過酸為陰離子(anion)帶負電,鹼是陽離子(cation)帶正電之原理,加速污染物吸收速率,即酸性污染物要用pH為鹼性的洗滌液吸收。但單片式酸槽製程酸鹼排氣無法確實分流,造成氨氣排入酸性洗滌塔處理效率不佳之問題。因此可透過洗滌水pH調整提高酸排中氨氣之溶解率如 圖3所示。酸性或鹼性廢氣成分經常是以水當作洗滌液,於氨氣處理方式控制於酸性範圍,可使酸性廢氣中氨分子在吸收至水中解離為NH4+離子。
NH3 + H2O → NH4++ OH-
圖3、洗滌水pH 值對NH3氣體處理效率之影響[6]

氣體滯留機會
氣態污染物要能被洗滌液吸收,必要條件就是要和洗滌液接觸,氣液接觸的方法主要有「慣性衝擊」和「直接截留」兩種 圖4。慣性衝擊是氣態分子因慣性撞擊填充材而產生接觸,路徑越長截留機率越高。直接截留為微粒等效直徑介於慣性衝擊與擴散之間時,由於障礙物表面流體流速接近靜止狀態,微粒經過此區域無法獲得足夠動能而停留在障礙物表面上被收集,此機制主要由微粒直徑與障礙物大小比例決定,微粒直徑愈大,則此機制愈重要。
圖4、氣體污染物滯留方式

洗滌液水質導電度與處理效率
氣態污染物藉氣體與液體的接觸,使氣相中的溶質傳送到液相中。如先前章節所提「雙膜理論」(Two-Film Theory)與亨利常數(Henry's law constant),兩相氣體與流體因污染物濃度差為兩相質傳的驅動力,代表濃度差越大代表位能越大,同理越潔淨的水吸收速率越快。
污染物濃度與處理效率
這可以視為雙膜理論的另一種應用,如 圖5。雖廠務桶槽區污染物濃度高,但經過混合、稀釋進入中央洗滌塔之後濃度下降,間接導致洗滌塔處理效率不佳。進一步解析檢測結果可發現,混合後製程排氣濃度落在100ppb以下的時候,處理效率將低於70%,反觀當前端排放濃度>100ppb以上時,就具有在現址設置濕式洗滌塔進行預處理的價值。
圖5、污染物濃度與處理效率

計畫方法
污染物來源分析
以N28成熟半導體製程廠區進行污染物來源分析,污染物排放總表如 圖6所示,其中排放量最大宗為NH3 22.1噸,共佔總排放之59%,污染物排放分析如 圖7,酸排管道中主要氨氣來自於單片式酸槽製程(Single Wafer),包含STD Clean共43台,NiSix/other Clean共53台,約佔酸排管道中氨氣排放量90%,現已依現場位置需求針對STD Clean機台加裝DAS Salix進行前處理,因單片式製程酸氣與氨氣混合排放進入酸排洗滌塔導致氨氣處理效率不佳,因此透過調整pH與增加換水量進行酸排洗滌塔水質改善以提升去除效率。而主要無機酸排放來源為廠務化學桶槽及廢水桶槽,皆已加裝現址尾氣處理設備進行污染物前置處理。
圖6、排放污染物總表

圖7、排放污染物來源分析
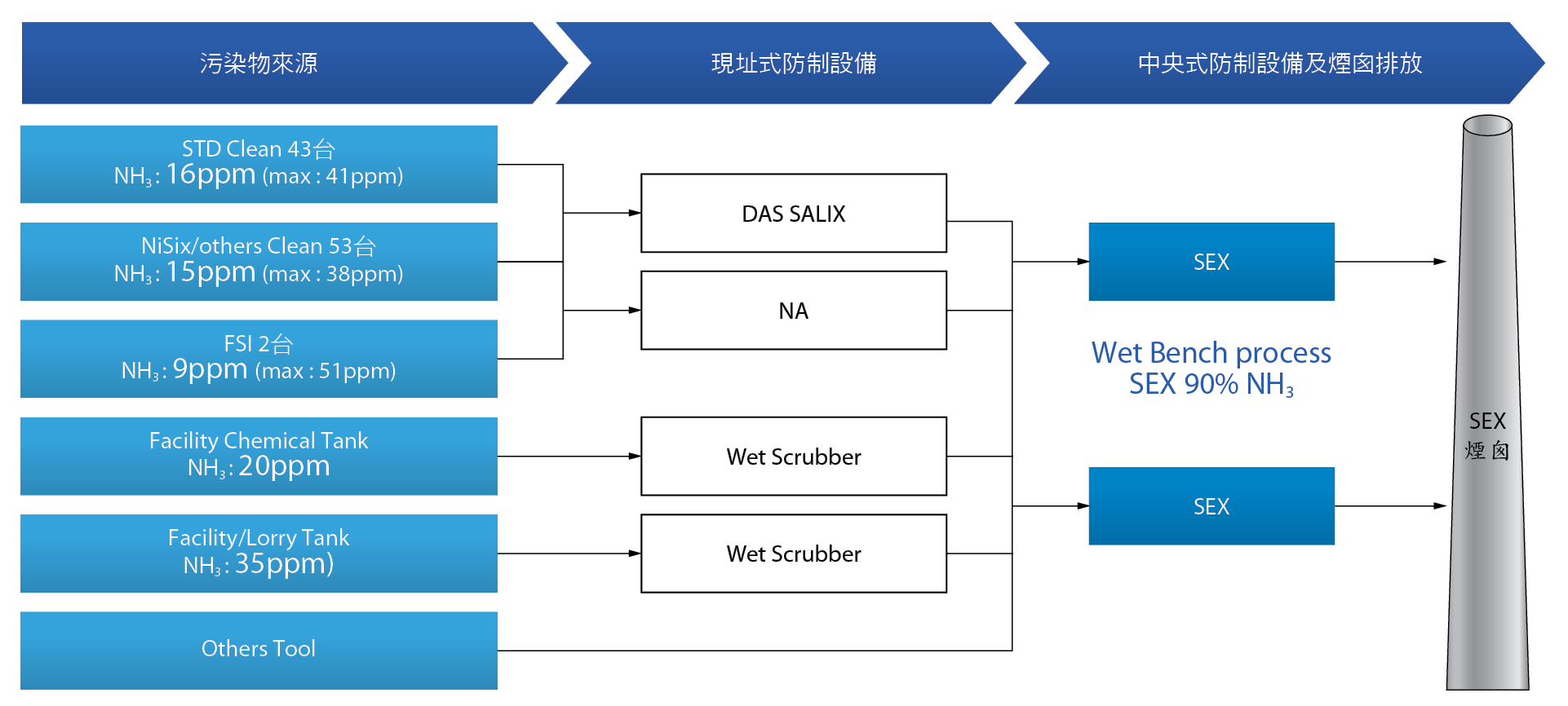
洗滌塔回收水系統架構探討
針對各廠水處理系統標準設計,洗滌塔水質皆由RCW01(Reclaim City Water)所供應,酸/鹼排洗滌塔(SEX/AEX)處理後之廢水各別排放至氫氟酸處理系統(HF system)及氨氮處理系統(MD system),酸排廢水氫氟酸處理系統處理完成後,進入AWD系統進行pH調整後外排,鹼排洗滌塔AEX廢水經由MD system處理後,進入AWD系統進行pH調整後外排。而F15P3/4則是將洗滌塔來源水更改為RCW02,由MAU(Make Air Unit)排水及UPW ROR供應如 圖8所示,F15P3/4 RCW01/02水質差異分析如 表3所示,於空污方面,洗滌塔使用更純淨(低導電度)洗滌水進行廢氣處理,依據上一章節所提雙膜理論(Two-Film Theory),越潔淨的水吸收速率越快並提升洗滌塔去除效率,另於水回收及水污處理方面則是將酸/鹼排洗滌塔排水(SEX/AEX drain),經由AWR/CWR水回收系統,將廢水濃縮後進入氨氮(MD)系統處理,產水則是經由UV(紫外光)及混床樹酯塔(MB)進行精煉處理後,其產水再次供給洗滌塔,達成水質循環使用與污染物妥善處理之目的。
圖8、廠區標準RCW系統供應架構與差異圖
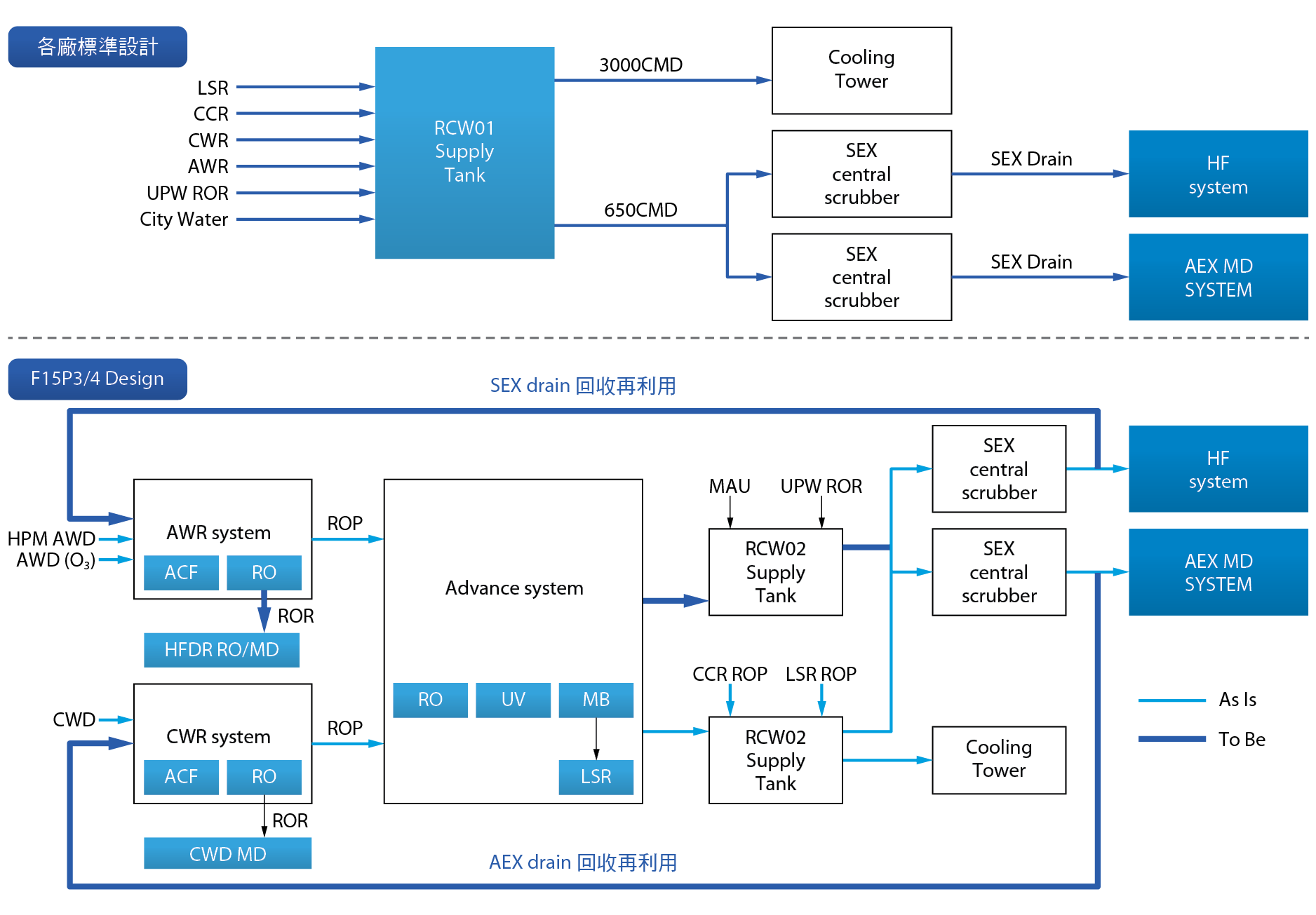
|
F15P34 RCW水質比較 |
cond (µS/cm) |
TOC (ppm) |
pH |
終端用戶 |
|---|---|---|---|---|
|
RCW01 |
<400 |
<3 |
9.0-11.0 |
冷卻水塔 |
|
RCW02 |
<20 |
<0.3 |
6.5-7.5 |
中央洗滌塔 |
結果與分析
如先前章節所提,影響洗滌塔之效率關鍵因子有洗滌水pH、水質導電度、氣體滯留時間及污染物濃度四項因素,其中針對前兩項尋找洗滌水水質改善機會點,擬定策略方針如下:
- 調整洗滌水pH值,當pH由9調降至8,由文獻理論上NH3轉化NH4+由55%提升至85%,代表洗滌水可將氣態中NH3溶解更多至液態中NH4+,提升洗滌塔去除氨氣效率,以降低排煙管道氨氣之排放量。
- 增加洗滌水水量降低導電度,將洗滌塔換水量由650頓/天提升至1000頓/天,依據雙膜理論,使用越乾淨的水將提升氣態中汙染物溶解至液態中。
經由P3/4機械課與水處理課努力不懈合作下,於LB2完成酸排及鹼排洗滌塔排水分別導入AWR及CWR回收系統處理完成後供回洗滌塔重新使用,達成洗滌水水質回收再利用之循環系統,經RCW水質檢驗分析,供應至RF之洗滌水水質導電度由334us/cm提升至5.3us/cm,而提升洗滌塔換水量之循環水檢測導電度由1297us/cm降至343us/cm 表4。經由TLD1酸排管道氨氣量測自檢與第三方九連檢測結果,皆有明顯提升酸排洗滌塔中氨氣去除率,提升洗滌塔補水成效驗證如 表5,九連自檢結果排放量測由9ppm降至5.9ppm提升30%之去除率,換算單台減少排放噸數為1.13噸/年。
|
|
改善前 RCW |
改善後 RCW |
改善前 |
改善後 |
單位 |
|||
|---|---|---|---|---|---|---|---|---|
|
SEX03循環水 |
SEX06循環水 |
SEX03循環水 |
SEX06循環水 |
|||||
|
導電度 |
μS/cm |
334 |
5.3 |
1297 |
310 |
343 |
334 |
μs/cm |
|
NH4+ |
mg/L |
18.5 |
0.69 |
28.4 |
57.5 |
86 |
116 |
ppm(mg/L) |
|
氨氣 |
mg/L |
14 |
0.53 |
22 |
44 |
66.5 |
90 |
ppm(mg/L) |
|
實驗條件 |
待測物 |
檢測值(ppm) |
風量(Nm3/min) |
總量(ton/hr) |
年總量(ton/yr) |
單台削減率 |
|
|---|---|---|---|---|---|---|---|
|
補水量 25 CMD |
P172 |
氨氣 |
9.0 |
1123 |
0.000421642 |
3.69 |
30% |
|
補水量 50 CMD |
P172 |
氨氣 |
5.9 |
1191 |
0.000293147 |
2.57 |
|
|
單台削減量(ton/yr) |
|
|
1.13 |
||||
結論
半導體產業所排放的廢氣濃度雖然屬於低濃度範圍,但是因為風量極大,排放廢氣的處理結果對區域性空氣品質影響相當可觀。這些污染物飄散至大氣中,有可能會轉化成為潔淨室最常擔心的污染物質,隨著各種先進製程的發展,本文探討既有廠區污染源分析,找出空污排放問題後,透過研究及實驗效率驗證,進行洗滌塔水質改善與探討,並針對廢水水質進行回收再利用,冀望達成趨近零排放規劃設計及有價資源循環再利用。而近年來由於全台各地空氣品質指標持續惡化,尤其台中地區,根據環保署空氣品質監測網數據統計,台中市西屯檢測站2018年空氣質量指數(AQI)大於100的天數,也就是達到不健康標準的天數達到71天[7],顯示改善空氣品質之急迫性,藉由洗滌塔水質改善作為,冀望能達到污染減量的目標,改善空氣品質,體現企業社會責任。
參考文獻
- 空氣污染防制專責人員訓練教材-氣狀污染物防制,環訓所,2017
- H.M. Chien et al, “Field enhancement of packed-bed performance for low-concentration acideic and basis waste gases from semiconductor manufacturing process”, Journal of the Air & Waste Management Association 55, pp 647-657, 2005
- 陳開亨,2004,利用微水霧改善傳統填充塔對HCl氣體去除效率之研究,碩士論文,國立交通大學環境工程研究所
- 半導體製造業空氣污染物排放標準
- 空氣污染防制理論與設計,鄭宗岳、林鴻祥編著第五版
- 工研院,簡弘民、吳信賢,低濃度酸鹼廢氣高效率洗滌處理技術,2004
- 行政院環境保護署空氣品質監測網



留言(0)