摘要

鈀(Pd)觸媒於超純水中去除雙氧水以抑制銅腐蝕之應用
Keywords / Copper Corrosion,Palladium-Loaded Monolithic Anion Exchange Resin,Hydrogen Peroxide2
超純水系統因紫外光的照射會導致內含有10~40μg/L的雙氧水,另雙氧水處於超純水酸性環境中會加速銅腐蝕的行為。目前發現藉由鈀觸媒陰離子樹脂(Palladium-loaded monolithic anion exchange resin,Pd-M),可將超純水內的H2O2濃度降至1μg/L,能有效抑制腐蝕行為,並無水質汙染的風險。
前言
二氧化碳超純水是在超純水中添加二氧化碳,讓比阻抗降低至0.025 MΩ.cm的洗淨水,目的是防止因晶片帶電造成對元件的靜電破壞或微粒子附著,早已受到廣泛使用。但在使用二氧化碳超純水進行晶片洗淨的過程中,銅薄膜的腐蝕溶解是常見的問題。Tokuri等人的研究指出,銅薄膜的腐蝕是伴隨著二氧化碳超純水的溶氧濃度而來,而且二氧化碳超純水呈現弱酸性(pH 4.6)更會加速銅薄膜的腐蝕。
本研究的目的為針對二氧化碳超純水中所含之H2O2會對銅薄膜的腐蝕帶來怎樣的影響進行驗證。 圖一顯示為半導體製程所使用之超純水的製造流程。通常為了達到降低有機物(Total Organic Carbon)之目的,會照射波長185nm以下之紫外線於超純水。受到紫外線照射的水會生成OH基(radical),此OH基會氧化分解然後去除有機物,然而一部分的OH基會再結合 (recombination) 生成H2O2。依據實驗,已經知道於超純水中含有約10~40μg/L左右的H2O2,從超純水所製造之二氧化碳超純水也含有H2O2。
圖一、超純水的製造工程圖

本文主要是介紹此新發展的鈀觸媒陰離子樹脂,並藉由此觸媒來去除H2O2的方法。 鈀觸媒陰離子樹脂是把鈀觸媒交換基置入於多孔性的open-celled monolithic結構,並可應用於超純水中H2O2的去除。
鈀觸媒陰離子樹脂簡介
鈀觸媒陰離子樹脂是將鈀觸媒附著於擔體(Monolith)上,此擔體為利用聚苯乙烯(Styrene,St)與二乙烯苯(Divinylbenzene,DVB)的聚合反應,另透過氯甲基化作用(chloromethylation)以及胺化反應(amination)所調製而成之陰離子交換樹脂。
圖二左圖為Monolith的掃描式電子顯微鏡(Scanning Electron Microscope, SEM)照片。Monolith之平均細孔半徑為15μm,全細孔體積(whole pore volume)為3mL/g、比表面積(specific surface area)為13.1m2/g。附著鈀觸媒之Monolith的穿透式電子顯微鏡(Transmission Electron Microscopy:TEM)照片為 圖二右圖。粒徑約50nm的球狀粒子平均地分散佈於表層約1μm處。
圖二、左:Monolith 的掃描式電子顯微鏡照片;右:Pd-M 的穿透式電子顯微鏡照片

鈀觸媒擔體的H2O2去除原理
鈀金屬於去除H2O2反應中僅單純為觸媒功能,可加速H2O2分解。功能類似於活性碳或亞鐵等常用觸媒。但相較其他觸媒物質,鈀金屬的潔淨度佳,反應速率也更快。
化學反應式:H2O2→½ O2+H2O
鈀觸媒擔體的H2O2去除性能
經實驗證明,透過鈀觸媒陰離子樹脂於5,000 h-1的體積流速下,可將40μg/L的H2O2去除至1μg/L以下。
鈀觸媒擔體的不純物分析(Leaching)
超純水中的不純物濃度的要求是越低越好, 表一顯示為以體積流速5000 h-1下鈀觸媒陰離子樹脂之水質檢測結果。每一個分析項目都是偵測極限值以下。
|
分析項目 |
檢測值 |
|---|---|
|
NO2-, Br -, F -, NH4+ |
< 10ng/L |
|
PO43-, NO3-, SO42-, Cl - |
< 1ng/L |
|
Pd |
< 0.5ng/L |
|
Na, K, Ca, Mg, Fe, Cu, Zn, Cd, Ni, Pb, Mn, Al, Co, Cr, Li, Ti |
< 0.1ng/L |
|
SiO2(ionic) |
< 0.1μg/L |
|
Particle |
< 1 count/mL |
|
Total Organic Carbon |
(over 50nm) |
|
佑位元組 |
< 1 μg/L |
銅薄膜的洗淨試驗(Rinse test)
利用濺鍍法將晶片上堆積200nm的銅薄膜,並將晶片送入單晶片機台持續清洗,且紀錄清洗後的銅膜厚改變。
試驗則是採用某公司研發中心內所設置之超純水系統(18.2MΩ・cm), 且含有15μg/L之H2O2。本實驗採二氧化碳超純水持續清洗兩小時,在溶氧值120μg/L下。一股水通過鈀觸媒擔體 (H2O2 < 1μg/L), 一股超純水(H2O2 >= 15μg/L),可見到通過鈀觸媒擔體的超純水銅腐蝕率僅為三分之一。 即使溶氧值高到800μg/L下,低濃度的H2O2超純水之銅腐蝕表現仍較一般超純水為佳,顯見H2O2的濃度與銅腐蝕行為有正相關性,控制超純水中的H2O2濃度確實可抑制銅腐蝕。
為了驗證去除H2O2可以達成抑制銅腐蝕效果,故於二氧化碳超純水中添加H2O2後提供給洗淨試驗使用。結果如 圖三所示,可確認銅腐蝕率是與H2O2濃度呈現正相關性。
圖三、去除CO2 水之H2O2 的效果與其DO 相依性

圖四、H2O2 濃度相依性

銅薄膜的表面觀察銅薄膜的表面觀察
為了清楚知道銅薄膜表面的狀態變化,使用溶氧值130μg/L的二氧化碳超純水進行16小時的洗淨之後,其SEM及SPM (scanning probe microscope) 照片顯示如 圖五。雖然兩者都有產生像孔蝕 (pitting)一樣的腐蝕,但是可以清楚的知道,使用去除H2O2之CO2來進行洗淨的樣品之孔洞的深度比較淺。由此結果也可清楚知道,藉由去除二氧化碳超純水中所含之H2O2可以有效抑制銅薄膜的腐蝕。
圖五、表面狀態(上:SEM 照片; 下:SPM 照片)
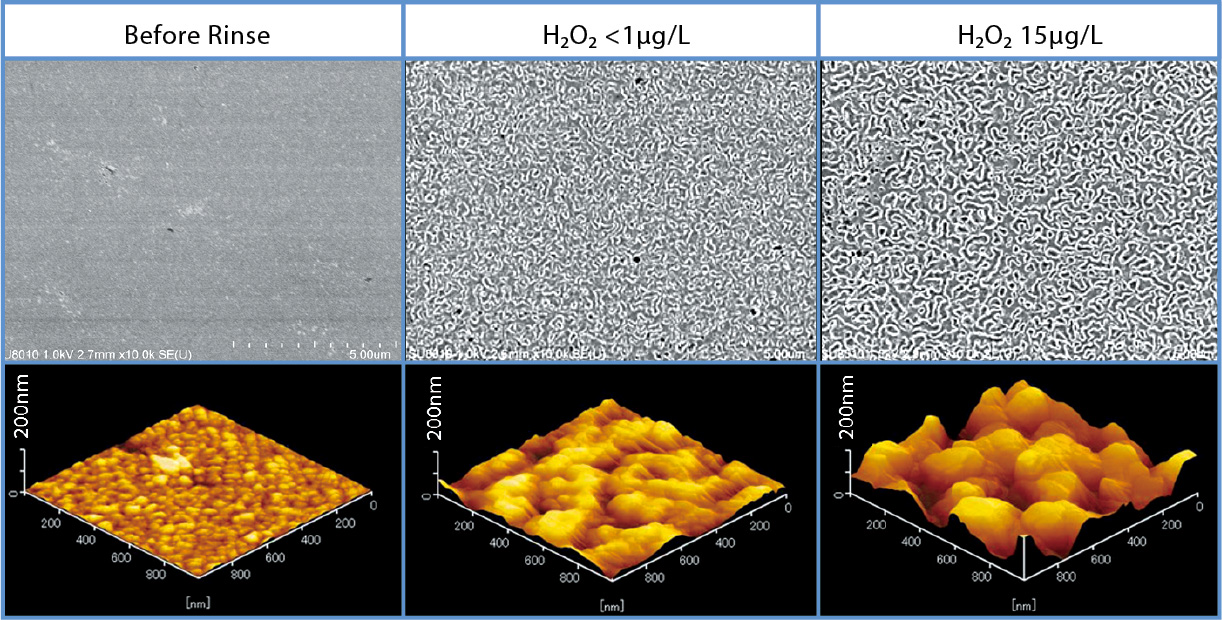
結論
半導體製程中所使用之超純水含有10~40μg/L的H2O2。經實驗證明,透過鈀觸媒陰離子樹脂 (palladium-loaded monolithic anion exchange resin) 可於5,000 h-1的體積流速下, 將40μg/L的H2O2去除至1μg/L以下, 且無汙染水質的問題。可為未來針對銅腐蝕敏感製程之機台端解決方案。
雖然目前已知超純水中的溶氧值會影響銅薄膜的腐蝕行為,但藉由實驗可以發現H2O2濃度與銅腐蝕行為也有高度關聯。
藉由去除H2O2, 可以將銅的腐蝕抑制1/3~1/2左右。
參考文獻
- K. Tokuri, Y. Yamashita, M. Shiohara, N. Oda, S. Kondo, S. Saito, Jpn. J. Appl. Phys., 49, 05FF04 (2010).
- D. M. Pfenning, Ultrapure Water, 17(3), 49 (2000).
- D. M. Pfenning and S. Fisher, Off. Proc. Int. Water Conf. 58th Ann. Meet., 553 (1997).
- H. Inoue, K. Yamanaka, A. Yoshida, T. Aoki, M. Teraguchi and T. Kaneko, Polymer, 45, 3 (2004).
- H. Inoue, H. Takada and M. Murayama, Kobunshi Ronbunshu, 68, 320 (2011).
- S. Yoshizawa, F. Ishihara and T. Yamaguchi, Japan Patent Kokai Hei10-96720 (1998).
- E. Apen, B. R. Rogers and J. A. Sellers, J. Vac. Sci. Technol. A 16, 1227 (1998).
- S. Poulston, P. M. Parlett, P. Stone and M. Bowker, Surf. Interface Anal., 24, 811 (1996).


留言(0)