摘要
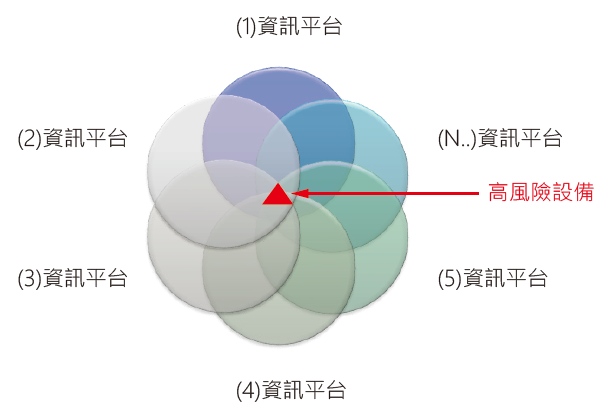
前言
隨著半導體製程技術的演進,潔淨室環境微污染(Airborne Molecular Contamination, AMC)對產品良率的影響也愈趨顯著。因此AMC控制技術將會面臨更嚴峻的挑戰,進而成為高端製程中良率提升的必要手段之一。理論上,AMC控制策略最好由源頭著手,了解污染源並予以消除乃為最佳策略。無塵室AMC污染源可分為:①外氣污染 :包括由廠區煙囪排放至大氣中後,再被MAU吸入之物質(含HCl、H2SO4、HF、VOCs等),以及大氣中環境背景污染值(含NH3、SO2、H2S等);②內部污染:包括製程機台維修保養、溼式清洗台作業之化學品逸散,人員違反化學品使用規範所造成的洩漏污染等,甚至為無塵室內建材或各類器材的釋氣(Outgassing) [1]。
目前台積電廠區內針對AMC控制策略大致分為:儀器即時監測、定期採樣分析、人員巡檢稽核、化學濾網安裝等。然而,這些防禦機制並無法提供整合性的資訊,當現場發生污染狀況時,僅能個別查詢及澄清污染相關資訊,不僅耗費人力時間,也無法第一時間找到污染源並進行防堵,造成晶圓受污染時間增加,影響製程可靠度。因此,針對廠區AMC防禦提升,本文將提出AMC即時顯示污染源定位追踪平台概念,目標為藉由結合AMC監測、人員巡檢與濾網資訊,並搭配廠區機台平面圖和機台維修&使用有機化學清潔品等資訊,可於偵測到污染物時直接呈現該區即時污染之關聯性,縮短污染處理時間,有效降低AMC造成晶圓污染之風險。
文獻探討
2.1.微污染之分類
根據國際半導體暨材料協會(Semiconductor Equip-ment and Materials International, SEMI)發佈的SEMI F21-95及F21-1102文件,將AMC分為4大類,分別為:① 酸性物質(Acids, MA):腐蝕性物質,具電子接收者的反應特性,如HF、H2SO4、HCl、HNO3、H3PO4、HBO3等 ;②鹼性物質(Bases, MB):腐蝕性物質,具電子提供者的反應特性,如NH3、TMAH、TMA、NMP等;③凝結物(Condensables, MC):除水之外的物質,在大氣壓力下沸點大於室溫,有凝結於表面能力者,如IPA、Acetone、 Glycol、Ethanol、Silicone、Hydrocarbon等;④摻雜物(Dopants, MD):可改變半導體材料電性的化學物質,如AsH3、B2H6、BF3等 [2] ,如 圖1所示。
圖1、AMC污染源分類表

2.2.微污染之影響
無塵室內製程繁複,其中以微影(lithography)、閘極(gate)及接觸層(contact layer)等製程對微污染具高敏感度 ,高濃度AMC可能造成產品良率。AMC所造成的影響包括 :①MA類 : 酸性AMC會造成晶圓或器材設備腐蝕,導致蝕刻速度改變、金屬線性破壞或是光學鏡頭霧化;②MB類 : 環境中若有高濃度鹼性AMC時,其會與微影製程中光阻劑內的光酸發生中和反應,導致晶圓或光罩表面產生鹽類微粒,造成圖像轉移時的缺陷,一般稱為「T-Topping」現象;③MC類 : 污染會晶圓表面Si-N膜轉變為Si-O,而導致晶圓膜厚及純度降低,或是改變介電質的特性而影響潰電壓,造成接觸電阻的改變;④MD類 : 環境中摻雜物若吸附在晶圓表面後,透過熱製程擴散至底部,可能造成產品電性飄移,或是摻雜參數改變導致元件失效及良率下降 [3] 。
2.3.污染物之控制策略與措施
無塵室所遭遇AMC問題,以例常性檢測並掌握污染物種類之特性與其發生原因,才能規劃出後續具體之防治措施。而在AMC防治控制上,約略可分為三方向進行 : ①污染源監測控制(monitor);②污染源隔離技術(SMIF、FOUP 、mini-environment);③污染源去除(chemical filter、air washer) [4]。
污染源監測控制即是在污染源發生之前,先對無塵室內可能釋出污染源加以控制,由於不同之無塵室、其污染成因可能不同,因此藉由製程上使用之化學品調查、場內各材質之釋氣調查與廠外周界之污染監測調查,將可在污染發生時迅速掌握污染來源與其發生原因。
污染源隔離技術是利用潔淨度高之區域環境(mini- environment)或是用內充氮氣之晶圓儲存閘系統,將晶圓與高污染環境進行隔離之動作,使晶圓在超潔淨環境中。 FOUP相關技術開發與精進目前仍在持續進行中(包含材質 、水氣控制、內充氮氣濃度與均勻度等),目的為減少外界AMC污染影響。
污染物去除控制通常用在外氣空調系統、廠內FFU循環系統或是製程機台內部加裝化學濾網(chemical filter)來過濾去除各類AMC污染物。化學濾網的裝置必須考慮處理之AMC濃度範圍,否則污染物之去除效率或化學濾網之壽命難以掌握。學者亦發展污染氣體控制系統-溼式氣體洗滌系統(air washer),利用氣-液相接觸傳輸作用來去除氣態分子污染物 [5]。
研究方法
各廠目前皆有AMC監測系統,當online/offline採值高時,雖可快速得知影響區域及位置,但卻無法立即得知是哪個機台發生異常,導致無法立即將污染源移除或抑制,造成污染源長時間曝露於環境中。因此本文將以污染源即時監測控制為主要研究方向,藉由現行無塵室機台監控/紀錄系統提出系統整合概念,找出高風險設備群以減少污染源查詢時間,如 圖2所示。
圖2、AMC污染源即時顯示概念說明
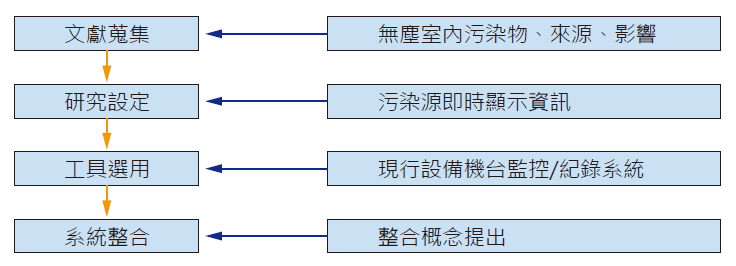
3.1.化學品供應狀態
設備機台化學品使用來源約略可分為兩類,其一為中央供應化學物料;其二為人為瓶酸替換。故在機台使用化學品查詢上,將以此二方向去查詢,近而可明確得知各機台使用的化學品清單,亦可明確得知污染源設備清單。
- 對於中央chemical供應系統,目前已有bluebook系統可查詢。系統操作步驟如下:①下拉式選單選定廠區 ②選擇utility to Tool點選欲查詢之種類 ③按下搜尋後即可查詢設備編號、設備單位、化學品種類等資訊,如 圖3所示。
圖3、Bluebook設備化學品使用設備清單查詢步驟

- 瓶酸領料系統已有平台可查詢。系統操作步驟如下:① 選用單位用量日報 ②顯示瓶酸領用時間/種類/領用人/用量等資訊,如 圖4所示。
圖4、小瓶酸系統使用設備清單查詢步驟

3.2.設備機況狀態查詢
設備機況掌握是AMC防治相當重要的因子,許多AMC異常案例常與設備T/S(trouble shooting)或PM(Preventive maintenance)後未恢復原始狀態有關,故在機況查詢上亦須考量。系統操作步驟如下 : ①進入系統選擇report ②選擇search report進入系統查詢 ③搜尋欲查詢機台區域及名稱,選擇欲查詢時間,點選Status History ④得知選擇時間內之機台機況,如 圖5所示。
圖5、SiView設備機台機況查詢步驟

結果與分析
在尚未將資訊平台整合時,可用區域自檢方式圈選出高污染設備。以F3E FAB,MD類採樣點為例,使用化學品供應狀態平台系統,確認各區域內污染源設備,其主要污染源設備使用化學品為PH3/BF3/BCl3,如 圖6所示;針對小瓶酸系統及設備機況狀態系統,做設備狀態點警報機制 ;當設備狀態轉為PM狀態時,或是設備小瓶酸領用時,可自動發送簡訊至值班手機,值班人員收到警報後可立即至現場確認設備使用狀態,避免異常使用造成大範圍污染情況,如 圖7所示。
圖6、F3E FAB MD類污染源設備分佈。(a)Diff區;(b)IMP區;(c)MEMS區;(d)Etch區

圖7、資訊平台整合概念
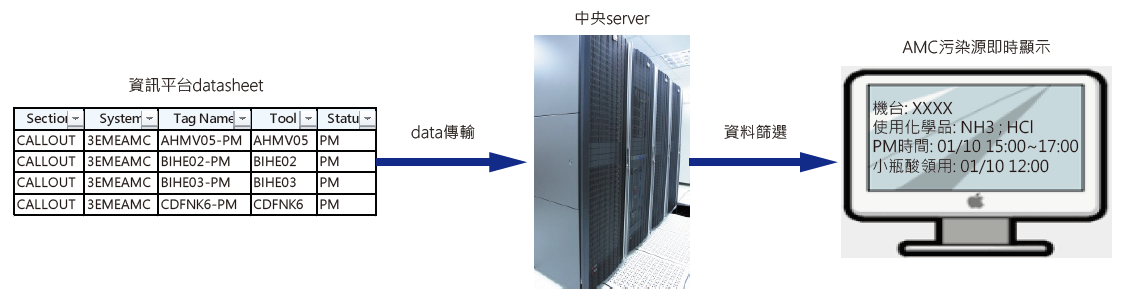
設備資訊系統平台整合可分三步驟執行。首先需將各平台權限開啟,使資訊平台內datasheet資料能做傳輸動作 ;data由資訊平台傳送中央電腦後,接著中央電腦將得到的資訊過濾(篩選所需資訊,如PM狀態、領料紀錄等),接著將資訊顯示於查詢平台介面,使用者能依時間/區域等選項找出交集度高的設備群,並可針對此高風險設備群立即做檢視查漏,如 圖7所示。如設備資訊平台整合數越多,將越能找到變異性設備清單,對於AMC防治而言會是一大利器,如 圖8所示。
圖8、整合多套設備資訊系統平台,交集得到高風險設備清單
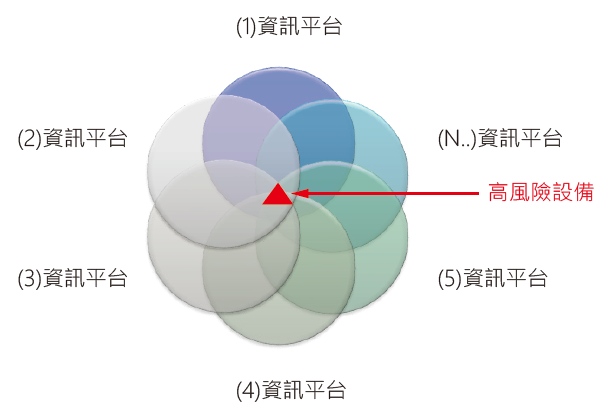
結論
現行設備資訊查詢平台已各自發展齊全,但尚缺平台整合概念,導致AMC異常事件發生時,需至各系統查詢機台資訊,費時費力且需靠人為逐一確認;如能將設備資訊整合,以區域作分類,直接顯示區域內設備變異機台,將高污染源、異常機況等資訊交集出高風險設備清單,將有效降低AMC Trouble shooting時間,對於AMC防治會是快速、通用、準確性的平台整合概念,如 圖6所示。
參考文獻
- The removal of airborne molecular contamination in cleanroom using PTFE and chemical filters, Yeh, CF,Hsiao, CW,Lin, SJ,Hsieh, CM,Kusumi, T,Aomi, H,Kaneko, H,Dai, BT,Tsai, MS, 2004.
- SEMI F21-1102 classification of airborne molecular contami nation levels in clean environmentals. Semiconductor Equipment and Materials International. 2001.
- Organic Airborne Molecular Contamination in Semiconduc tor Fabrication Clean Rooms, Walter Den,a,z Hsunling Bai,b and Yuhao Kangb,2006.
- Airborne Molecular Contamination : Formation, Impact, Measurement and Removal of Nitrous Acid (HNO2) Jürgen M.Lobert, Reena Srivastava, and Frank Belanger – AMC Business Unit, Entegris, Inc.
- John K. Higley and Michael A. Joffe,〝Airborne Molecular C ontamination : Cleanroom Control Strategies〞,Solid State Technology, pp. 211, July 1996.


留言(0)