摘要

半導體先進製程_CMP化學機械研磨,所使用之Slurry 研磨液品質與CMP defects 息息相關,如何適當地分析研磨液品質更顯得重要。研磨液其組成除了包含研磨粒子之外,還包括一些少量且不同功能的化學品,例如: Passivation agents/Oxidizers/Inhibitors/Dispersants/Chelating agent/Surfactants/pH buffer,目前在既有SDS(Slurry Dispense System)安裝之線上分析儀,不外乎酸鹼性pH計/ 比重計/ 導電度計/ 雙氧水分析儀器,這些既有的分析儀器,無法完全的表現出研磨液的輸送品質,本研究利用光學與電化學的原理去呈現研磨液的Pattern「圖案」,將分析儀器安裝於SDS,收集與建立符合運轉需求的baseline,以達到研磨液品質預警pre-alert機制。
Semiconductor Advanced Process_CMP Chemical Mechanical Polishing. The quality of the slurry is highly correlated with CMP defects, which indicates the importance of quantifying slurry quality for controlling CMP defects. In addition, the composition of the slurry also includes some complex chemicals, such as Passivation agents/Oxidizers/Inhibitors/Dispersants/Chelating agent/Surfactants/pH buffer. Currently, online meters in SDS(Slurry Dispense System), such as acid-base pH meters/specific gravity meters/conductivity meters/ hydrogen peroxide titrators cannot fully reflect the quality of the slurry delivering in SDS. Therefore, this study proposes two analytical instruments based on optical and electrochemical principles to quantify the unique "pattern" of the slurry, and also applying the instruments into a real case to investigate its suitability for slurry. In addition, instruments are installed in the SDS to establish operation baseline, in order to provide a pre-alert mechanism for better control the CMP defects.
1.前言
半導體製程越來越精細,對化學品研磨液(Slurry)中的微小變化容忍度更為嚴苛,在平常的運轉中,化學品研磨液供應系統SDS(Slurry Dispense System)為使研磨液與微粒隨時處於均勻混合的狀態,slurry會在桶槽與管線中不斷循環,但過程中研磨微粒(Abrasive),會受到剪應力的作用碰撞進而造成質變(聚集)。此外,大部分的研磨液會經由SDS進行稀釋/混合再供應,其中有些研磨液需要預先養酸(aging),讓化學成分反應一段時間後才能供應,因此檢測與化學性研磨速率有關的化學成分濃度變化將顯得更加重要。鑒於slurry中微粒/化學成分的變化,目前沒有合適的線上檢測方法能夠分辨出其中差異,僅能依據經驗值或由已發生產品缺陷(defect)的結果來改善運轉參數。
本文提出兩台分析儀: 化學品 Pot Life分析儀 (CPL)、化學品純度分析儀(CPA),分別針對slurry中的研磨微粒成分/化學成分進行檢測。CPL以藍光廷德爾效應(Tyndall effect)的原理發展,因為不同大小的粒子擁有不同的光散射特徵,藉由分析特徵的差異,就像標靶一樣可以專注在分析研磨微粒成分變化。CPA是透過電容/電阻量測的原理加以發展,因為化學品中的離子/分子都有其獨特的遷移率和響應行為,藉由改變測試頻率可以將化學品中離子/分子特性顯現出來,進而針對與化學研磨速率有關的化學成分進行分析。最重要的是,透過科學化的方式將slurry中的研磨微粒/化學成分變化進行量化(可視化),不僅可以提前預警原物料品質變異,還可避免CMP(Chemical-Mechanical Polishing)的研磨速率(Remove Rate, RR)跳脫規格或發生晶圓刮傷(Scratch, SC)的事件。此外,在Mega/ Giga FAB因產量需求要不斷的挑戰生產極限,若沒有原物料品質的量化數值作為參考依據,將要透過大量的Trail & Error才能找到可行的製程參數,這可能會造成額外的生產成本。
2.文獻探討
本研究針對廠區遇到的問題進行回顧,並比較現有儀器的適用性。
2.1 化學品研磨液新鮮度對於生產的影響
廠務透過SDS 輸送固定運轉參數(Recipe)的研磨液,然而研磨液在管線輸送/循環中不斷碰撞,造成研磨微粒聚集變大,導致研磨液變得不新鮮,這會在晶圓上造成刮傷,然而,線上目前卻沒有合適的方法可以將研磨液新鮮度差異檢出,僅透過已發生的產品缺陷(defect),作為微調運轉參數的依據。如圖1,使用固定的運轉參數但是線上defect(微刮傷,u-SC)偶爾還是會超出CMP訂定的規格,這是因為研磨液新鮮度並不是一個定值,因此需要發展線上檢測研磨液新鮮度的指標,進而更好的掌控生產良率。
圖1:Slurry PL9102 wafer data的時間關係圖
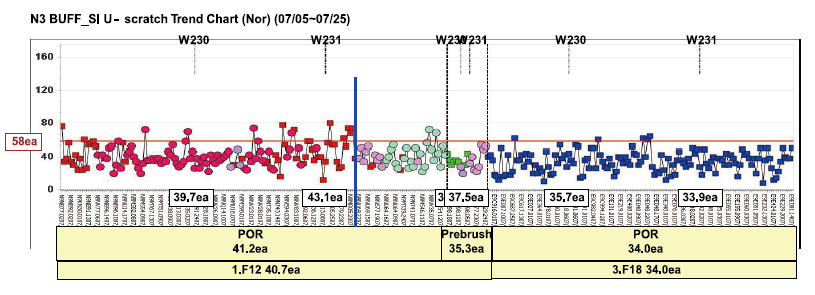
如表1,現有的offline分析儀器與CPL,發展成線上分析儀的適用性比較表,雖然現有的offline的儀器,可以分析出非常詳細的資訊(如: 粒徑分布、粒徑濃度等)。然而,要給出這些詳細數值之前,通常需要花費大量時間/蒐集大量數據才能夠給出準確的統計結果,此外,為了固定量測範圍還需要對樣品進行稀釋,這可能會導致樣品已經失去了與線上原物料的相關性,因此對於分析化學品研磨液新鮮度(Slurry pot life)的樣品來說不合適。然而,CPL的相對檢測的方式,簡單來說,只看當下的樣品跟上一個樣品之間的訊號差異,如此可以達到快速分析,才能為線上做最即時的預防。就像麵包,不用去檢測出所有的成分(像是: 防腐劑、麵粉、糖)有沒有改變,我們只要用眼睛看或用鼻子聞,跟原來的有無異同,就可決定要不要吃下肚。
| 廠商 | Malvern | Horiba | Entegris (LPC) | tsmc (CPL) |
|---|---|---|---|---|
| 型號 | Nano ZS (ZEN3600) | LA-950V2 | FX/FX Nano | CPL-1000 |
| 技術 |
|
Laser Diffraction | Single Particle Optical sensing (SPOS) |
Laser Diffraction (Bulk phenomenon) |
| 測量資訊 |
|
PA size | PA size PA concentration |
PA aggregation |
| 粒徑測量範圍 | 0.3 nm ~ 10 um | 10 nm ~ 5000 um | 150 nm ~ 150 um | 45 nm ~ 1 um |
| 量測SLY聚集的缺點 | 需要時間來觀測粒子的運動行為(布朗運動)統計要準確,數據就要多,數據多就花時間,這對於分析pot life issue的樣品來說不合適。 | 稀釋可能使原本聚合的研磨粒分開,與線上使用的研磨液狀態失去相關性。 | - | |
| 為何這樣選擇? | - | - | - | 使用與業界相近的雷射波長範圍,且藍光對於小尺寸的PA有更好的識別性。 |
2.2 化學品純度對於生產的影響
廠務同仁在換Drum前發現原物料顏色異常,有幸此事件是肉眼可分辨,沒有造成線上停機斷線,後來釐清是原物料中的成分四「乙基」氫氧化銨變質導致,變質前是透明無色,變質後則呈現黃色(圖2),令人更害怕的是,若原物料的變化是肉眼不可分辨的呢? 真的注入SDS系統後,有哪些方法可以控管品質呢?
圖2:Slurry 5910 不同批號樣品的顏色差異圖

如表2,整理了現有的offline分析儀器與CPA,發展成線上分析儀的適用性比較表,可以發現電感耦合電漿體質譜法(ICP-MS)雖然適用於分析此案例,但若要發展成線上分析儀將會面臨難以普及的問題,因其系統需要額外搭建無塵室空間,機台價格昂貴。此外,如自動滴定氧化還原系統(ATRS)僅能針對研磨液中的雙氧水成分濃度進行分析。而導電度計則是解析度不靈敏。令人振奮的是,CPA不用無塵室空間、機台價格便宜,不僅大幅降低普及化的成本外,CPA還有一個特點是只要透過改變測試參數「頻率」,就可以將化學品中特有的離子/分子成分凸顯出來,進而可以檢測出化學品中不同成分的濃度變化來管控品質。
| 廠商 | Agilent | Entegris | Rosemount | tsmc (CPA) |
|---|---|---|---|---|
| 型號 | 8900 ICP-MS | APM200 | 226 | CPA-1000 |
| 技術 | Mass Spectrometry | Redox Titration | Ohm’s Law | Parallel-plate capacitor method |
| 測量資訊 | (金屬)陽離子元素濃度 | H2O2 concentration pH |
導電度 | 電容/電阻值 |
| 量測極限 | 0.1~5 ppt | 0.1% | ± 5μS/cm | 1 ppb |
| 缺點 | 對於背景值要求嚴苛、同質量元素及複合離子的干擾問題 | Bubble、硫酸廢液排放 | 解析度逐漸無法滿足先進製程的對於原物料差異性的需求 | - |
| 為何這樣選擇? | - | - | - | 根據化學品中的離子/分子其獨特的遷移率和響應行為,透過電容變頻的方式將其現形出來 |
3.分析儀原理介紹
3.1 化學品Pot Life分析儀 (CPL)
化學品Pot Life 分析儀(CPL)的原理(圖3)是採用檢測膠體溶液固體粒子的廷得耳效應(Tyndall effect)[1] : 在光的傳播過程中,光線照射到粒子時,如果粒子大於入射光波長很多倍,則發生光的反射;如果粒子小於入射光波長,則發生光的散射,這時觀察到的光波環繞微粒而向其四周放射的光,稱為散射光或乳光,廷得耳效應就是光的散射現象或乳光現象。CMP研磨液中的研磨粒子會於輸送過程中因剪應力、pH & Zeta電位的改變,而聚集變成大顆粒的粒子,易造成CMP製程對晶圓表面的刮痕,觀察CPL的光學反應即可監測CMP研磨液中研磨粒子的尺寸變化,可用來確保CMP研磨液的品質,維持CMP製程的良率。
圖3:CPL原理示意圖
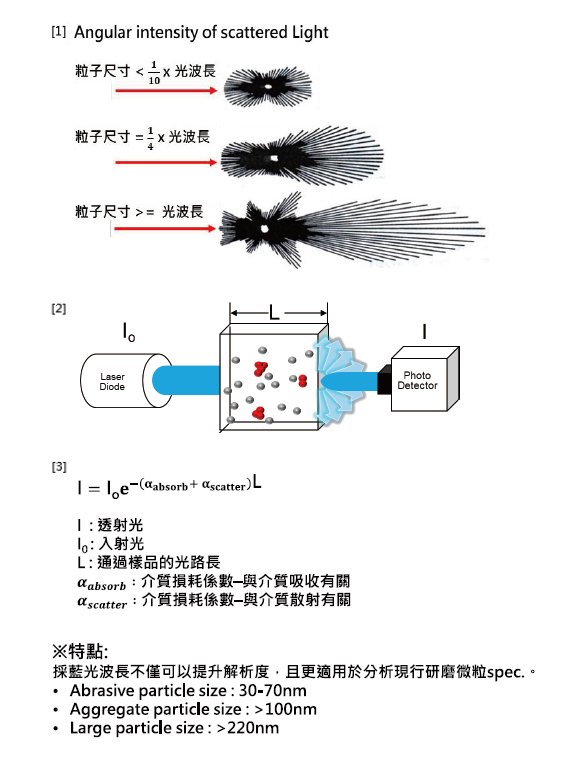
3.2 化學品純度分析儀 (CPA)
化學品(液態)純度分析儀 (CPA)的原理(圖4)是利用固定容積的液體中離子與極性分子隨著被施加頻率改變,液體的電容(或介電系數)與阻抗(或電阻率)會有不同的響應[2],而介電系數與電阻率都是物質的特徵值,如不同物質有不同的密度,此種量測方式能檢測液體的特性與純度,利用CPA可監測液態化學品在生產過程中的特性或純度變化,以確保生產的品質與良率。
圖4:CPA原理示意圖

4.案例探討
4.1 化學品Pot Life分析儀 (CPL)
4.1.1 化學研磨液pot life
研磨液在SDS進行稀釋/混合再供應,在供應過程中會持續循環研磨液,為保持研磨微粒的均勻性,然而研磨微粒在管線中循環時碰撞可能造成聚集,以往是根據經驗值或藉由已造成的損失(如: wafer defect)來微調並定期的排放,但透過經驗值(時間)來定義化學研磨液pot life並不是很好的辦法,因為當研磨液提早變質,繼續使用會造成額外的損失,而當研磨液可以繼續使用,卻提早排放掉,無形中也提高生產的成本,因此,若能以科學的方式將化學研磨液pot life量化成數值,將能更完全的呈現當下輸送的原物料品質,做最恰當的處理方式,進而優化生產的效能,本文針對N3 CMP Slurry PL6122進行為期3個月的offline取樣測試,嘗試找出化學研磨液pot life與線上製程表現關聯性。由測試結果發現,測得化學研磨液pot life(光強度)與wafer data(deep-scratch)具有相同之趨勢之外,還有高關聯性R2=0.5(圖5、圖6)。此量化數值能作為及時預警(pre-alert)系統,避免不符合需求的化學研磨液pot life被使用,進而提升良率的,也降低潛在的生產成本。
圖5:Slurry PL6122 wafer data 與CPL量化光強度的時間關係圖

圖6:Slurry PL6122 wafer data 與CPL量化光強度的相關性圖

4.1.2 濾網過濾時間pot life
CMP tool跟SDS要酸前,SDS的混酸槽(mixing tank)會先進行混酸過濾,但目前線上沒有儀器可針對過濾效果進行檢測,故本文針對N2 CMP Slurry CSL9535C mixing tank 循環過濾的差異來進行分析。將過濾時間與光強度作圖,如圖7,發現經過8分鐘的過濾,檢測光強度上升,這是由於大顆粒子/聚集的研磨粒子被濾除。經過15分鐘的過濾,發現檢測光強度下降,推測是循環時的流體剪應力造成研磨粒子再次聚集導致。將此結果與Wafer data(deep-scratch)進行比較,如圖8所示,線上使用過濾15分鐘的研磨液,deep-scratch會比過濾10分鐘還要差。總結來說,透過CPL量測的化學研磨液品質,可以間接量化出濾網過濾效能,也可以找到最佳化的運轉參數(如:過濾時間)。
圖7:Slurry CSL9535C mixing tank過濾時間與CPL量化光強度的關係圖

圖8:Slurry CSL9535C mixing tank過濾時間與wafer data時間關係圖

4.1.3 過濾器壽命pot life
過濾器(filter)使用一段時間後,被攔截在filter上的粒子(濾渣)會堆積形成濾餅(filter cake),進而造成filter壓損上升,也就是說,更大的壓力將會作用在filter cake上,更容易使濾餅上的粒子被沖脫釋放出來,進而導致研磨液品質變得不好。因此,若能量化過濾器的壽命(filter lifetime),不僅可避免線上使用到品質變差的研磨液,也可以提供filter lifetime的量化數值作為更換過濾器的依據。故本文針對N3 CMP slurry F6A 的研磨液品質來間接評估過濾器壽命。由測試結果發現隨過濾器使用時間增加(day1~day3),光強度上升,這是因為濾渣的堆積使過濾器平均孔徑縮小,可過濾更小尺寸的粒子。然而,時間推進(day4~day7),光強度轉而下降,這是因為濾餅所造成的壓損已變得不可忽視,濾餅上的粒子也更容易被巨大的壓力沖脫出來,從圖9可以看到濾效在第3天發生轉折且有下降趨勢,且測得的研磨液品質第6天與第1天差不多,代表研磨液可以繼續使用。需注意的是,第7天的研磨液品質較第6天與第1天差,因此不建議將filter lifetime設定為7天。將此結果與Wafer data(deep-scratch)進行比較,如圖10所示,線上使用7天filter lifetime的過濾器提供的研磨液,deep-scratch比6天filter lifetime差,結果一致。
圖9:Slurry F6A filter lifetime與CPL量化光強度的關係圖

圖10:Slurry F6A filter lifetime與wafer data時間關係圖

4.2 化學品純度分析儀 (CPA)
4.2.1 化學品純度 vs. Remove Rate (RR)
Copper(Cu) CMP slurry 是CMP製程中配方最複雜的研磨液,晶圓表面的銅接觸到研磨液就會被腐蝕,若CMP中Cu的腐蝕速率太快就容易造成 dishing/Erosion[3]的問題,所以在Cu slurry中,含有鰲合劑(鰲合游離出來的銅離子,避免再次沉積回去),以及腐蝕抑制劑(避免Cu過度被腐蝕),故Cu CMP中chemicals的純度變化對於研磨速率(Remove Rate, RR)顯得特別重要。故針對N3 Cu CMP slurry F6A透過CPA將研磨液中chemical的純度數值化並與研磨速率(RR)做相關性分析,如圖11所示,測得電容值(chemical純度變化)與RR成正比之外,還具有高相關性R2=0.92。
圖11:Slurry F6A Remove Rate與CPA量化電容值的相關性圖

4.2.2 化學品純度 vs. ESDTHK
CMP發現N3 CMP slurry MSL5225C的ESDTHK與研磨液中的成分chem6 & chem9有關,經Pi-run驗證後鎖定是由不同批號的原物料差異造成,但線上目前無可分析其中差異的儀器,僅靠不斷Pi-run新批號與指定批號的原物料來控制ESDTHK高低,來因應CMP的需求,這將導致潛在的斷料、斷線風險與人力調度問題。故利用CPA對此劑研磨液的chemicals純度進行數值化,並與廠商提供的CoA中 chem6 & chem 9成分濃度進行比較。如圖12,發現測試頻率為1kHz時,測得電容值(純度變化) 與 CoA上的chem 9趨勢一致R2=0.98;測試頻率為100kHz時,測得電容值(純度變化) 與CoA上的chem 6趨勢一致R2=0.93,這代表廠務可利用CPA來控管廠商提供的原物料品質外,也可檢驗儲放廠內的原物料是否放久變質。此外,為了證明CPA檢測的chemical純度數值是與wafer data相關的,本文也針對此劑研磨液在F12P8進行為期1個月的online測試。如圖13,發現測得電容值(純度變化) 與wafer data不僅具有相同之趨勢,還有高關聯性 R2=0.55;透過科學方法量化出來的數值,不僅可以快速的找到最佳的運轉參數(挑對原物料批號),更可以做為提早預警(pre-alert)的指標,降低潛在的生產成本。
圖12:Slurry MSL5225C 不同批號的CoA數值與CPA量化電容值關係圖

圖13:Slurry MSL5225C wafer data與CPA量化電容值關係圖

5.結論
隨半導體製程越來越精細,研磨液的組成因應製程的需求,不斷的添加多種化學品,但伴隨而來的是更加複雜的變化,廠務利用研磨液供應系統SDS(Slurry Dispense System) 輸送不同類型的研磨液,透過稀釋不同的比例與攪拌時間,以符合CMP的需求,然而研磨液在管線中不斷的循環碰撞,造成研磨液的變化(老化/質變),以往是根據經驗值或藉由已造成的晶圓缺陷來微調並定期的排放,但透過經驗值(時間)來定義化學研磨液pot life並不是很好的辦法,因為當研磨液提早變質,繼續使用會造成額外的損失,而當研磨液可以繼續使用,卻提早排放掉,無形中也提高生產的成本。因此本研究提出可以快速全面性分析且可以線上應用的方法: 利用光學與電化學的原理,針對研磨液中的研磨粒與化學品純度的成分進行分析,並透過實際的案例說明將研磨液品質以科學的方式量化成數值後,可以幫助研磨液品質更加穩定和可控,也提供給operation參考依據來做及時調整保持產品品質的一致性,還可以延伸應用(Filtration time、Filter lifetime)來最佳化運轉參數,而不需花費大量時間與生產成本進行pi-run。
參考文獻
- Sourav Bhattacharjee., Journal of Controlled Release(2016).
- T. N. Tran et al., Phys. Chem. Liq(2019).
- Carl., 5大關鍵指標判斷CMP表現。https://carl5202002.pixnet.net/blog/post/312432396-cmp-performance


留言(0)