摘要

前言
隨著科技進步,5G及人工智慧的時代已經來臨,對於運算晶片的需求及效能也呈幾何式的增長,高階製程的重要性也越發凸顯,為了減少無塵室環境對產品良率的影響 ,高階製程中針對AMC問題進行有效減量與管制也越發被重視[1]。
在現行半導體製程中,wet clean為晶片清洗的必要製程之一,但也伴隨大量MA、MB及MC污染,在wet clean製程中CWR區域更是應用大量IPA進行清潔[2][3][4],造成CWR區域環境IPA濃度偏高,在本廠中AMC高敏感區ECP更是與CWR緊鄰相接,現行IPA污染主要靠AMC filter進行處理[5],然而實務經驗上現行AMC filter針對Acetone及IPA的去除是最為困難的,造成ECP區域的IPA濃度更是面臨嚴峻的挑戰。
為了迎接如此嚴峻的挑戰,針對CWR區域的防守戰也因此如火如荼的展開,本研究參考來自負壓病房的案例,期望可將CWR的IPA污染隔離,避免CWR區域的IPA影響到其他區域,建立起完善的CWR機台IPA逸散減量與區域防禦機制。
文獻探討
負壓病房建立方法與應用
負壓病房於現今的醫療中廣泛使用,不管是2002年SARS事件乃至2020年新冠肺炎的事件,負壓病房的存在提高良好的病源隔絕以及大量提高疫情控制的效果 。負壓病房目的為控制具感染性之病原體於固定空間內,避免造成外界感染,現今在設計負壓病房尚有諸多規範,包含:風口位置、負壓大小、換氣頻率、氣密程度[6],在本次研究中,借鑒此種污染封鎖的概念,將CWR區域IPA視作病原體,建立「類」負壓病房將污染物隔絕,參考其建立規範,本研究也著手將其引進無塵室內:
A、氣密程度
負壓病房的建立中,門縫及隔間的氣密程度皆與負壓的建立有密切關係,縫隙皆必須小於一定值才能達到足夠的負壓,在無塵室實務中,無塵室內必須保持與外氣的絕對正壓,在本研究所建立的類負壓病房為與周圍其他製程區的相對負壓,透過氣密程度的加強與改善,直接的隔絕兩區污染物互通,減少污染物直接擴散造成的污染。
B、負壓大小
負壓病房中需建立足夠負壓確保病原體無外洩疑慮,在台灣的規範中負壓病房需與環境有8Pa負壓值,本次研究則透過以下方法來建立CWR與周圍環境的相對負壓:
a、CWR正壓減少
無塵室內環境供氣主要由MA進行供應,減少CWR區域MA供應量,可有效降低CWR區域的正壓,同時亦增加CWR區域環境抽氣量,進一步減少區域正壓大小 。
b、周邊環境提高正壓
透過將周邊環境供氣量提高,提高周圍壓力,確保與CWR有足夠壓力差,建立足夠的壓力梯度力確保於氣密之縫隙處的風向為周圍至CWR,避免污染物外洩。

其中 a=氣流加速度
𝜌=空氣密度
𝑝=氣壓
研究方法
3.1.設備端–逸散減量
本研究的目的是為了解決Wafer recycle機台在運轉時使用大量IPA清洗控制片後,仍有殘留的IPA透過機台外罩氣密性較差的區域外漏,造成無塵室內AMC污染,為減少污染源的逸散提出改善機台環境排氣方法,藉由增加排氣系統抽風量及縮小機台污染物逸散範圍,進而優化局部空間換氣量,進行源頭逸散減量。
Mini-exhaust改管
Wafer recycle機台下方設有環境排氣,將原本使用GEX一般排氣風管,將溢散在外的IPA排至非無塵室外,變更為使用VEX有機排氣風管,專管將溢散的IPA氣體排至VOC燃燒後排放出大氣中。可降低GEX排放至大氣中IPA濃度,並且可達到專管專用避免造成空污問題。
為了加大抽氣效果,同時將環排管徑由8吋管改為12吋管,增加環境排氣的抽氣量,減少IPA機台端對環境的影響。
機台周邊curtain防護
為了進一步提高還排抽氣效率,本研究將機台下方使用PVC curtain包圍,集中機台溢散出IPA氣體,縮小AMC 溢散空間,避免影響到鄰近環境,可使Exhaust排氣效率提升。
整體防護如 圖1所示,透過加大抽氣管徑,並同時利用curtain將污染物集中,預期可減少IPA的逸散量,達到汙染源頭減量的目的。
圖1、機台周邊curtain防護示意圖及現場照片
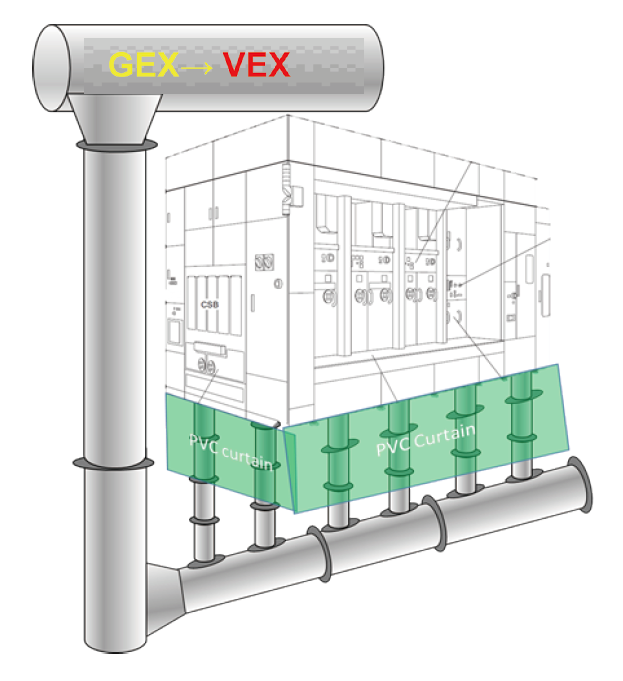
3.2.廠務端–類負壓病房建立
A、氣密
a、ECP氣密改善
建立完善的氣密空間是負壓病房的關鍵,透過以下的手法來達成 :
- L40-L35-L30-L20全區域氣密改善,改善建廠時期缺失,並配合定期巡檢確保負壓病房無洩漏之虞。
- 動線上的自動門進行管制,僅在機台move in時開放 ,減少對外開口之機會,如 圖2。
圖2、ECP動線自動門管制

- 增設ECP, CWR隔間牆,在隔間牆與動線上自動門之間形成Buffer room,減少受汙染源影響之疑慮,如圖3。
圖3、ECP新增隔間牆與buffer room

B、壓力
a、FFU轉速調整
FFU轉速係無塵室壓力之重要因素,為建立CWR之相對負壓,須將ECP FFU轉速加載而增壓,CWR則反之 ; 透過壓力梯度之建立,讓風不僅縱向流動,亦達成橫向流動之效果。
儘管透過FFU加減載,在L30達成CWR對ECP之相對負壓,卻讓CWR L35相對ECP正壓,使得負壓病房出現破口,逸散汙染物至其他區域。
另外我們將ECP與CWR交界處之FFU加載,透過風速大且穩定的氣流來製作air curtain,更降低了汙染源逸散的可能。
b、MA風管改管
為解決CWR L35正壓問題,需對MA風管進行改管 ,將原先CWR之MA風管改管至ECP,讓ECP L35增壓 、CWR L35降壓,透過一增一減之方式達成天花板上下皆「負壓」之病房,如 圖4所示。
圖4、ECP 壓力改善措施示意圖
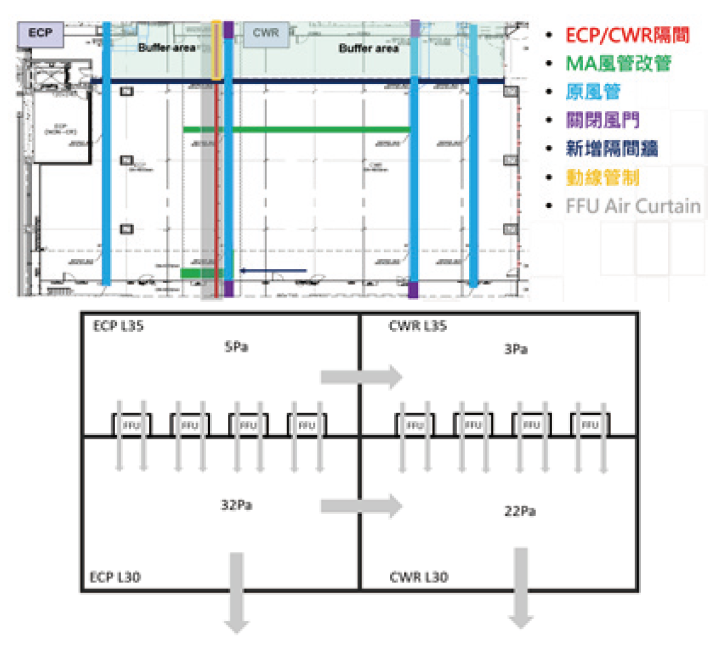
c、CWR新增環境抽氣
透過增加環境抽氣可降低相對壓力。本案立中,我們於CWR區L35增加一管環境抽氣,減少CWR L35的相對壓力,達到相對ECP負壓的結果。
結果與分析
4.1.機台周邊IPA濃度變化
透過加大機台端Mini-exhaust管徑及新增高架地板下PVC curtain,成功降低機台附近逸散至環境的IPA濃度。圖5為CWR機台的改善結果,在改善前,以MiTAP量測機台旁濃度皆偏高,對環境有嚴重的影響。進行改善後濃度減少93%的污染逸散,呈現極為明顯的下降,而機台後端及L/P等非IPA排放管附近IPA讀值相對低的地方,於改善後也有5%~30%的下降,整體而言,透過此方法有效的將IPA逸散降低直接性的從源頭將污染源減量。
圖5、CWR機台IPA源頭改善結果
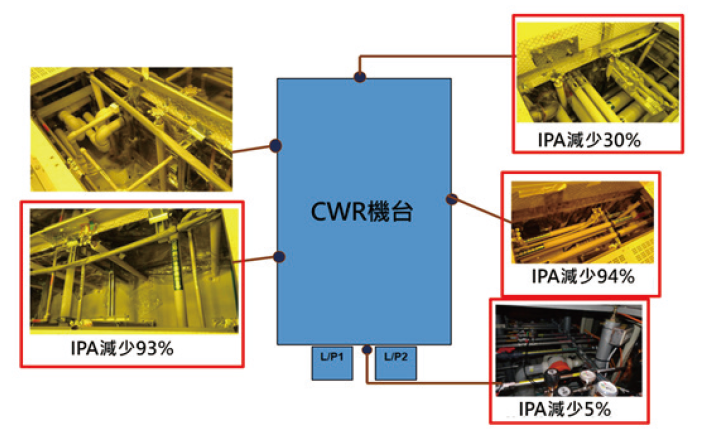
4.2.ECP區域正壓維持
透過氣密與壓力的改善,建立完善的CWR負壓病房。三樓壓力的部分,在FFU調整之下,調整前ECP與CWR兩者相差無幾,ECP壓力僅大於CWR 1pa,將ECP FFU加載後,ECP對CWR之正壓約10Pa,導入壓力梯度力之概念 :

壓力差∂p由1pa增加至10pa,兩者的梯度力也增加10倍之多,為L30建立起堅實的防護牆。
在FFU加載的同時建立了L30的正壓,但是卻因L35抽氣量增加造成鄭壓防護牆失守,於是透過增加MA風量進行防護,於L35同步建立負壓防護。MA風管改管前,ECP與CWR壓力差為負值,進行MA改管及風量補充後,壓力差增加約8pa,也建立起L35 ECP相對CWR正壓的防護,導入壓力梯度力的概念,L35增加MA風量使∂p由負號變為正號,正負號之轉換意味風壓方向之變化,故而原本風向為CWR至ECP,MA增量後改由ECP至CWR,成功建立負壓病房阻止IPA之擴散,整體改善如 圖6所示。
圖6、ECP與CWR壓力改善變化圖
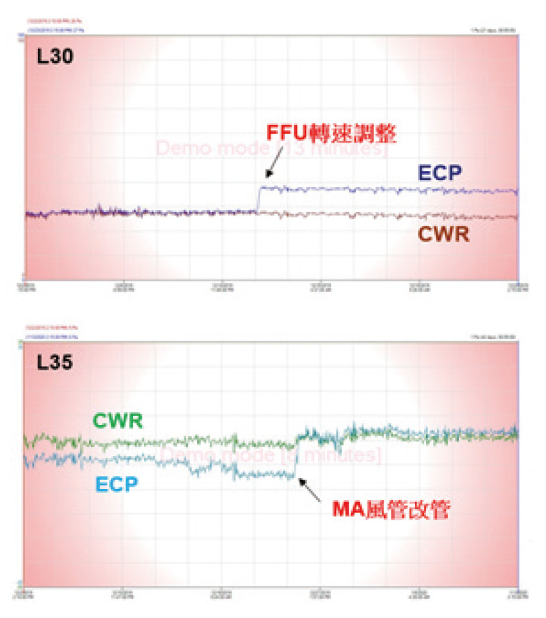
4.3.ECP區域IPA防護
透過ECP的正壓建立,避免影響旁邊的ECP。如 圖7為ECP&CWR區IPA濃度變化,以ECP現行baseline作為標準將IPA濃度進行比值換算。
圖7、CWR&ECP區IPA濃度變化

12月初時IPA受CWR影響濃度為baseline約5~8倍,開始建立各種防禦措施後IPA濃度開始下降,成功將濃度降到baseline,並達到母廠的標準。同時看CWR區域之IPA濃度變化,可以發現即使在1月後CWR開始大量排放後IPA逐漸升高並且有較大的變化量,但是ECP IPA持續保持在baseline,成功透過將IPA污染封鎖在CWR區域,為ECP量產之AMC穩定性提供不可或缺的貢獻。
圖8為ECP、CWR區域2019年12月中、2019年12月底與2020年2月IPA濃度空間分布圖,可以很明顯的發現初期ECP受CWR影響,隨者各種措施的改善,ECP不再受CWR影響,即使CWR開始run貨IPA濃度上升,ECP仍可保持在Baseline。
圖8、ECP與CWR IPA濃度空間分布圖

結論
透過源頭減量及類負壓病房建立,F18P2成功將IPA污染留在CWR內,避免影響ECP的AMC品質。透過將exhaust改管及機台周邊curtain防護,更有效率的將mini- exhaust的效果提升,減少對環境的影響,機台端IPA濃度有效降低93%,同時將GEX改管為VEX可減少屋頂的IPA排放,亦減少源頭的外氣污染。
透過加強氣密、調整FFU轉速及新增L35環境抽氣,成功將CWR L30及L35皆相對ECP負壓,L30 ECP對CWR之正壓約10Pa ,L35 ECP對CWR之壓力由負轉正,成功將IPA封鎖於CWR之內,即便CWR因run貨而造成IPA明顯提升的同時,ECP區並未因此而被污染。
藉由各種方法,F18P2成功守住ECP區,藉由此次的經驗與挑戰成功提供良好的AMC供應品質,並期許借鑑這些經驗,朝向AMC零污染之願景邁進。
參考文獻
- 施惠雅、李壽南、顏紹儀、呂建豪,「微污染控制之成功案例」 ,工業技術研究院能源與環境研究所。
- Dainippon Screen Mfg. Co., Ltd, FC-3100 Series Operation Manual, 2006.
- Carl Woods, James P. Garcia, John de Larios, MENISCUS, VACUUM, IPA VAPOR, DRYING MANFOLD. United States Patent 7198055, 2007.
- Wet benches.net, http://wetbenches.net/wetbenches_002.htm ,2013.
- Shih-Cheng Hu, Andy Chang, Angus Shiue, Ti Lin, Song-Dun Liao, Adsorption characteristics and kinetics of organic airborne contamination for the chemical filters used in the fan-filter unit (FFU) of a cleanroom, Journal of the Taiwan Institute of Chemical Engineers, Volume 75, 2017, Pages 87-96.
- 行政院勞工微員會勞工安全衛生研究所,「負壓隔離病房微粒擴散模式及設計參數改良研究」,2009。



留言(0)